
扫码添加微信,获取更多半导体相关资料
本文报道的实验旨在研究表面化学引起的蚀刻刻度的差异,为了分离蚀刻刻放的基本机制,在三种不同的衬底温度下,即Tsub5 85、20和2 45 °C的相同等离子体条件下,蚀刻相同图案的Si和砷化镓样品。由于等离子体条件是相同的,从硅到砷化镓或从一种温度到另一种温度的蚀刻速率尺度的差异不能归因于离子和中性输运效应。由于在两种衬底材料中蚀刻了相同的特征,因此几何因素也保持不变。
我们表明,在两种衬底的较高温度下,长宽比比例占主导地位,但对硅的影响明显更强。对于砷化镓和Si,在最低温度下可以观察到一个更复杂的、随时间变化的尺度,同样,这种影响在硅中比在砷化镓蚀刻速率中更明显,数据用纯中性通量阴影的离子中性协同模型35,36很好地描述,在低温下,该模型被扩展到包括一种蚀刻抑制剂的沉积,以解释非长宽比的比例。在总结之前,讨论了这些结果对最小化蚀刻率刻度效应的影响以及其他非均匀性机制的重要性。
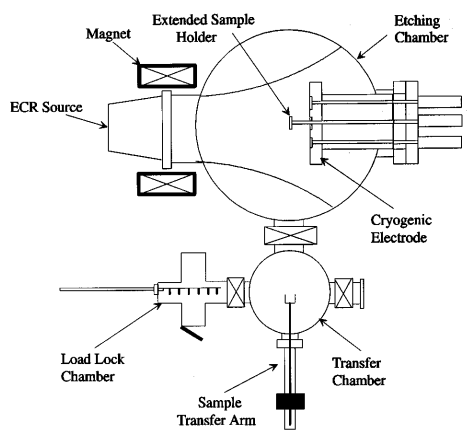
图1
实验使用电子回旋共振~ECR,见图1。在处理过程中,通过将电容压力计的输出反馈到限制1500l/s涡轮分子泵的泵送速度,来控制2mTorr的腔室压力,石英内衬温度用于近似气体温度38;在本研究中最长的蚀刻期间增加200K,可高达750K。中性通量10%的变化导致本实验长宽比蚀刻率10%的变化,为了引起蚀刻率的变化,通过红外干涉仪现场监测的毯状蚀刻率没有显著变化,证实了10%。
在使用电流互感器和高压探针获得电流和电压波形,电极温度是通过安装在电极背面的凹槽中的K型热电偶测量电极温度的,温度是通过同时从LN2储液器中冷却和从电极内部的欧姆加热器中加热来设定的。利用加热元件的反馈控制,通过红外干涉法测量的衬底温度Tsub在处理过程中保持在设定温度的6 3°C内。虽然这项工作只涉及Si和砷化镓沟槽中心的蚀刻速率,但在两种材料中选择了同时产生最垂直剖面的条件,见图2和3。
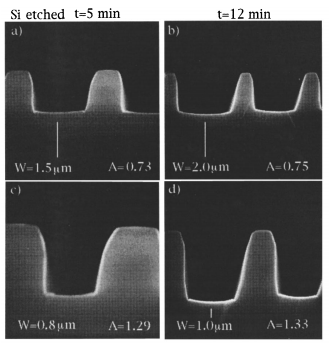
图2
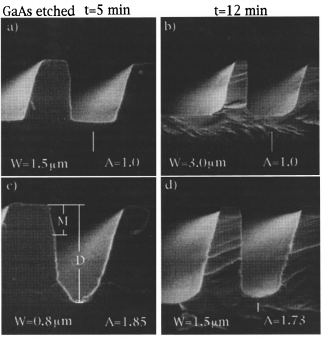
图3
在具有长宽比缩放的RIE滞后条件下,仅将蚀刻深度除以蚀刻时间所得到的蚀刻率高估了最终长宽比的实际蚀刻率。砷化镓的沟槽轮廓往往比Si~的沟槽轮廓更锥细。砷化镓的变细在较低Tsub和较高纵横比特征时最为明显,这与特征宽度无关。3a、3b到3c和3d。而在Si中,随着高宽比的变化似乎很小见图2,如果在砷化镓中逐渐变细是由于重新沉积,重新沉积的材料很可能是Ga和As,因为重新沉积的材料和原始砷化镓之间没有观察到对比。
虽然可以考虑许多高宽比相关的蚀刻机制,但在我们的实验条件下,中性阴影似乎占主导地位,但由于Si和砷化镓蚀刻过程中等离子体和光刻掩模是相同的,所以掩模充电不能造成两种材料长宽比比例差异的原因。
虽然我们只考虑了沟槽中心的蚀刻速率,并且在那里我们发现中性阴影与数据一致,但对于沟槽的其他部分,其他机制,如克努森扩散可能发挥更重要的作用。在底物温度下,使用具有朗缪尔吸附动力学的离子中性协同模型来很好地描述,蚀刻率的比例可以仅用中性阴影来解释,Si和砷化镓的尺度之间的差异归因于Cl表面覆盖的差异:对于Si,表面覆盖小于砷化镓,导致Si沟槽蚀刻速率更依赖于中性通量,因此长径比。这些数据可以很好地描述,假设少量的蚀刻抑制剂的表面覆盖度在蚀刻过程中随时间缓慢地增加。虽然该抑制剂的确切鉴定仍未确定,但有证据表明光刻胶的影响。