
扫码添加微信,获取更多半导体相关资料
引言
本研究考察了利用超临界二氧化碳和共溶剂添加剂去除硅晶片表面Si3N4刨除的技术。 首先,通过关于几种表面活性剂和添加剂的超临界二氧化碳溶解度及刨花板分散性评价,确定了其对超临界工艺的适用性。 通过调整各种变量,进行了刨花板洗脱实验,确立了最佳去除条件。 实验中使用的表面活性剂除垢效果差,实验后证实有次生污染物形成。 而trimethyl phosphate是IPA共溶剂和微量HF混合的清洁添加剂,含超临界二氧化碳为5 wt%的流体,温度50℃; 在压力2000psi下,以15mL min-1的流速洗脱4分钟,结果表明,除垢效率为85%。
实验
试剂和材料:作为实验中使用的蚀刻用试剂,HF水溶液以HF/water(1:1, 德山),并购买了IPA(东友精密化学)、Tergitol(ALDRICH)、TMN-6(ALDRICH,)、Trimethyl phosphate(ALDRICH)作为公用溶剂和添加剂,按适当比例配伍使用。 这些药品均为试剂级,没有单独的提纯过程使用,试验使用的蒸馏水采用了三次蒸馏水。 购买并使用纯度为99.99%的二氧化碳(临沧气体),购买并使用Silicon nitride(Si3N4,50 nm,ALDRICH)作为污染样品的污染源,wafer使用的是由纳米综合Fab中心设备制作的silicon材质bare wafer。
制作污染材料:本研究中使用的污染材料是将硅酮硝酸酯粒子分散到IPA中,利用自旋柯特机在1 × 1厘米的Si wafer上涂层20秒后制作的。通过光学显微镜(opticalmicroscope)和扫描电子显微镜(SEM)观察了制造的污染物质,并根据粒子清除效率(particle remove efficiency,PEM)进行了观察。公开介质的种类、刨花板量和涂层时转速不同,制作了污染材料,条件在Table 1中进行了说明。除了2号外,样品在bare wafer上涂了自旋涂层,2号在HF预处理的bare wafer上涂了自旋涂层。
结果表明,silicon nitride的含量越高,自旋KOTER旋转数越低,表面粒子的密集度就越高,HF预处理的有无就看不到明显的差异。污染费去除半导体过程中产生的微量粒子。
本实验使用的污染费是IPA将Si3N4分散0.2 wt%,以2000RPM的速度旋转涂层制造的污染费(Figure 2)。
利用超临界二氧化碳清洗硅片:超临界清洗装置使用了15 mL的反应器,该反应器是用HASTELLOY(HASTELLOY)特制的,可承受高压和HF[18]。反应器内部加入了涂有特氟龙的磁棒,使超临界二氧化碳和试剂混合良好。反应温度利用恒温水箱均匀保持在50 ℃。在进行实验时,将污染材料放入装有清洗液的烧杯中进行前处理,然后放置在反应器内部自制的样品架上。利用微吸管加入定量清洗液,屏蔽反应器后,用ISCO无脉动硅氧泵注入二氧化碳。这时以3 mL min-1的流速注入二氧化碳,在注入过程中使用反应器内部的磁棒,使二氧化碳和药液混合良好。反应完成后,反应器内部二氧化碳和清洁液的排出,同时为了通过减压防止药液残留,以固定流速在内部流出数分钟,在保持超临界状态的情况下排出残留药液。另外,使用含有NaOH水溶液的陷阱消除了排出的少量HF(FIGURE 3)。
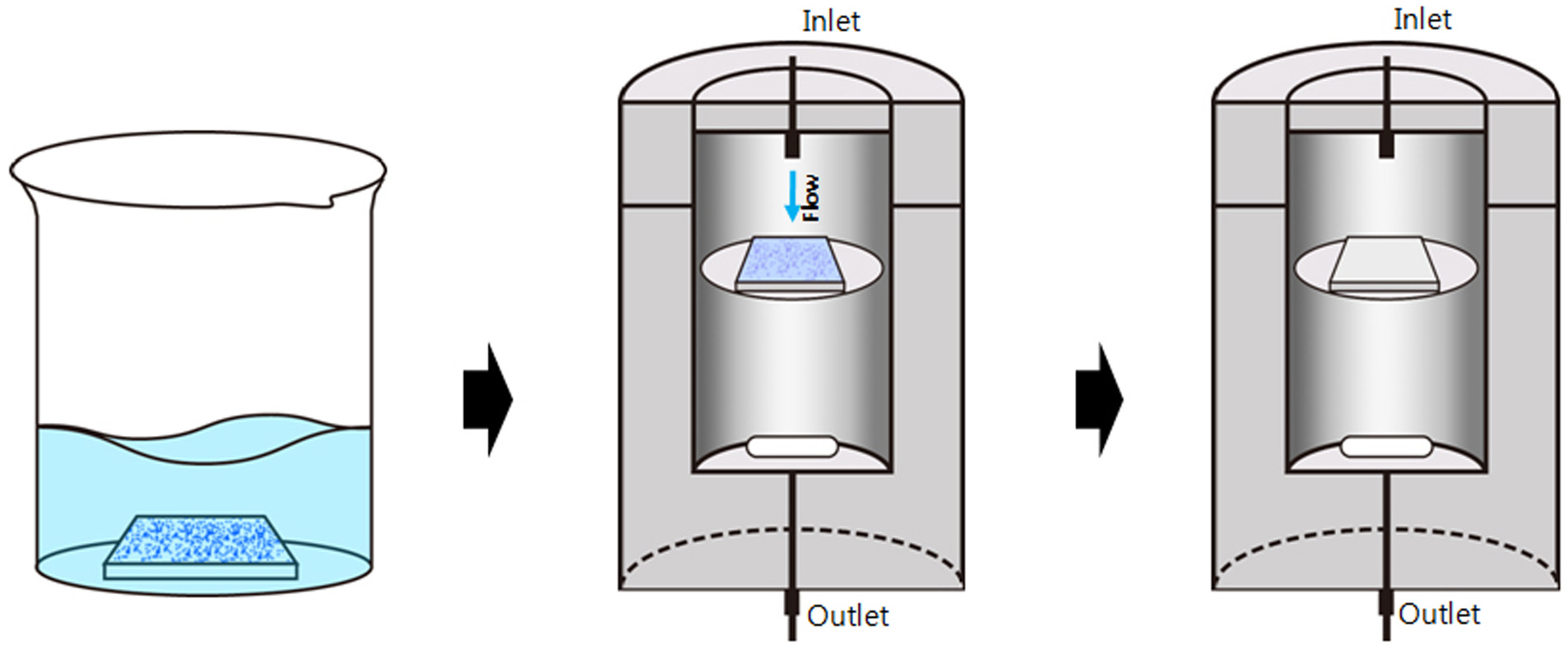
图3 超临界清洗工艺
结果和讨论
工艺条件确立:为了消除以物理结合方式粘附在晶片上的刨花板,必须提供比这种结合力更强的物理力。 但实际上具有数nm微图案或结构的晶片,强大的物理力会引起所建立的图案及结构的衰变[19,20],因此通过实验寻求了最小物理力的标准。 反应器In/Outlet的位置随二氧化碳的注入速率及与Inlet的距离而变化,使内部的流体流动发生变化。 因此,观察了In/Outlet不同位置对刨除的效果,采用未添加药液的纯二氧化碳。 实验中使用的反应器的样子都在Figure 4上。 以超临界二氧化碳温度60℃、压力2000 psi的条件,改变流速,冲洗6分钟。在水平flow型反应器中以10mL min-1流速实验的晶片表面观察到明显的CO2 flow形状。
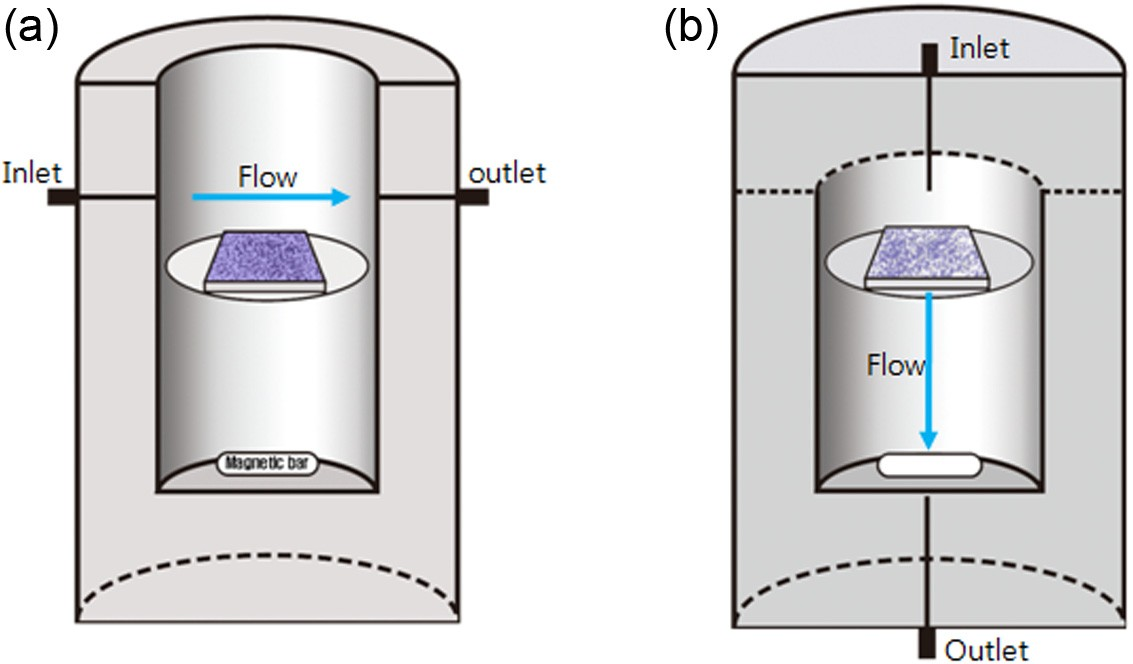
图4 不同SCC O2流量的室结构类型
相反,在垂直flow类型的反应器中,无法观察到外观上的差异,因此以更快的流速进行了实验(Table 2)。观察晶片表面后,在15 mL min-1的流速下出现了部分敌人去除,并确认随着流速的增加,晶片表面的粒子去除范围变大。为了有效地去除硅片表面上的粒子,需要scCO2流速的物理力的帮助,但强大的力会导致半导体模式和结构的崩溃,因此用垂直类型的反应器在高达15 mL min-1的条件下进行了实验(Figure 5)。
总结
本研究利用超临界二氧化碳,粗射了可以去除半导体制作时产生的Si3N4粒子的清洁系统。进行了去除Si3N4刨花板的工艺条件及IPA公用溶剂和清洁液中添加的表面活性剂、根据粘结剂去除晶片表面的Si3N4刨花板的试验。与垂直放置的反应器相比,In/Outlet的位置水平放置的反应器在晶片表面以均匀的力作用,可以确认二氧化碳的作用。而且,从晶片表面拆卸粒子时,需要15 mL min-1左右的超临界二氧化碳流速来提供物理力。表面活性剂Tergitol 15-S-7和TMN-6,作为提高二氧化碳流体内颗粒吸附和分散性的目的,其表面活性剂TMN-6很少出现颗粒去除性能,反应后提供晶片表面的二次污染源,因此不适合作为清洁液的添加剂。