
扫码添加微信,获取更多半导体相关资料
引言
本文研究了硅的氧化物和氮化物的气相氟化氢蚀刻作用,新的氧化物选择性模式,概述了通过将无水高频与控制量的水蒸汽混合而产生高频蒸汽蚀刻剂的实现方法,描述了一种通过将氮气通过高频水溶液而引入高频蒸汽的系统。
实验
图1显示了本工作中使用的反应器的示意图;该反应器由一个惰性碳化硅反应室和两个装有适当溶液的加热汽化器组成,通过使受控量的氮气载气通过汽化器来输送蒸汽,该室没有被加热,并且处理压力保持在350托。为了进行电学表征,在掺硼多晶硅上制备了具有450纳米掺杂栅的LOCOS隔离MOSCAPs 5-10 Q-cm (100)取向的硅衬底,12纳米的栅氧化层是在900℃的干燥氧气环境中生长的,电容器既没有接受氧化后惰性环境,也没有接受金属化后形成气体退火。
结果与讨论
通过气相高频氧化物蚀刻,可以实现孵育时间和不同模式的蚀刻选择性。硅的各种氧化物和氮化物的蚀刻速率列于表1。与高频水溶液一样,气相等效物对不同的硅氧化物表现出不同的蚀刻速率,从而产生了蚀刻选择性,蚀刻速率从热生长到沉积氧化物,从未掺杂到掺杂氧化物增加。虽然氮化硅的低蚀刻速率使其成为硅氧化物的合适蚀刻掩模,但需要注意的是,气相HF与水对应物一样,产生各向同性蚀刻。
气相和水相高频之间有明显的区别。如表1所示,蚀刻发生的时间存在于蚀刻过程的开始,这种孵育时间与在晶片表面形成薄的水膜所需的时间有关,不同氧化物的孵育时间不同,从而产生了第二种蚀刻选择性,如图所示2,在热氧化物孵育时间内的时间间隔8t内,PSG的非零蚀刻速率意味着PSG对热氧化物蚀刻的选择性是无限。这种现象的一个特殊应用是选择性地从含有热氧化物的介电材料堆中去除掺杂氧化物,通过进行多个由抽送/解吸步骤分离的多步骤蚀刻过程,可以进一步增加无限选择性的持续时间。对于给定的氧化物,孵育时间和蚀刻速率都受HF蒸汽注入速率和H=O蒸汽注入量的影响,分别由氮载气通过HF和H20蒸发器的流动控制。
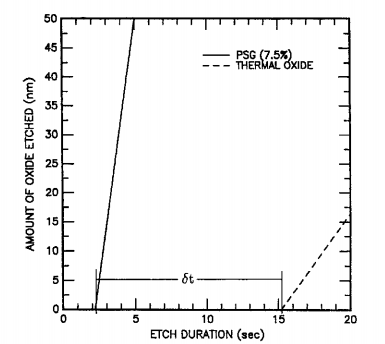
图2
对于热生长的氧化物,蚀刻速率随着氮载气通过高频汽化器的流量的减小而减小。为了区分长孵育时间和短孵育时间和可忽略的蚀刻速率的可能组合,设计了一个连续的多步蚀刻过程来表征减少氮载气流量下的热氧化物蚀刻速率,结果汇总如图所示3,第一步包括10秒的蚀刻,氮气以15升/分钟的速度流动,接下来的步骤是氮气的流量减少,而通过注入额外的纯氮气,通过蚀气室的总流量保持在15升/分钟,第一步是凝聚态膜的形成。因此,第二步的有效孵化时间基本上为零。在第一步和向第二步的过渡期间,蚀刻时间略小于60nm。当氮载气流速为5l/min时,使用该技术测量的蚀刻速率为3.2nm/s,而在流量上升时基本上没有观察到蚀刻。
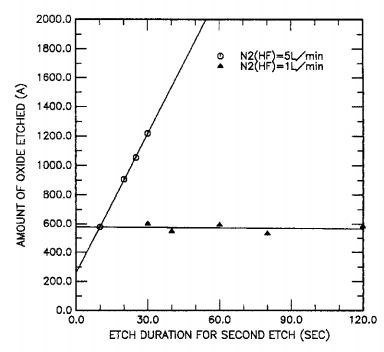
图3
由于孵育时间等同于水膜的形成时间,因此在较低流速下较长的孵育时间可以通过伴随降低的H20蒸汽分压降低来理解,进一步验证了孵育时间对H20蒸汽分压的依赖性。对于掺杂的氧化物薄膜,蚀刻速率进一步受到与薄膜致密化过程相关的热处理的影响。除了在氮气环境下在850~下退火20min的薄膜外,致密化实际上导致了更多的氧化物蚀刻,要么是由于更快的蚀刻速率,要么是由于减少了孵育时间。未致敏膜的蚀刻速率和在850~下退火的膜的蚀刻速率相当,而致敏膜的孵育时间略高于沉积膜的两倍。研究发现,即使HF和H20注射量保持不变,HClinjection.--The注射HC1的影响也会显著影响气相氧化物蚀刻特性,蚀刻速率和孵育时间均随着HC1注射量的增加而增加。
根据表面conditioning--Besides的依赖性,蚀刻速率对形成方法和氧化膜掺杂的依赖性,孵育时间的存在带来了另一个工艺参数,该参数的变化必须仔细研究。
当使用气相高频蚀刻天然或化学氧化物时,可以消除冲洗和干燥晶片的需要,当用气相高频代替水相高频时,天然氧化物脱胶的粒子性能。需要指出的是,同时使用相同的高频源来产生水溶液和蒸汽。至于重金属镀层,由于与蒸气产生相关的额外蒸馏,在天然氧化物的气相高频蚀刻过程中,这种镀层也降低了。在将晶片分为三组不同的心衰处理前,对其进行常规的预氧化清洁处理。处理方法为水相(1%)高频、气相I-IF和气相高频,然后进行水冲洗。从水高频到汽相高频有改善的趋势,气相高频和水冲洗相结合的分布最好。经过4倍以上的改进,随时间变化的介电击穿数据,当水相高频被气相高频取代时,其变化最为显著。
结果
对各种硅氧化物的气相高频蚀刻进行了广泛的表征,基于不同氧化物孵育时间变化的新工艺已经被开发出来,用于实际应用,如在同样含有热氧化物的图案堆叠中选择性去除PSG。用气相高压工艺取代传统的水高频工艺,不仅可以获得更好的清洁度,而且可以提高薄氧化物的电应力耐久性。