
扫码添加微信,获取更多半导体相关资料
引言
石墨烯与通常应用于标准光刻过程中的聚合物的高亲和力,并且不可避免地会改变石墨烯的电学性质,通过拉曼光谱和电输运研究,我们将石墨烯器件的室温载流子迁移率与石墨烯中有序域的大小联系起来。我们还发现这些有序结构域的大小受到光刻后清洗过程的高度影响。最后表明,通过使用聚(二甲基戊二酰亚胺)(PMGI)作为保护层,提高了CVD石墨烯器件的产量。相反,与传统生产方法制造的器件相比,它们的电学性能会恶化。
在高质量石墨烯的几种合成方法中,化学气相沉积(CVD)是大规模生产最常用的方法之一。然而,石墨烯基器件大规模生产的挑战是基于石墨烯的电子工业全面发展的巨大障碍。这是由于难以避免石墨烯的结构降解和化学污染。因此,在本研究中,我们利用拉曼光谱和电输运技术进行了研究。
实验
我们在300纳米厚的二氧化硅层上使用了CVD石墨烯,石墨烯器件是在场效应晶体管结构(GFET)中通过两个光刻步骤生产出来的(图1)。第一步用于定义石墨烯器件的几何形状,第二步用于制造电极。在第一个光刻步骤中,石墨烯上涂有一层1340nm厚的光刻胶(图1a),然后,通过直接激光书写光刻技术(图1b)来定义器件的几何形状,然后在AZ351B(1:4)显影剂中开发暴露的光刻胶,图1c。在这一发展之后,多余的石墨烯用o2等离子体去除石墨烯(图1d)。最后,我们使用不同的协议去除光刻胶层(图1e),在第二个光刻步骤中,在之前的图案石墨烯上涂上一层820nm厚的聚(二甲基戊二酰亚胺)(PMGI)基抗蚀剂,来自Microchem.com的LOR5A,然后是1340nm厚的光刻胶AZ1512HS(图1f),紫外照射后,暴露的光刻胶的发展产生下切口轮廓,如图1gh所示。然后,在样品上热蒸发5/100nm的Cr/Au,并按照程序“P1”或程序“P2”进行升降程序(图1j)。

图1
在称为P1的过程中,光致抗蚀剂脱剥离剂、N-甲基-2-吡咯烷酮(NMP)(剥离),然后冲洗异丙醇(IPA)和去离子水,图21、2b、2c显示。该过程严重损害了石墨烯。为了提高器件的生产效率,我们使用第二种方法逐步去除光刻胶和LOR。首先,用1-甲氧基-2-乙酸丙醇(PGMEA)去除光致抗蚀剂,这是一种LOR是惰性的溶剂(图2d,e),然后,在AZ351B(1:4)中去除覆盖石墨烯膜的剩余LOR层(图2f)。研究发现,程序P2不如程序P1激进,总共有60台设备的设备生产效率提高了85%(图2g)。事实上,当PMGI作为支撑支架进行CVD石墨烯转移时,产量较高。
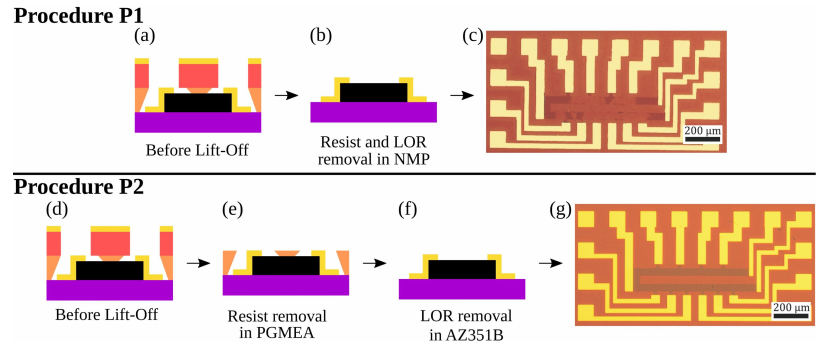
图2
我们在室温下进行了拉曼光谱和电输运测量,以将石墨烯中有序域的大小与其载流子迁移率联系起来。
结果与讨论
图3a显示了接收的CVD石墨烯的拉曼光谱,图3b和图3c分别显示了P1和P2程序产生的石墨烯器件的拉曼光谱。用P1程序处理的石墨烯(图3b)与参考CVD石墨烯的拉曼光谱非常相似(图3a)。这表明,使用NMP的发射在石墨烯上留下的化学残留量可以忽略不计。然而,图3c显示,在P2程序进行的剥离过程中,PMGI聚合物并没有被完全去除。这可以通过图3c所示的1137、1178、1300、1312、1400、1410、1434、1404−1和1604cm−1与PMGI聚合物相关来证实。因此,使用程序P2的设备生产的巨大增加伴随着在起飞过程中PMGI的显著污染。
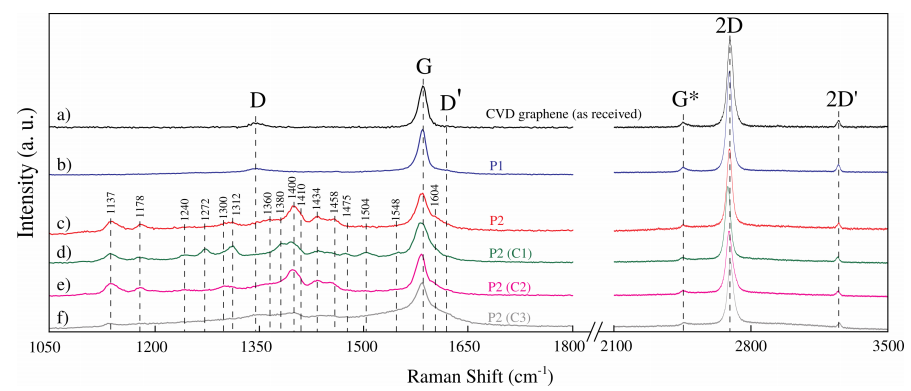
图3
为了去除P2程序产生的石墨烯器件中残留的PMGI,我们尝试了三种不同的清洗方法:第一种方法(C1)包括在一个NMP浴缸中清洗设备;在第二种清洗方法(C2)中,我们使用N、N-二甲基甲酰胺(DMF)来清洗石墨烯器件;最后,第三种方法(C3)包括通过H2/Ar(1:1)在300°C下退火2h清洗石墨烯。尽管如此,我们还是观察到,分别使用NMP和DMF的清洁方法C1和C2都不能从石墨烯表面去除残留的PMGI聚合物。图3c通过P2程序生产并用NMP(图3d)和DMF(图3e)清洗的两种石墨烯器件的拉曼光谱显示了与PMGI聚合物相关的相同特征。对于H2/Ar退火,图3f显示,该过程并没有完全去除石墨烯表面残留的PMGI聚合物,因为仍然存在一些与聚合物相关的拉曼带。石墨烯的结构无序可以通过ID/IG强度比来量化。
经过P1和P2两种方法处理的石墨烯的有序结构域的尺寸均减小到La≈160nm,由此,我们推断,这些过程在石墨烯中引入的结构缺陷数量大致相同。此外,由于P2制备的器件用C1清洗,La的表达值没有下降。然而,当采用C2和C3方法进行清洗时,有序结构域的尺寸进一步减小,这表明石墨烯的结构无序性增加。
因此,清洁方法要么不清洁石墨烯表面,要么促进一定程度的清洁,但以引入缺陷为代价。为了将拉曼光谱得到的结果与石墨烯器件的电输运特性联系起来,我们对不同发射程序和清洗方法产生的几种器件进行了导电率栅极电压(Vg)的函数测量,由于几个设备的中立点超过100V,我们在这里只考虑通过孔的传输。石墨烯的电导率σ作为栅极电压Vg的次线性函数,这种次线性行为与石墨烯中的弱点无序有关,该无序作为载流子密度无关的残余电阻率ρs出现。强无序率和带电杂质无序率是产生电阻率(μne)−1的原因,其中μ是迁移率,n是载流子密度。
我们进行了电输运测量和拉曼光谱研究,以比较CVD贝尔斯坦纳米技术的性质。并采用最近开发的一种使用LOR作为牺牲层的方法生产的器件。我们发现PMGI分子在石墨烯中引入无序,从而损害了基于CVD-石墨烯的器件的性能。然后,我们应用了最常见的光刻后清洗方法来去除PMGI分子。我们能够将电迁移率与经过不同清洗程序的设备中有序的域大小联系起来。我们的结论是,使用LOR作为牺牲层提高了CVD石墨烯器件的产量,但损害了器件的整体电子性能。