
扫码添加微信,获取更多半导体相关资料
本文报告了证明硅的预氧化清洗对5种不同清洗程序的氧化动力学的影响的实验结果。这些清洗处理包括简单地冲洗以及nh4OH-HHCI-H202和HF溶液的组合。在低厚度下计算的不同速率表明了界面效应对初始氧化状态的影响。在高厚度计算的速率差异表明,由于清洁处理,氧化物结构的变化,这是由折射率的椭偏距测量表明氧化物密度的变化。使用不同的预氧化前清洗程序可以通过硅的热氧化来改变二氧化硅的生长速率。本文描述了硅表面处理后的氧化动力学的类似研究结果。选择这些化学处理方法进行研究,因为它们构成了那些在广泛使用的RCA清洁剂中。结果表明,氧化动力学在所研究的整个厚度范围内都发生了变化,即24-430nm。
经过一系列实验,8次氧化处理的厚度与时间的数据如图1所示。所绘制的厚度是至少4个测量的平均值,2个样本中每个至少2个测量。前四种氧化时间小于200分钟,只含有“不清洁”、“仅碱”、“仅酸”和“碱+酸+HF”样品。为了更好地了解高频预处理对氧化的影响,我们加入了“NoClean+HF”组。首先,需要注意的是,每次氧化的相对厚度顺序都是相同的。“碱+酸+HF”总是有最厚的氧化物,所有的氧化作用都与相对厚度一致,这有力地证明了预氧化处理对氧化动力学有显著影响。
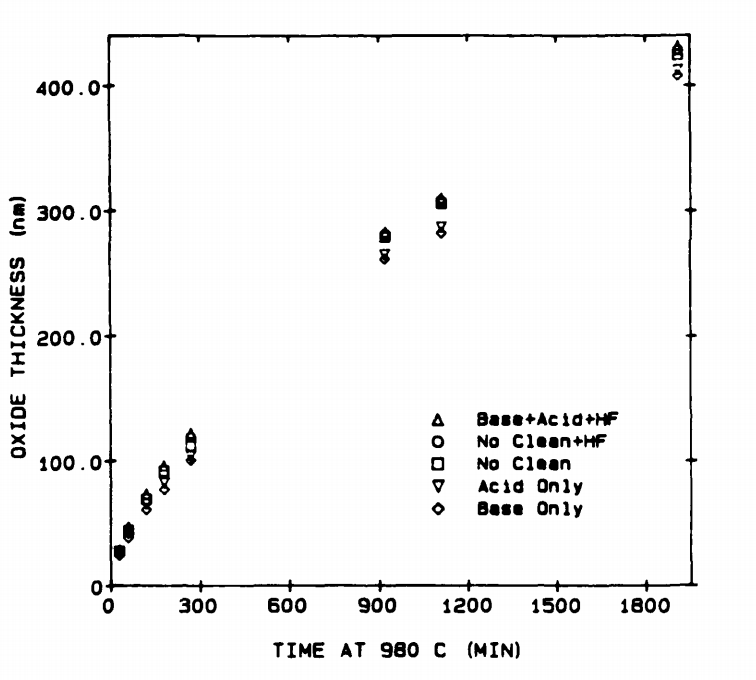
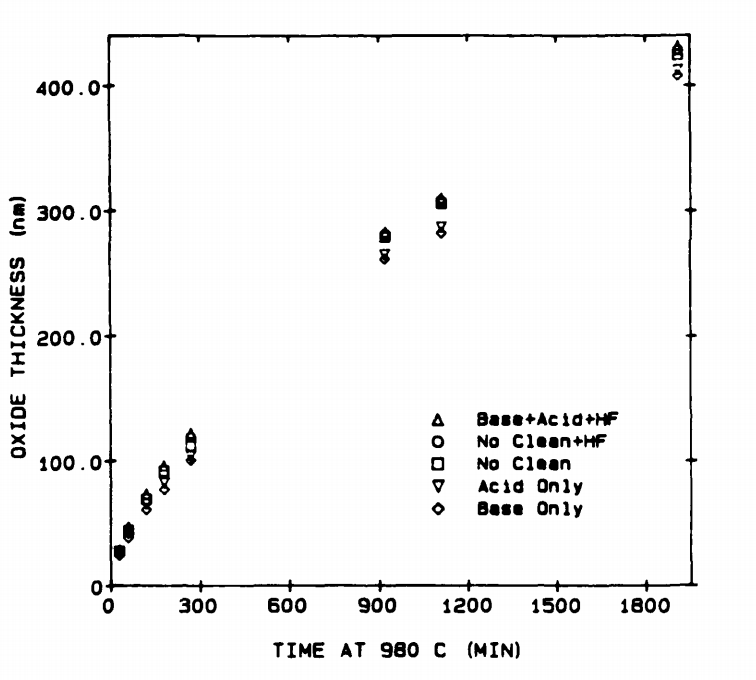
图 2
图1数据的另一个主要特征是这些点在较短的氧化时间下聚类,随后在较长的氧化时间下发散。当比较“仅酸”和“只碱”组与其他三组时,这一点尤其明显。为了进一步研究这种差异,我们测定了不同厚度下不同基团的氧化率。为了避免使用任何特定的硅氧化模型来计算速率,它们是通过数值方法确定的,只需取适合数据的解析函数的导数。通过在y轴上绘制时间(t),在x轴上绘制厚度(L),t-aL2+bL+c形式的二阶多项式函数可以相当精确地拟合于数据点的任何子集。
氧化的后期阶段由氧通过氧化物向硅的扩散控制,从而产生抛物线速率。我们可以合理地假设,对硅的任何预氧化处理都将只影响硅表面,因此将主要影响氧化的线性或早期阶段。因此,不同的化学清洗会对较薄的氧化物膜产生不同的氧化速率,如表1所示,随着氧化物变厚,氧气通过氧化物的扩散成为氧化过程中的限制步骤,因此由V界面引起的任何影响都会减少。
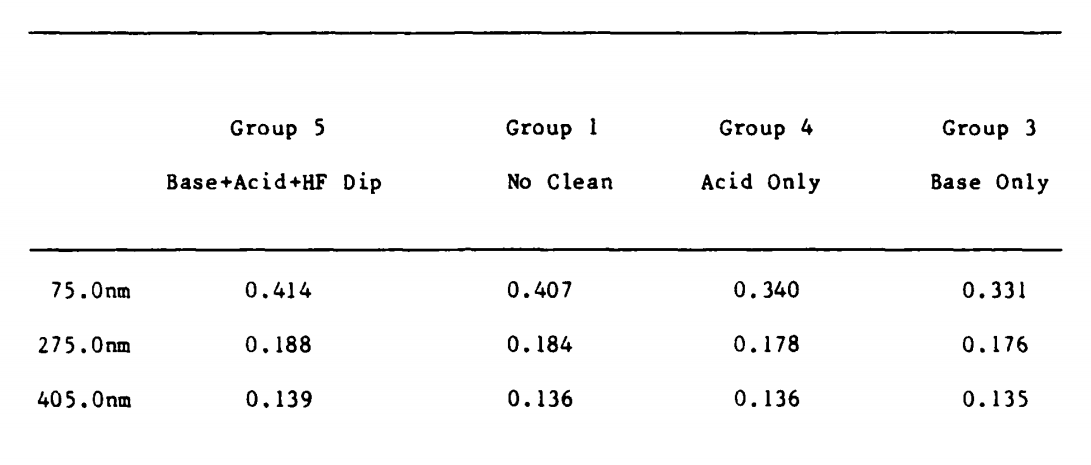
表 1
考虑到扩散被认为是重要的硅氧化速率生长后的氧化物,似乎275.0nm速率的差异可以通过假设二氧化硅本身以某种程度改变了所使用的化学处理来解释。椭圆计法可以精确测量一定厚度范围内的二氧化硅的折射率。这些样本的折射率指数被测量为“至少10次总测量”的平均值,即每组两个样本每人至少进行5次测量。在厚度接近n/2周期(其中n为奇数整数)时,误差高达0.05,是仪器精度(0.01)的5倍,厚度和折射率小于千分之一的I的误差。重复测量保证了每个样品的折射率的精度,在适当的厚度范围内的测量保证了指数的精度。然而,在测量折射率的两个椭圆距周期内,“仅酸”“仅碱基”对和“碱基+酸+HF”“NoClean+HF”对之间确实存在显著差异。“碱+酸+HF”“没有清洁+HF”对最高的氧化速率和最低密度而“酸”“只有碱”对最慢的速率但最高密度的“没有清洁”组在这两对之间与相应的中间速率和密度。速率和密度之间的相关性是根据一项已发表的研究所预期的,该研究表明,较低密度的氧化物可以使氧通过氧化物更快地扩散,从而产生更快的氧化速率。
范围表明,化学处理对硅的影响可能超出了初始氧化区域。到目前为止,还没有很好地解释为什么这些化学处理在大厚度下产生这样的效果。在前面提到的研究中,发现了高二氧化硅折射率与慢氧化动力学的类似相关性,这种行为与氧化物的固有膜应力有关,这增加了氧化物的密度。