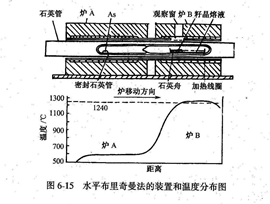
HB法制备GaAs的工艺流程:
①装料:As量要比化学计算的量要稍多一些
②加热除去氧化膜
Ga:高真空下,700℃,2h
As:高真空下,280℃,2h
③用液氮或干冰将Ga凝固,撞破石英隔窗,将反应管放入炉中
④升温:低温炉617℃,高温炉1250℃
⑤移动熔区合成好熔体
⑥生长单晶,
⑦降温:先将高温区降至610℃,再同时降温至室温
HB法优缺点:
优点:设备简单,生长系统中温度梯度小,可生长低位错密度单晶
缺点:①粘舟,产生缺陷生长截面D形,加工成圆片材料损失
②难以生长非掺杂半绝缘GaAs单晶
③难以生长大直径75mm
液态密封法LEC、LEP:
是对CZ技术的一项重大改进
基本原理:用一种惰性液体覆盖着被拉制材料的熔体,生长室内充入惰性气体,使其压力大于熔体的离解压力,以抑制熔体中挥发性组元的蒸发损失,这样就可按通常CZ技术拉制单晶
液态密封法中所用覆盖剂应满足条件:
1.密度小于拉制材料
2.对熔体和坩埚在化学上必须是惰性的,而且熔体中溶解度小
3.熔点低于被拉制材料熔点,且蒸汽压低,易去掉
4.有较高纯度,熔融状态下透明B2O3满足上述要求
LEC法生长GaSb熔点低,用1:1KCl+NaCl作覆盖剂

LEC法工艺流程:
1.装料:一石英杯装Ga,一石英安瓶装As,石英坩埚中装B2O3
2.抽真空下,B2O3加热脱水900-1000℃,Ga杯,As瓶烘烤除去氧化膜
3.降温至600-700℃,将Ga倒入坩埚内沉没在B2O3下,充Ar气
4.As安瓶下端的毛细管尖插入Ga液中,升温至合成温度,As受热气化溶入Ga内生长GaAs
5.拔出安瓶管,并按CZ拉晶步骤拉制GaAs单晶
LEC法的几个问题:
B2O3是热的不良导体。LEC单晶生长中,刚生长出的晶体是处于覆盖层内,它对这部分晶体有一“后加热器”作用,B2O3厚度的选择是重要的工艺参数之一。
为防止炉内高温烘烤造成单晶表面的分解,炉内纵向温度梯度要加大,晶体因热应力过大造成位错密度大。
B2O3易吸水,高温下对石英坩埚有腐蚀,造成一定的Si沾污100-150mm
LEC技术的一项改进—蒸气控制直拉技术vapourcontrolCZ,VCZ
改进之处:把坩埚-晶体置于一准密封的内生长室内,内生长室中放置少量As,使内生长室内充满As气氛。这样即使在相当低的温度梯度下生长,晶体表面也不至于离解。
优点:位错密度低低一个数量级以上缺点:由于该技术要放置内生长室且要求较好密封性使得生长系统复杂化,对生长过程不易观察,重复性差,尚未用于批量生产。
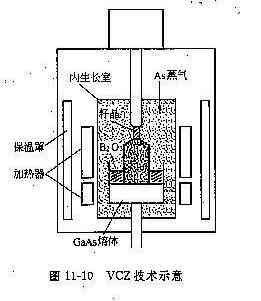
6:3砷化镓单晶中杂质的控制
6:3:1砷化镓单晶中杂质的性质Ⅱ族元素Be,Mg,Zn,Cd,Hg,它们一般是浅受主,P型掺杂剂,但是它们也会与晶格缺陷结合生成复合体而呈现深受主能级。Ⅵ族元素S,Se,Te在砷化镓中均为浅施主杂质,N型掺杂剂。氧元素在GaAs中的行为比较复杂。在低温溶液中生长的GaAs晶体中是浅施主在高温熔体中生长的GaAs晶体中是深施主
6:3:1砷化镓单晶中杂质的性质
Ⅳ族元素Si,Ge,Sn等在III-V族化合物半导体中呈现两性掺杂特性。Ⅳ族原子在III族原子晶格点上时是施主,在V族原子晶格点上是受主。过渡元素Cr,Mn,Co,Ni,Fe,V,其中V是施主杂质,其他都是深受主,深能级杂质使GaAs电阻率大大增加。中性杂质IIIA族B、Al、In取代GaVA族P、Sb取代As
6:3:2砷化镓单晶的掺杂
GaAs常用的掺杂剂N型掺杂剂Te,Sn,SiP型是Zn高阻是Cr,Fe和O掺杂的方法可将杂质直接加入Ga中,也可以将易挥发的杂质如Te与砷放在一起,加热后通过气相溶入GaAs中掺杂在重掺Te时,需把As端温度升高以增加Te蒸气压这时PAs也增大,造成富As的组分过冷故应放慢拉速
掺杂量的计算与杂质均匀性
在HB法中要考虑到脱氧过程造成的杂质损失以及存在的杂质补偿,进行修正LEC法中要考虑杂质与B2O3的作用及杂质在B2O3中的溶解度----经验公式LEC法中不能掺Si,引起B沾污LEC中,因为B2O3抑制了挥发,HB密闭,蒸发有限所以杂质的分布只与分凝作用有关—变速拉晶杂质扩散会进入B2O3中,对K1,有利于杂质的均匀分布
6:3:3砷化镓单晶中Si沾污的抑制
砷化镓单晶中Si沾污主要来源于GaAs熔体侵蚀石英器皿的结果.减少Si的沾污,主要措施是:
1.采用三温区横拉单晶炉改变炉温分布,温度升高可以抑制Si的生成.同时降低合成GaAs及拉晶时高温区温度
2.缩小中低温间管径,限制Ga2O气体由高温区向低温区扩散
3.压缩反应系统与GaAs熔体的体积比.
4.往反应系统中添加O2,Ga2O3,减少硅的沾污
5.改变GaAs熔体与石英舟接触的状态,减少”粘舟”现象
6-4GaAs单晶的完整性
点缺陷:空位,间隙原子,反结构原子点缺陷之间以及点缺陷与杂质间形成络物,多起受主作用点缺陷的产生主要与晶体生长时As蒸气压的控制有关
6-4GaAs单晶的完整性
2.位错
位错对器件的影响:引起耿氏器件的电击穿,使发光器件发光不均匀,寿命短;也能与点缺陷作用,减少缺陷-杂质络合物的形成.因此可以生长低位错GaAs单晶有时也是器件的需求.GaAs晶体中引入位错的原因:
a:由应力引入位错,如HB法生长单晶发生粘舟将产生大量位错.
b:生长时引入位错,如籽晶中位错的延伸选择合适的籽晶(如<311>,<511>等),防止粘舟,调整单晶炉热场,稳定生长条件,以及采取缩颈等工艺措施,可以生长出无位错或者是低位错的GaAs单晶.
位错对器件的影响:引起耿氏器件的电击穿,使发光器件发光不均匀,寿命短;也能与点缺陷作用,减少缺陷-杂质络合物的形成.GaAs晶体中引入位错的原因:
a:由应力引入位错,如HB法生长单晶发生粘舟将产生大量位错,LEC中炉内较大的温度梯度,B2O3覆盖的“后加热器”作用
b:生长时引入位错,籽晶中位错的延伸
c:与偏离化学配比有关的点缺陷易于发生堆垛层错,并形成孪晶扰
微缺陷
GaAs中沉淀在GaAs单晶中,掺入杂质的浓度足够高时就会发现有沉淀生成.例如,重掺Te的GaAs中,当掺入的Te浓度比GaAs中载流子浓度大时,有一部分Te形成电学非活性的沉淀.
GaAs中的微沉淀对器件的性能有很大的影响,如Te沉淀物使单异质结激光器内量子效率降低,吸收系数增大,发光不均匀,使器件性能退化.
GaAs晶体的热处理
一般半导体材料dρ/dT<0,本征激发对Gunn氏器件要求dρ/dT0GaAs材料Eg大,本征激发很少外延法生长的GaAs材料dρ/dT0体单晶材料则dρ/dT<0
原因:GaAs材料中存在着较高浓度的深能级缺陷
免责声明:文章来源于网络,不代表本公司观点,如有侵权请联系作者删除。