化学气相沉积装置
有机金属化学气相沉积装置达成上述目的,其特征在于包括:
腔室,提供对基板进行处理的处理空间;气体供给部,向腔室的内部供给处理气体;以及基板支撑部,配置于腔室的内部,具备安装基板的收容槽,对基板进行加热;且在收容槽的内侧形成有安装基板的安装部,在安装部的边缘与收容槽之间形成有中间槽。在基板安装到安装部的情况下,中间槽的宽度可被所述基板遮挡60%至95%。
中间槽可形成为内部的边角具有棱角的形态。在此情况下,中间槽的宽度可为1mm至3mm。
从安装部的上表面测定的中间槽的深度可相对于从基板支撑部的上表面测定的中间槽的深度而为40%至80%。
进而,基板可沿圆形的圆周面而在至少一部分具备平面,收容槽具备从边缘向内侧突出形成而防止基板旋转的突出部。此时,基板的平面可与突出部接触。在此情况下,基板的圆周面与平面接触的角隅区域不与突出部接触。突出部相对于安装部的中心的圆周角度可相对小于基板的平面相对于安装部的中心的圆周角度。进而,能够以可装卸的方式配置突出部。基板支撑部可包括安装基板并加热的加热器区块,从加热器区块的底部向上部形成插入槽,在插入槽的内侧具备测定加热器区块的温度的热电偶。从加热器区块的底部测定的插入槽的高度可相对于加热器区块的高度而为60%至90%。
发明效果
根据具有上述构成的,在基板支撑部的收容槽安装基板的安装部与收容槽的内表面之间形成中间槽,由此引导如颗粒等的异物形成到中间槽,从而可防止在基板配置到收容槽时倾斜地配置的情况。
根据,沿安装基板的收容槽的内侧边缘具备突出部而防止基板旋转,由此可防止基板卡入到收容槽的内部或破损。

图1

图2

图3

图4

图5

图6

图7

图8
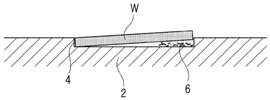
图9

图10

图11
图1是表示一实施例的有机金属化学气相沉积装置的构造的剖面图。
图2是基板支撑部的俯视图。
图3是基板支撑部的局部剖面图。
图4至图8是表示形成在基板支撑部的收容槽的突出部的各种实施例的俯视图。
图9是表示基板支撑部的内部构造的剖面图。
图10是以往装置的基板支撑部的剖面图。
图11是以往装置的基板支撑部的俯视图。
参照图1,有机金属化学气相沉积装置(1000)具备腔室(10)、基板支撑部(20)、气体供给部(30)及反应空间形成单元(40)。
腔室(10)具备:腔室顶盖(11),覆盖腔室的上部;外部壁部(12),紧固到腔室顶盖(11),覆盖腔室的侧部;以及底部凸缘部(13),形成腔室的下部底面。腔室顶盖(11)可通过螺杆等紧固元件以可分离的方式紧固到外部壁部(12),可在腔室顶盖(11)形成冷却流路(11a)。冷却流路(11a)以如下方式构成:供冷却水或冷却气体等冷却介质流动,从而使因在腔室(10)内的沉积制程中产生的高温的热而加热的腔室(10)冷却。
在腔室顶盖(11)设置有作为光学传感器(51)的光测定通路而发挥功能的传感器管(52),光学传感器用以光学测定在下文叙述的反应空间形成单元(40)内沉积到基板上的薄膜。此处,以如下方式构成:对传感器管(52)导入吹扫气体而防止反应气体从反应空间形成单元(40)排出到传感器管(52)。外部壁部(12)以紧固到腔室顶盖(11)且覆盖腔室(10)的侧部的方式构成。外部壁部(12)以如下方式构成:形成排气孔(14),排气孔(14)连接到排气线,从而在沉积制程结束后,通过排气孔(14)与排气线将残留在反应空间形成单元(40)的反应气体排出到腔室(10)的外部。
在外部壁部(12)的内部还可配置内部壁部(12a)。内部壁部(12a)以如下方式构成:以插入贯通的方式设置反应空间形成单元(40),从而可稳定地设置反应空间形成单元(40)。
在腔室(10)的下部设置底部凸缘部(13)。可在底部凸缘部(13)形成冷却流路(13a)。冷却流路(13a)以如下方式构成:供冷却水或冷却气体等冷却介质流动,从而使因在腔室(10)内的沉积制程中产生的高温的热而加热的腔室(10)冷却。
在腔室的内部配置安装基板(W)的基板支撑部(20)。基板支撑部(20)包括:加热器区块(21),安装基板(W)并加热;轴(22),支撑加热器区块(21)并使其旋转;密封部(23);以及感应加热部(24),对加热器区块(21)进行加热。
加热器区块(21)设置有多个收容槽(210、220、230)(参照图2),以便可在上部面安装多个基板(W)。轴(22)以如下方式构成:一末端连接到加热器区块(21),另一末端贯通腔室(10)的底部凸缘部(13)而连接到配置在腔室(10)的外部的旋转驱动部来支撑加热器区块(21)并使其旋转。轴(22)以如下方式构成:在内部设置热电偶(22a)而测定由感应加热部(24)加热的加热器区块(21)的温度来进行控制。之后详细地对热电偶(22a)配置到加热器区块(21)的内部的构成进行说明。
以在轴(22)与腔室(10)的底部凸缘部(13)之间设置密封部(23)来密封旋转的轴(22)与底部凸缘部(13)之间的空间的方式构成。在密封部(23)填充流体密封件,,流体密封件可构成为通过磁性力而气密地密封与外部的空隙的磁性流体密封件。
可在密封部(23)的上部设置隔热部(26),隔热部包围轴(22),防止在沉积制程过程中产生的高温的热传递到腔室(10)及密封部(23)。
感应加热部(24)以如下方式构成:例如,由包围加热器区块
(21)的感应线圈形成,从而对配置在感应加热部(24)的内侧的加热器区块(21)进行加热。可在感应加热部(24)与加热器区块(21)之间配置热障壁(25)。热障壁(25)不仅防止由感应加热部(24)加热的加热器区块(21)的高温的热传递到所述腔室(10)的内部,而且也可保护感应加热部(24)免受加热器区块(21)的高温的热的影响。,热障壁(25)例如可由对高温稳定且热反射率较高的陶瓷原材料形成。
在腔室的一侧设置气体供给部(30)。气体供给部(30)具备分别连接到多个供气线的多个气体供给埠,从多个气体供给源向多个供气线供给处理气体。有机金属化学气相沉积装置(1000)具备设置到腔室(10)的内部的反应空间形成单元(40)。
反应空间形成单元(40)包括设置到与腔室顶盖对应的一侧的上部板(41)、侧部板(、及设置到与基板支撑部对应的一侧的下部板(43),向反应空间形成单元供给反应气体的一侧与连通到排气孔的一侧开口。
反应空间形成单元(40)以如下方式构成:一侧贯通腔室(10)的内部壁部而紧固到气体供给部(30),另一侧连通到形成在外部壁部(12)的排气孔(14)。
可在反应空间形成单元的上部板(41)设置阻热顶盖(44)。阻热顶盖(44)设置到与加热器区块(21)对向的位置,厚于上部板,朝向加热器区块(21)的上部面突出,因此可更小地形成安装在加热器区块(21)的基板(W)上的反应空间。
阻热顶盖(44)与上部板(41)紧固成一体,为了使更换容易,以可与上部板(41)分离的方式构成。阻热顶盖(44)例如可由对高温稳定且热反射率较高的陶瓷材质形成。
腔室(10)的内部温度达到1000℃以上的高温,故而通过利用陶瓷原材料形成包覆加热器区块(21)的热障壁(25)及阻热顶盖(44)而构成为对高温稳定。由此,通过热反射率较高的阻热顶盖(44)可有效率地对基板进行加热,同时可有效率地减少加热基板所需的功耗。在基板上生长薄膜的过程中,在因沉积制程的化学反应而集中地产生副产物的位置设置阻热顶盖来延长零件的更换周期,由此可提高生产效率。
有机金属化学气相沉积装置以如下方式构成:在基板支撑部的收容槽安装基板的情况下,可防止因会形成到收容槽的颗粒等而倾斜地配置基板的情况。
图2是加热器区块(21)的俯视图,图3是加热器区块(21)的局部剖面图。图3的(A)表示收容槽(210),图3的(B)表示在收容槽(210)安装有基板(W)的状态。
参照图2及图3,有机金属化学气相沉积装置(1000)在加热器区块(21)具备收容基板(W)的收容槽(210、220、230)。收容槽(210、220、230)在图中表示为3个,但并不限定于此,可适当地调节。
可在收容槽(210、220、230)的内侧形成安装基板(W)的安装部(212、222、232),在安装部(212、222、232)的边缘与收容槽(210、220、230)之间形成中间槽(213)。
在收容槽(210、220、230)的内侧,在以特定长度朝向上部突出形成的安装部(212、222、232)的上表面安装基板(W),在此情况下,在基板(W)的边缘区域的下部定位中间槽(213)。
此时,平坦地形成安装部(212、222、232)的上表面,因此在安装部(212、
222、232)的上表面安装基板(W)的情况下,不会在基板(W)的下表面与安装部
(212、222、232)的上表面之间产生空间。由于不会在基板(W)与安装部(212、222、232)之间产生空间,因此可防止流入处理气体而产生颗粒、粉末等异物的情况。
中间槽(213)可像图中所示一样形成为内部的边角具有棱角的形态。在此情况下,中间槽(213)的侧剖面形成为具有棱角的四边形等多边形形态,因此非常易于形成具有相对小于无棱角的单纯为圆形的形态的宽度的槽。与圆形形态相比,具有棱角的四边形形态在中间槽(213)的内侧具有相对较广的表面积,因此易于附着颗粒而可不使颗粒露出到中间槽(213)的外部。进而,也可期待中间槽(213)的具有棱角的边角部分阻碍颗粒移动的效果。
其结果,如图3的(b)所示,即便处理气体流入到基板(W)的下部,大部分颗粒等异物也形成到中间槽(213)的内侧。尤其,中间槽(213)的边角形成为具有棱角的形态,因此颗粒等无法沿具有棱角的边角上升而移动,而是聚集到中间槽(213)的底面。因此,不会像以往一样在安装基板(W)的面形成颗粒等,因此在基板(W)安装到收容槽(210、220、230)的内部的情况下,可防止基板(W)倾斜。
在基板(W)安装到安装部(212、222、232)的上表面的情况下,以基板(W)的边缘最大限度地与收容槽(210、220、230)邻接的方式配置。即,以略微大于基板(W)的外径的方式设定收容槽(210、220、230)的内部直径。在此情况下,基板(W)的边缘像图中所示一样遮挡中间槽(213)的宽度(D)的大部分。例如,基板(W)可遮挡中间槽(213)的宽度(D)的50%以上,优选为基板(W)可遮挡中间槽(213)的宽度(D)的60%至95%左右。在中间槽(213)的宽度(D)的大部分被基板(W)遮挡的情况下,可减少流入到中间槽(213)的处理气体的量,从而可抑制颗粒的产生。
根据实验,中间槽(213)的宽度(D)、或安装部(212、222、232)的边缘与收容槽(210、220、230)的内侧面之间的距离(D)可为大致1mm至3mm,且可为大致2mm。可由构成基板支撑部(20)的加热器区块(21)的上表面(21a)至中间槽(213)的底部的深度(B1)、及安装部(212、222、232)的上表面至中间槽(213)的底部的深度(B2)定义中间槽(213)的深度。在此情况下,安装部(212、222、232)的上表面至中间槽(213)的底部的深度(B2)可相对于加热器区块(21)的上表面21a至中间槽(213)的底部的深度(B1)而为大致40%至80%。
可知在像上述内容一样设定中间槽(213)的深度的情况下,由中间槽(213)实现的颗粒引导效果最优异。
有机金属化学气相沉积装置以如下方式构成:在基板支撑部的收容槽安装基板的情况下,可通过防止基板旋转而防止基板卡入到收容槽或破损。以下,具体地进行说明。
图4至图8是表示形成在基板支撑部(20)的收容槽(310)的突出部的各种实施例的俯视图。即,,为了防止基板(W)在收容槽(310)的内侧旋转,具备从收容槽(310)的边缘向内侧突出形成而防止基板(W)旋转的突出部。在此情况下,基板(W)可沿圆形的圆周面(Ws)而在至少一部分具备平面(Wf),在基板的圆周面(Ws)与平面(Wf)接触的区域形成角隅区域(Wc)。在图4至图8中,(a)图是收容槽(310)的俯视图,(b)图是(a)图中的虚线区域的放大图。
参照图4,突出部(314)从收容槽(310)的边缘向内侧突出形成。此时,所
述基板(W)可像上述内容一样沿圆周而在至少一部分形成平面(Wf),突出部(314)以与平面(Wf)接触的方式配置。
即,在以往技术中,基板的角隅区域与收容槽的边缘接触而基板的角隅区域卡入到收容槽,在中,为了解决上述问题,以与基板(W)的平面(Wf)接触的方式配置突出部(314)。因此,在中,基板(W)的角隅区域(Wc)不与突出部(314)接触,从而可防止角隅区域(Wc)卡入到突出部(314)的情况。
为此,在基板(W)安装到安装部(312)的情况下,以相对小于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1)的方式形成突出部(314)相对于安装部(312)的中心(C)的圆周角度(θ2)。
如果突出部(314)相对于安装部(312)的中心(C)的圆周角度(θ2)相对大于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1),则无法防止基板(W)的角隅区域(Wc)与突出部(314)接触。在此情况下,会像上述内容一样产生基板(W)的角隅区域(Wc)卡入到突出部(314)的现象。
因此,在中,为了防止基板(W)的角隅区域(Wc)卡入到突出部(314),以相对小于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1)的方式形成突出部(314)相对于安装部(312)的中心(C)的圆周角度(θ2)。
有机金属化学气相沉积装置(1000)从基板(W)的侧面供给处理气体。如果从基板(W)的上侧或下侧供给处理气体,则基板(W)不旋转,但如果像一样从基板(W)的侧面供给处理气体,则基板(W)会旋转。尤其,如果为了抑制处理气体之间的寄生反应而提高处理气体的气体喷射速度,则基板(W)更容易旋转。
因此,在有机金属化学气相沉积装置(1000)中,即便从基板(W)的侧面供给处理气体,除基板(W)的角隅区域(Wc)以外的平面(Wf)的至少一部分与突出部(314)接触而也最大限度地防止基板(W)旋转,进而,可防止基板(W)的角隅区域(Wc)卡入到突出部(314)。基板(W)的圆周面(Ws)与平面(Wf)接触的角隅区域(Wc)容易破损或损伤,但在中,以不使角隅区域(Wc)与突出部(314)接触的方式配置突出部(314),因此可最大限度地防止基板(W)损伤或破损。中间槽(213)的宽度、或安装部(312)的边缘与收容槽(310)的内侧面之间的距离因突出部(314)而发生变化。
在无突出部(314)的区域,中间槽(213)的宽度(d2)可像上述内容一样形
成为大致1mm至3mm,与此相反,在形成有突出部(314)的区域,中间槽(213)的宽度(d1)形成为相对小于宽度(d2)。在形成有突出部(314)的区域,中间槽(213)的宽度(d1)会相当于无突出部(314)的中间槽(213)的宽度(d2)的大致一半左右。在此情况下,在形成有突出部(314)的区域,固定地保持中间槽(213)的宽度(d1)。
图4的实施例的构成可防止基板(W)旋转,但在基板(W)与突出部(314)接
触的情况下,突出部(314)的面与基板(W)的边角接触,从而防止卡入现象的效果降低。具有突出部(314)的耐久性相对较弱的特性。
图5表示另一实施例的突出部(324)。
参照图5,突出部(324)从收容槽(310)的边缘向内侧突出形成。图5的突
出部(324)的形状与图4的突出部的形状相似,但其宽度及突出长度存在差异。
即,在无突出部(324)的区域,中间槽(213)的宽度(d2)像
上述内容一样形成为大致1mm至3mm,与此相反,在形成有突出部(324)的区域,中间槽(213)的宽度(d3)可相对小于宽度(d2)而为大致20%至40%左右。即,可谓本实施例的突出部(324)呈较图4的突出部更突出的形态。能够以相对小于图4的突出部(314)的方式构成收容槽(310)的圆周方向上的突出部(324)的长度。
与图4的构成相比,图5的构成在基板(W)与突出部(324)接触的情况下,
突出部(324)的面与基板(W)的面接触而基板的卡入程度减小,尤其,突出部(324)的耐久性明显地得到改善。然而,在形成有突出部(324)的区域,中间槽(213)的宽度(d3)相对变小,从而基板的装载/卸载的便利性及固定地保持基板的温度的温度梯度特性具有与图4相似的特性。
图5的突出部(324)也在基板(W)安装到安装部(312)的情况下,以相对小于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1)的方式形成突出部(324)相对于安装部(312)的中心(C)的圆周角度(θ3)。之前已对此进行了详述,因此省略重复的说明。
图6表示又一实施例的突出部(334)。
参照图6,本实施例的突出部(334)在从收容槽(310)的边缘的内侧突出的情
况下呈平行地突出的形态。即,突出部(334)与安装部(312)之间的距离不像图中所示一样固定,而是持续地发生变化。
与图4及图5相比,在图6的实施例中,在形成有突出部(334)的区域,中间槽(213)的宽度相对变小,因此基板的装载/卸载的便利性略微较低,但温度梯度特性明显地得到改善。在基板(W)与突出部(334)接触的情况下,突出部334)的面与基板(W)的面接触,从而表现出基板的卡入现象相对减少,突出部的耐久性也得到改善的特性。
图6的突出部(334)也在基板(W)安装到安装部(312)的情况下,以相对小于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1)的方式形成突出部(334)相对于安装部(312)的中心(C)的圆周角度(θ4)。之前已对此进行了详述,因此省略重复的说明。
图7表示又一实施例的突出部(354、356)的构成。
参照图7,沿收容槽(310)的边缘的内侧具备一对本实施例的突出部(354、356)。
沿收容槽(310)的边缘的内侧而隔以特定距离具备一对突出部(354、356),突出部(354、356)大致突出形成为具有特定的半径的半圆形状、或曲线形状、弯曲(curved)形状等。
在此情况下,形成有突出部(354、356)的区域相对小于上述实施例,故而基板的装载/卸载特性相对变良好。在基板(W)与突出部(354、356)接触的情况下,突出部(354、356)的面与基板(W)的面接触而防止基板的卡入现象,但突出部的耐久性相对变差,基板的外周面与加热器区块(21)之间的距离变远,因此基板的温度梯度特性变差。
在像图7一样具备一对突出部(354、356)的情况下,在基板(W)安装到安装部(312)时,也以相对小于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1)的方式形成一对突出部(354、356)相对于安装部(312)的中心(C)的圆周角度(θ5)。之前已对此进行了详述,因此省略重复的说明。
图8表示又一实施例的突出部(344、346)的构成。
参照图8,与图7的实施例相似地具备一对本实施例的突出部(344、346)。然而,本实施例的各突出部(344、346)以如下方式构成:在从收容槽(310)的边缘突出的情况下,形成突出部(344、346)的两面的长度不同。
即,如图所示,第一突出部(344)以第一面(344A)长于第二面(344B)的方式构成,相同地,第二突出部(346)以第三面(346A)长于第四面(346B)的方式构成。第一突出部(344)的第一面(344A)与第二突出部(346)的第三面(346A)可沿假想线配置。
在此情况下,形成有突出部(344、346)的区域相对小于上述实施例,故而基板的装载/卸载特性相对变良好。在基板(W)与突出部(344、346)接触的情况下,突出部(344、346)的面与基板(W)的面接触,从而防止基板的卡入现象,耐久性也变良好。
在像图8一样具备一对突出部(344、346)的情况下,在基板(W)安装到安装部(312)时,也以相对小于基板(W)的平面(Wf)相对于安装部(312)的中心(C)的圆周角度(θ1)的方式形成一对突出部(344、346)相对于安装部(312)的中心(C)的圆周角度(θ6)。之前已对此进行了详述,因此省略重复的说明。
图4至图8的突出部的构成也可一体地形成到收容槽,但能够以可装卸的方式具备突出部。在此情况下,突出部可包括与区块加热器不同的材质。例如,突出部可由耐久性相对优于加热器区块且耐热的材质制作。如上,在以可装卸的方式构成突出部的情况下,在今后对基板支撑部进行维护等时,可更快且容易地进行维护。
如上,在基板支撑部(20)的加热器区块(21)的内侧具备测定加热器区块(21)的温度的热电偶(22a)。图9是表示加热器区块(21)的内部构成的剖面图。
参照图9,为了装设热电偶(22a),从加热器区块(21)的底部向上部形成
插入槽(29),在插入槽(29)的内部具备热电偶(22a)。在图9中,轴’22’表示轴。
此时,热电偶(22a)可对加热器区块(21)的温度进行测定而推测由加热器区块(21)加热的基板(W)的温度。因此,在加热器区块(21)的内部与基板(W)邻接地配置热电偶(22a)会较为有利。然而,如果为了实现这种配置而使从加热器区块(21)的底部测定的插入槽(29)的高度(h2)与加热器区块(21)的高度(h1)大致相似、或设为90%左右以上,则用以加热基板(W)的热能会通过插入槽(29)排出到腔室(10)的外部。这种情况会降低基板(W)的加热效率而降低沉积到基板(W)的薄膜的品质。在将从加热器区块(21)的底部测定的插入槽(29)的高度(h2)设为加热器区块(21)的高度(h1)的60%以下的情况下,存在如下缺点:与安装晶片的加热器区块上表面的温度的差异较大,因此不适于用作制程反馈温度。
因此,,将从加热器区块(21)的底部测定的插入槽(29)的高度(h2)设为加热器区块(21)的高度(h1)的大致60%至90%左右,优选为设为75%左
右。
在这种构成中,插入槽(29)的高度(h2)相对于加热器区块(21)的高度(h1)而为大致90%以下,因此可抑制用以加热基板(W)的热能通过插入槽(29)排
出的情况。如图所示,以在插入槽(29)的内侧不与插入槽(29)的上表面接触的方式具备热电偶(22a)。因此,在加热器区块(21)旋转的情况下,也可防止热电偶(22a)受损。进而,热电偶(22a)配置到插入槽(29)的内侧而测定加热器区块(21)的温度,因此能够以不根据基板(W)上部的环境改变的情况、例如处理气体变化、压力变化、温度变化等环境变化而敏感地发生变化的状态准确地测定加热器区块(21)的温度。
免责声明:文章来源于网络,不代表本公司观点,如有侵权请联系作者删除。