
扫码添加微信,获取更多湿法工艺资料
在半导体器件制造中,蚀刻是指选择性地从衬底上的薄膜去除材料并通过这种去除在衬底上创建该材料的图案的技术。该图案由一个能够抵抗蚀刻过程的掩模定义,其创建过程在光刻中有详细描述。一旦掩模就位,就可以通过湿化学或“干”物理方法蚀刻不受掩模保护的材料。
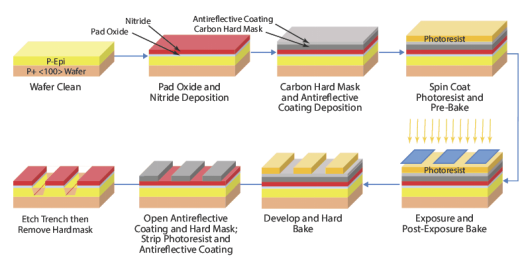
从历史上看,湿化学方法在用于图案定义的蚀刻中发挥了重要作用,随着器件特征尺寸的减小,表面形貌变得更加关键,湿化学蚀刻让位于干蚀刻技术。这种转变主要是由于湿蚀刻的各向同性。湿法蚀刻会在所有方向产生材料去除,如图2所示,这导致掩模定义的特征尺寸与基板上复制的特征尺寸之间存在差异。此外,先进设备中的纵横比(深度与宽度之比)增加,实现这些比例需要使用定向蚀刻技术对材料进行各向异性蚀刻。图3提供了一个示意图,有助于理解各向同性与各向异性特征生成和定向蚀刻。对湿法蚀刻在高级加工中的效用的最后打击可能是这样一个事实,即许多用于器件制造的新材料没有可用于蚀刻的湿法化学物质。这些问题结合在一起使湿蚀刻技术几乎只用于清洁而不是蚀刻应用。只有特征尺寸相对较大的器件才继续采用湿法蚀刻。表面清洁已在 各向异性特征生成和定向蚀刻。对湿法蚀刻在高级加工中的效用的最后打击可能是这样一个事实,即许多用于器件制造的新材料没有可用于蚀刻的湿法化学物质。这些问题结合在一起使湿蚀刻技术几乎只用于清洁而不是蚀刻应用。只有特征尺寸相对较大的器才继续采用湿法蚀刻。表面清洁已在晶圆表面清洁

各向异性蚀刻使用了一系列被统称为“干”蚀刻的技术。干蚀刻可以通过物理方式去除材料,例如离子撞击伴随着材料从基板喷射或通过化学反应将基板材料转化为可以被抽走的挥发性反应产物。干蚀刻技术包括以下常用方法(无论蚀刻过程是通过化学蚀刻、物理蚀刻还是括号中所述的组合进行):各向同性径向蚀刻(化学)、反应离子蚀刻(化学/物理)、溅射蚀刻(物理)、离子铣削(物理)、离子束辅助蚀刻(物理)、反应离子束蚀刻(化学/物理)。所有干蚀刻技术都是在真空条件下进行的,压力在一定程度上决定了蚀刻现象的性质。
基本流程
在许多文本中可以找到对等离子蚀刻基础的深入讨论,在这里,我们仅提供对等离子体生成基本原理的最简要说明。在等离子蚀刻工艺中,有许多物理现象在起作用。当使用电极(在直流电势或射频激发的情况下)或波导(在微波的情况下)在等离子体室中产生强电场时,该场会加速任何可用的自由电子,提高它们的内能(那里在由宇宙射线等产生的任何环境中总是一些自由电子)。自由电子与气相中的原子或分子碰撞,如果电子在碰撞中将足够的能量传递给原子/分子,将发生电离事件,产生一个正离子和另一个自由电子。然而,为电离传递的能量不足的碰撞可以传递足够的能量以产生稳定但具有反应性的中性物质(即分子自由基)。当给系统提供足够的能量时,会产生稳定的气相等离子体,其中包含自由电子、正离子和反应性中性离子。
在等离子体蚀刻工艺中,来自等离子体的原子和分子离子和/或反应性中性离子可用于通过物理或化学途径或通过采用两者的机制从衬底去除材料。纯物理蚀刻(图 4)是通过使用强电场将正原子离子(通常是重惰性元素如氩气的离子)朝向基板加速来实现的。这种加速将能量传递给离子,当它们撞击基板表面时,它们的内部能量会转移到基板中的原子上。如果传递足够的能量,衬底原子将被喷射到气相中,然后被真空系统抽走。入射离子在碰撞中被中和,因为它是气体,它解吸到气相中,重新电离或泵出系统。

化学蚀刻与物理蚀刻的不同之处在于,它利用等离子体内产生的反应性中性物质与基板材料之间的化学反应。最常见的化学蚀刻类型涉及卤化物化学,其中氯或氟原子是蚀刻过程中的活性剂。蚀刻工艺的代表性化学物质是使用 NF3进行硅蚀刻。此蚀刻过程中的化学反应顺序为:
NF 3 + e - → • NF 2 + F • + e -Si(s) +4F • → SiF 4 ↑
NF 3在等离子体中解离以产生高反应性原子氟自由基。这些自由基与衬底中的硅反应生成四氟化硅 SiF 4,这是一种可以被抽走的挥发性气体。以这种方式从衬底蚀刻硅。化学蚀刻与湿蚀刻一样,是一种没有方向性的各向同性工艺(图 5)。其原因是反应性中性物质的粘附系数相对较低,因此与基材表面的大多数碰撞不会导致蚀刻,而是使反应性中性物质简单解吸回气相。这种现象导致被蚀刻的特征内的蚀刻过程的平衡,并最终导致蚀刻中的各向同性特征。

现代器件制造中使用的大多数蚀刻技术都结合了物理和化学蚀刻的各个方面。在反应离子蚀刻等工艺中(RIE),定向蚀刻是通过偏置基板来实现的,这样等离子体中的离子物质会朝着基板表面加速。在那里,它们与表面和反应性中性物质相互作用,产生可以被抽走的挥发性产物(图 6)。RIE 中的离子能量远低于物理蚀刻技术所采用的离子能量,并且离子轰击效应可以忽略不计。离子能量转移到表面可以通过改善反应物在轰击表面上的吸附(进入的离子在吸附和反应优先发生的地方产生高能量缺陷)和通过增强的副产物解吸(进入的离子能量转移到反应产物导致它们从表面解吸)。
注意:此处包含的信息、建议和意见仅供参考,仅供您考虑,查询和验证,不以任何方式 保证任何材料在特定下的的适用性。华林科纳CSE对以任何形式、任何情况,任可应用、测试或交流使用提供的数据不承担任何法法律表任,此处包含的所有内容不得解释为在任何专利下运营或侵如任何专利的许可或授权。