
扫码添加微信,获取更多半导体相关资料
摘要
本文所描述的工作是对氮化镓的表面清洁和欧姆接触策略的系统研究的一部分。本研究的目的是确定最有效的湿化学和热解吸清洗去除氧(O)和C)碳的方法。比较了氢氯(HC1)和氢氟(HF)酸基清洗处理,并在超高真空(UHV)条件下将热解吸作为温度的函数进行了表征。在整个研究过程中,俄杰电子能谱(AES)分析用于监测表面O和C的存在。对于去除表面氧化物,hcl基溶液被发现是最有效的;在清洁的空气暴露条件下,HCI:DIH20(1:1)溶液导致残留的O和C水平最低。然而,hf基溶液导致更有效的从表面热解吸C。与通常观察到的热解吸清洁砷化镓的结果,完全去除暴露氮化镓氧和碳表面没有单独使用真空加热,甚至温度氮化镓分解发生(>800-900℃)。本研究的结果表明,氮化镓表面的氧和碳的存在即使是高温,必须添加进一步的原位清洁方法,以获得光谱清洁的氮化镓表面。
介绍
半导体器件结构之间的表面和界面是固态结构的基本组成部分。随着设备尺寸的缩小和集成规模的增加,这些接口的质量已经成为一个越来越重要的问题。此外,寄生电阻和电容的存在,如在接触界面上存在的电容,在更高的工作功率和更高的振荡频率下变得更加有害。对于许多设备,发生在接触接口上的损失占总损失的很大一部分,因此会对设备造成重大影响的性能。在半导体器件技术的发展过程中,表面清洁程序已经被设计出来脱脂并去除严重污染,去除颗粒和金属原子污染,去除表面氧化物,使表面提供尽可能的原子清洁。在实践中,表面清洁既是一种艺术形式或工艺,也是一种科学;对表面组成和结构的理解往往远远落后于处理步骤的成功应用。程序通常是通过经验推导出来的,很少对所涉及的化学或物理进行详细的调查。
本研究比较了氢氯(HCI)和氢氟(HF)酸作为清洁剂;还比较了水溶液和甲醇基溶液的效果。已知HCI和高频溶液都能去除ga基半导体中的氧化物。然而,有证据表明高频溶液更有效的电和化学钝化,通过“捆绑”暴露悬键与原子氢,使用低分子量有机化合物钝化表面也在本研究中使用甲醇溶液,并与水溶液进行比较,观察由于氧和碳残基与氮化镓表面的键不同而导致的热解吸行为的任何差异。
实验
实验中使用的紫外线、臭氧装置由室内空气中的汞灯组成。样品表面放置在灯表面2-3mm内;典型的紫外线暴露为20min。除接收和紫外、臭氧氧化条件外,连续用三氯乙烯(TCE)、丙酮、甲醇(MeOH)对样品进行溶剂清洗,并在每个酸清洗溶液中浸泡3min。本研究中使用的所有化学试剂均为高纯度电子级;没有使用最终的水冲洗。每次湿式化学清洗后,样品立即用N2吹干,固定在样品支架上,并尽快插入真空系统(基础压力510-9Torr及以下),以尽量减少暴露在室内空气中。在将样品固定到样品块所需的时间内,每个样品不可避免地暴露在空气中约10min。对于热解吸,样品在(UHV)条件下(<室的510-9Torr)使用热丝加热;样品以大约每分钟75~的速度加热,并按所需的速度保存冷却15min后冷却进行分析。
结果和讨论
从各种湿化学溶液中清洗的氮化镓表面中获得的AES光谱如图所示1,以及典型空气暴露条件和紫外线、臭氧氧化表面的光谱。“DI”指去离子水;“溶剂清洗”指传统的三氯乙烯(TCE)、丙酮和甲醇(MeOH)。为了绘制这些数据,氮的峰到峰的高度都被设置为相同的值,以便可以比较氧和碳的相对浓度。峰值高度比的相关数据见表1。氧和碳信号的峰顶高度与氮信号的峰顶高度有关,表明了加氧基和碳基表面覆盖层的相对丰度。比率之所以使用峰值高度,是因为,尽管给定峰值中的计数总数可能因运行而异,但对于给定表面的相对峰值强度保持不变。在接收到的表面使用紫外线、臭氧氧化导致O大量增加,C覆盖率略有增加,这并不奇怪。
其他最近的热解吸实验的结果NCSU在真空中执行类似氮化镓薄膜迄今为止表明,O和C没有完全消失,甚至氮化镓分解发生的温度(>800-900℃)。这些观察形成成熟的,通常直接的砷化镓表面氧化物的热行为。活性物种的存在来帮助表面去除(例如,氢等离子体,离子轰击等)。在NH3通量中加热以抑制氮化镓分解,预计会产生比真空中简单的热解吸更清洁的表面。在这方面的一个重要考虑是目前关注H及其补偿体杂质的作用。寻找一种尽可能获得原子“原始”表面的方法,必须包括与表面清洁程序有关的可能发生的任何表面损伤或其他性质退化的特征。
在清洗方法中使用电离的、加速的气相物质很可能会造成一些表面损伤,这取决于电离物质的动能和质量。也有湿化学清洗步骤也可能造成一些表面损伤;有迹象表明,即使短期暴露于酸水溶液也会导致砷化镓表面微脱落,随着暴露时间的增加而增加。

图1 用不同化学处理清洗的氮化镓表面的AES测量光谱
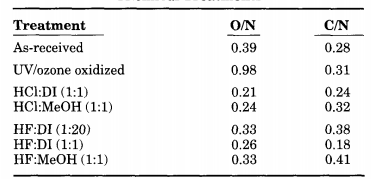
表一 不同湿化学处理处理的氮化镓表面的相对雾峰强度

图3 高频清洗后的氮化镓表面的AES测量光谱随温度的变化
结论
本研究进行的表面清洁实验结果表明,氮化镓表面的清洁溶液的选择取决于在后续处理步骤之前是否在真空中进行热解吸。在这里研究的湿化学清洗方法中,HCI:DI(1:1)溶液在清洁的表面残氧和碳水平最低。所有检测的涉及心衰的清洁方法最初都发现在表面留下更多的氧和碳。相比之下,我们发现基于hf的清洁处理可以更有效地从表面解吸C。与砷化镓的热解吸清洗中通常观察到的结果相反,仅使用真空加热没有完全去除空气暴露的氮化镓表面的O和C,即使是氮化镓分解的温度(>800-900℃在加热到800℃后,特别是HF:MeOH样品,经历了大量的C去除;然而,残氧覆盖并没有低于HCl清洗表面的水平。除了简单的湿式化学清洁和热解吸外,进一步的原位处理是必要的,以实现光谱清洁的氮化镓表面。
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁