
扫码添加微信,获取更多半导体相关资料
引言
氢氧化钾溶液中硅的各向异性刻蚀是微机械加工中的一项重要技术。氢氧化钾蚀刻硅的残留物沉积通常被认为是该技术的缺点。在这份报告中,我们利用这种残留物作为第二掩模层来制造两层复杂结构。设计并测试了尺寸在15-150米范围内、间隙距离为5米的方形图案。当衬底在氢氟酸溶液中被过度蚀刻超过阈值时,出现残余掩蔽层。根据二氧化硅和残留物两种不同的掩蔽层,得到了由类壁结构包围的两层微锥结构。残余掩蔽层是稳定的,并且可以在氢氧化钾蚀刻中存活很长时间,以实现深硅蚀刻。研究了刻蚀剂浓度、温度、刻蚀时间和图形尺寸等工艺参数。通过良好控制的两层结构,可以设计有用的结构用于未来的等离子体和微流体装置。
介绍
氢氧化钾蚀刻硅的残留物沉积是众所周知的,这通常被认为是这种制造技术的缺点。在这项工作中,我们利用残余物作为第二掩模层来制造两层微结构。不同图案尺寸的方形阵列微机械从15到150米和5米的间隙距离已经被设计和测试。正常的微锥可以通过在氢氟酸和氢氧化钾溶液中蚀刻控制良好的二氧化硅和硅来制造。当衬底在HF中被过度蚀刻以获得更大的间隙时,第二层壁状结构出现在第一层微锥体之间。仔细控制制造参数,两层结构尺寸可以精确调整。残留物掩蔽层坚固稳定,比氢氧化钾蚀刻的二氧化硅掩蔽层存活时间更长,最终导致反转结构。
双层微/纳米结构对于实现分步乳化微流体装置]和超疏水表面非常重要。使用标准的微制造技术,通常需要两次光刻和湿法蚀刻来获得两层微结构。通过这种方法,可以在简单的一步光刻和湿法蚀刻工艺中制造两层微结构,这对于制造等离子体功能器件非常有用微流体应用。
结果与讨论
通过在氢氧化钾蚀刻溶液中对硅表面进行各向异性蚀刻,可以制造微米至纳米尺寸的金字塔。金字塔的形成既与任何特定的氢氧化钾供应商无关,也与掩模或光刻问题无关。通常,氢氧化钾蚀刻的金字塔具有精确的几何形状。根据实验条件,可以观察到两种类型的金字塔:矩形底座或八角形底座[21]。
通常,根据KOH溶液中< 100 >和< 110 >平面的各向异性蚀刻获得金字塔。在这项工作中,我们设计了15至150米的正方形图案,间距为5米。通过控制在HF溶液中的蚀刻时间,二氧化硅(用于KOH蚀刻的第一掩模层)的开口随着蚀刻时间而变化。通过严格控制在氢氟酸溶液中的腐蚀时间,我们获得了简单的微锥结构。然而,在HF溶液中延长的蚀刻时间扩大了硅衬底上二氧化硅的开口尺寸,这导致与大量产物的快速反应,这些产物将沉积在用作第二掩模层的硅表面上,以在第一层微锥体之间产生第二层壁状结构。
一步湿法刻蚀获得的两种微结构 略
高频刻蚀时间对双层结构的影响 略
图4:第二层壁的宽度随氢氧化钾浓度而变化。(b)第二层壁的宽度(W2nd)随着氢氧化钾溶液中的蚀刻时间而变化。样品图案为50米~ 50米见方,间距为5米。每个数据点是通过对三个样本的值进行平均而获得的。所有样品在氢氟酸溶液中蚀刻1.5分钟。蚀刻时间和温度为30分钟和70 ˝c(a)。对于(b),KOH浓度为10 wt % KOH,蚀刻温度为70 ˝C。
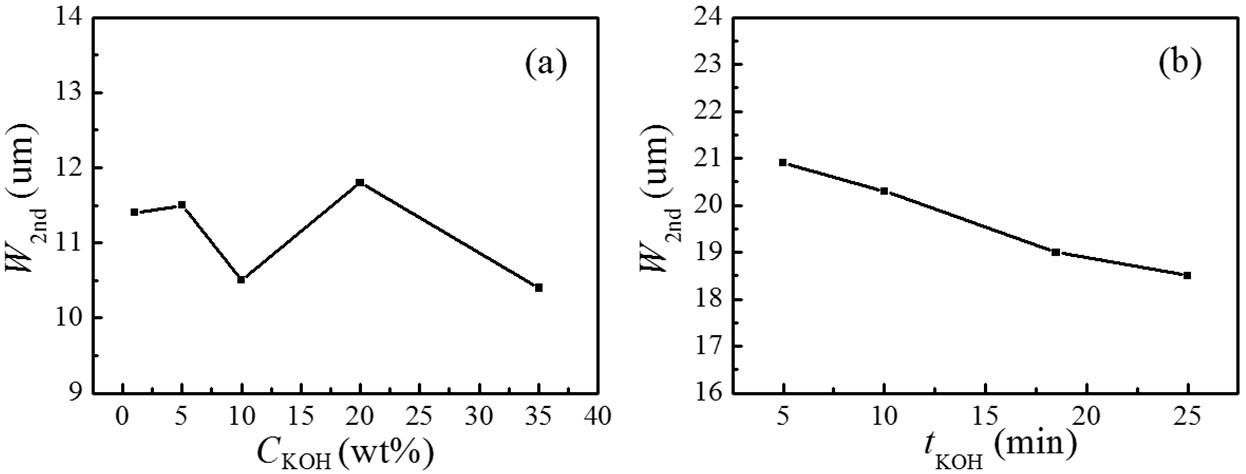
样品在氢氟酸中腐蚀1.0分钟,得到简单的单层微锥。当tHF增加到1.5、2.0和3.0 min时,观察到明显的双层结构。当tHF = 1.5分钟时,微锥体(第一层)和壁状结构(第二层)的高度为15.1和11.8米,当tHF = 2.0分钟时,为9.9和8.1米,当tHF = 3.0分钟时,为3.1和8.6米。因此,对于1.5、2.0和3.0 min的tHF,第一层和第二层之间的高度差分别为3.3、1.8和5.5 m。在tHF = 1.5 min时获得最大的第二层壁状结构。在tHF = 3.0 min时,获得了一种特殊的结构,其中微锥小于壁结构。从扫描电镜图像的细节可以看出,二氧化硅层在氢氧化钾蚀刻过程中消失,留下其覆盖的硅完全开放,用于氢氧化钾蚀刻,这导致微锥体收缩。然而,壁状结构在所有蚀刻过程中都是稳定的,显示出强而宽的壁结构。因此,我们可以得出结论,两层复杂结构是根据两个掩蔽层产生的:第一二氧化硅掩蔽层和第二残留物掩蔽层是由氢氧化钾和硅的反应产物在开放区域的快速积累产生的。
总结
在这项工作中,我们设计了用于在二氧化硅作为掩模层的硅衬底上制作微锥体的微图形。通过在HF溶液中控制蚀刻以在大约5 m处打开蚀刻进入孔,已经获得简单的单层微锥体。通过在HF溶液中过蚀刻衬底,获得了由第二层壁状结构包围的第一层微锥体的两层复杂结构。由于正方形图案的尺寸在15至150米的范围内,且具有5米的间隙距离,因此在广泛的制造条件下已经获得了可再现的双层结构。作为例子,当HF蚀刻时间大于1.5 min时,出现50 μm ~ 50 μm的具有5 m间隙的两层微锥。随着HF中蚀刻时间的增加,第二层壁状结构的宽度和高度增加,而第一层微锥的高度和宽度减小。KOH精矿对壁状结构尺寸影响不大;然而,由于平面选择性和蚀刻速度,它确实影响微锥体的形状。残留物掩蔽层坚固稳定,可承受长时间的氢氧化钾蚀刻。对于留下较少二氧化硅的长时间HF蚀刻,第二层掩模可以在KOH溶液中长时间蚀刻后诱导反转结构。利用残留物作为第二掩模层在硅衬底上制造可控微结构是一种简单而有用的方法,它将用于制造各种应用于等离子体、微流体和超疏水表面的结构。