
扫码添加微信,获取更多半导体相关资料
本方法一般涉及半导体的制造,更具体地说,涉及在生产最终半导体产品如集成电路的过程中清洗半导体或 硅晶片,由此中间清洗步骤去除在先前处理步骤中沉积在相关硅晶片表面上的污染物。
典型的,在生产复杂的半导体产品,例如集成电路器件时,需要数千个加工步骡来获得最终产品。为了提高利润,重要的是在加工期间从单个硅晶片获得的有用集成电路器件的产量或数量最大化。因此,半导体制造商在半导体器件的制造过程中需要提供最长的寿命。这种器件通常在洁净室条件下制造,以便在加工过程中基本上消除任何空气污染物到达硅晶片表面,并降低产量。
此外,在硅晶片的实际加工过程中,某些其它加工步骤本身可能导致污染物沉积在晶片表面上,使得在预定的加工步骤完成之后,有必要在进行后续加工或制造步骤之前清洁晶片表面,以确保所生产的器件具有最高的可能产量。
半导体产品制造过程中的典型清洗周期包括湿晶片清洗,其通常包括多个清洗步骤。最初的步骤通常包括将化学制品和水的混合物喷洒到晶片表面上,或者将晶片浸入这种混合物中,随后是水冲洗步骤和干燥步骤,之后硅晶片进行进一步的器件处理。在半导体制造中经常使用本领域中通常称为“RCA-clean”的清洗顺序。“RCA, clean'中使用的步骤之一通常被称为“SCI”步骤,用于从被处理的硅片表面去除颗粒。然而,“SCI”步骤傾向于增加晶片表面的金属污染,需要后续的清洗。
本方法的一个目的是在半导体器件的制造过程中,在清洗序列之后,降低硅晶片表面上的金属液度。本方法的另一个目的是改进被称为“RCA-clean”的清洗顺序,用于显著减少以这种顺序清洗的晶片表面上的金属污染。
下面参考附图描述本发明的各种实施例:
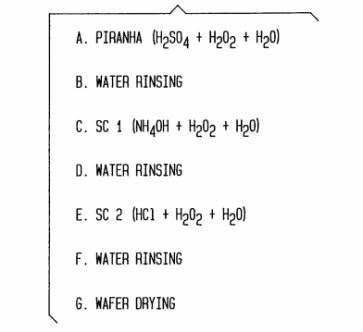
图1 示出了通常被称为“RCA清洁”的半导体制造清洁序列的流程图
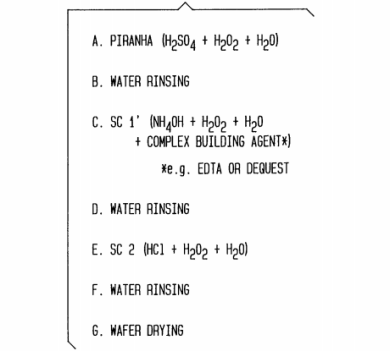
图2 本方法一个实施例的半导体制造清洁序列的流程图
在半导体制造中,通常对硅晶片进行处理,以化学和物理方式改变晶片。这种处理可以包括在由基础硅晶片提供的衬底上外延生长半导体材料层的步骤。在处理时蚀刻部分,将晶片的部分掺杂成具有n或p的导电率,等等。在生产集成电路设备所需的典型数千个步骤中,例如,在一系列此类步骤的结束时,有必要引入一个清理序列。一个这样的预先清洗序列通常被称为“rca清洁”,如图1所示,包括多个步骤B到G。通常在现有技术中,作为步骤“A”或“ PIRANHA”步骤的附加步骤被添加到“RCA-clean”步骤“B”到“G”中,以提供如图所示的“ PIRANHA-RCA”清洗序列。
通常在现有技术中,作为步骤“A”或“PIRANHA”步骤的附加步骤被添加到“RCA-clean”步骤“B”到“G”中,以提供如图所示的“PIRANHA-RCA”清洗序列。在“A”到“G”的步骤中,“A”或“PIRANHA”中的有机污染物从被清洗的硅片中去除;在步骤“C”或“SC1”颗粒从硅片中去除;在步骤“E”或“SC2”金属污染物从硅片中去除。步骤“B”、“D”和“F”是水冲洗步骤,步骤“G”是晶片干燥步骤。
最近有技术中发现,相对于“原始rca-clean”公式中使用的浓度,使用“rca清洁步骤的稀释化学”在清洗硅晶圆中可以获得基本相同的结果。如下表1所示,显示了原始和稀释的“PIRANHA-rca”清洗步骤“A”、“C”和“E”的化学物质和浓度。

表一
表1所示的化学溶液可以通过喷雾工具应用于硅晶片,其中溶液或混合物直接喷洒在晶片上,或者硅晶片浸在罐工具中包含的化学混合物或溶液的槽中。一种常用的喷雾工具是“FSIMECURYOC”。此外,常用的坦克工具包括“Pokorny湿板凳”,“SMS湿板凳”,一款“DNS自动清洁器”,或“三济汽车清洁”中的任何一个。
我们认识到,金属浓度留下了用图中的“Pira-40nha-RCa”序列清洗过的硅晶片的N表面。通常保持高于预期,导致在复杂集成电路如64MDRAM和256MDRAM的制造过程中产率降低。我们发现,通过修改图中“PIRANHARCA”清洗序列的步骤“C”或“SC1”步骤,可以大大减少金属污染问题。以这种方式,金属络合物保持结合在溶液中,从而防止相关的金属污染被清洗的硅晶片的表面。如下表2所示, 铁(Fe)的浓度。
在本方法的优选实施例中,我们发现在图2的修改清洗序列的修改步骤“C”或“SC1”步骤中,EDTA的浓度在0.05mg/l到0.01mg/l之间提供了最佳的结果。然而,所需的EDTA浓度取决于溶液中使用的其他化学物质的浓度,包括是否使用原始或稀释的化学物质“PIRANHA-rca”。例如,在原始Pira的“SC1”步骤中添加0.10mg/lEDTA得到最佳结果。
还要注意,本方法的清洁顺序改进不能用于喷射工具。原因是化学物质混合和硅晶片加工之间的时间太短,不能形成化学复合物。因此,本发明的改进工艺要求在图2的步骤“C:中使用槽工具清洗硅晶片。
此外,自动注射器可以包括在清洁系统硬件中,用于向清洁溶液中添加预定量的复合助洗剂,用于图2的清洁序列的“SCI”步骤。尽管上面已经示出和描述了本方法的各种实施例,但是它们并不意味着是限制性的。