
扫码添加微信,获取更多半导体相关资料
引言
电子工业中用于集成电路的典型硅片是由直拉法生长的硅单晶锭切割而成的。这种单晶是从石英坩埚中的熔体中拉出的,该坩埚将氧原子结合到硅晶体中。氧原子占据硅晶格中的间隙位置,并能形成二氧化硅团簇的核。这种硅晶体的热处理引起氧扩散和氧沉淀物的生长。晶体生长过程中每个晶片的热历史负责晶体不同部分中间隙氧和氧化物核的各种分布。本文研究了不同温度工艺后直拉硅单晶中的氧沉淀,研究了不同温度预退火对氧沉淀的影响,其中温度历史没有完全消除,只是达到了不同的抑制阶段。通过红外(IR)吸收光谱测量使用不同温度和时间的没有和具有TR预退火的样品,并将结果与化学蚀刻和透射电子显微镜(TEM)进行比较。本文还讨论了从锭头和锭尾观察到的晶片温度历史的影响。
实验
我们探讨了从两个1.5毫米厚的硅晶片上切下的样品中氧的沉淀过程。一个样本是靠近直径为150毫米的直拉法生长晶锭的起点{S}和另一个靠近终点{E}切片。该晶锭掺硼,电阻率为3-5Ω·cm,晶片表面的晶体取向为(111)。
两个晶片{S,E}被一起分成10个系列的矩形样品(尺寸约为20 mm × 15 mm):五个系列的样品来自锭头{S},另外五个系列的样品来自锭尾{E}。每个系列进行各种TR退火:TR 1和TR 2–分别在1000℃和1100℃下退火6分钟,TR 3和TR 4–在与TR 1和TR 2相同的温度下退火24分钟,加上一个标为R的系列作为参考,没有TR过程。在下一步中,使用以下三步处理对所有样品进行退火:600℃退火8小时(成核),800℃退火4小时(均化)和1000℃退火不同时间t(沉淀)。每个系列包含几个具有合适的沉淀时间t范围的样品。选择时间t,使得间隙氧的衰减在温度1000℃下很好地向平衡氧浓度ceq收敛。由于实验的目的是研究TR对降水的逐渐影响,只是部分消除了热历史,所以我们使用1000℃和1100℃的预退火温度来代替其他工作中使用的RTA。两种晶圆通用的热处理概述如表1所示。
所有样品的温度处理都是在传统的实验室炉中使用氮气流大气中进行的。晶片在退火前进行化学抛光,以消除样品边界上滑动错位的产生。通常在退火前后通过化学清洗去除20mm厚的表层。

表1 对两个样品系列进行热处理:从铸锭开始{S}和从铸锭结束{E}
结果和讨论
文中给出了透射光谱的测量结果,以便获得二氧化硅沉淀的纯吸收光谱。通过减去含有最少量间隙氧(8.6×1015cm-3)的浮动区硅谱,从硅谱中去除了多声子吸收带。为了区分间隙氧和氧沉淀的贡献,将在77 K下测量的退火样品的光谱与在生长的参考样品上测量的光谱进行了比较。
根据前文所述的理论,由椭球体沉淀的长径比双驱动的变化去极化因子Li控制了吸收光谱中最高最大值对应的吸收带的位置。球形二氧化硅沉淀的最大值略低于1100cm-1,而二氧化硅圆盘沉淀的最大值约为1250cm-1。对于椭球体的氧气,根据长宽比沉淀最大位移。
图1和图2根据中描述的模型拟合,还显示吸收系数光谱的模拟结果中使用三种不同长宽比的沉淀物。更多不同的类型会导致更好的拟合,但是拟合模型的条件会更少。由于在测量的光谱中可以清楚地观察到三个吸收带,我们将模型限制为三种不同的类型——长宽比,其中每种类型也可以具有不同的体积分数和化学计量比。因此,沉淀物由三种共存的稀释二氧化硅椭圆体表示,它们具有三种不同的纵横比bi和体积分数fi。从拟合吸收光谱获得的二氧化硅x3圆盘的化学计量演化与测量值的比较如图3所示,对于来自两个晶片的所有样品。结果表明,在接近晶锭开始的晶片中出现了片状沉淀物。
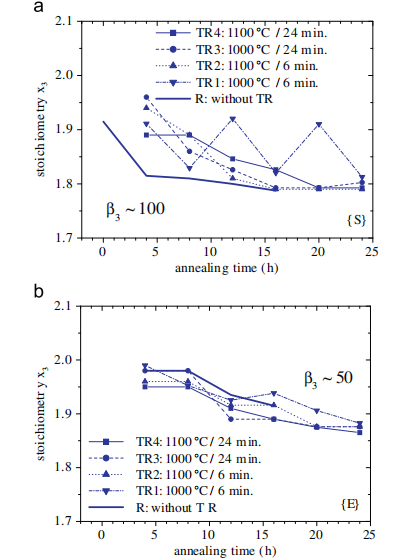
图3 对于不同预热的样品组,绘制了板状沉淀物(纵横比cca 50和100)中氧的化学计量的演变
二氧化硅椭偏体的稀释溶液模型也允许我们确定由吸收光谱强度确定的特定类型沉淀物的体积分数fi,见等式。从所有三种假设类型的椭球体的体积分数f获得的沉淀物内部氧浓度的增加如图5所示。此外,沉淀氧总浓度的演变,如图最左图5所示,表明1000℃6min时TR过程的沉淀受到明显抑制,而1100℃24min时的TR导致氧沉淀更类似于没有TR的参考样品。这种沉淀生长的延迟趋势在所有假设类型的沉淀中都是明显的。另外,在靠近钢锭开始的晶片中,板样沉淀在最长退火时达到长宽比,而TR处理过的样品并非如此。在接近钢锭末端的地方,预退火和未预退火的样品之间的晶圆片的差异并不显著,因为在这种情况下,温度历史要短得多。
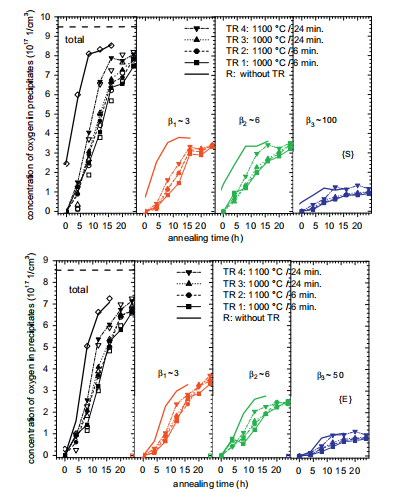
图5 根据不同预热样品组的红外光谱确定沉淀物内部氧含量的增长
从铸锭的开始和结束开始,在晶片中采用四种不同的TR过程实现了温度预退火对沉淀的影响。退火过程中间氧损失值和氧沉淀拟合谱的参数对预退火具有显著的敏感性。在沉淀过程中,我们观察到在标准热处理前使用较低的温度和较短的TR,在沉淀退火过程中,Oi的衰减速度较慢。在没有TR工艺的晶圆中,1000℃12h后氧气已经完全沉淀,但最短的TR工艺至少延长沉淀两次,见Ref中接近锭种子的晶圆的结果。
总结
在本文中,我们研究了在籽晶处和晶锭端部切片的直拉硅片中的氧沉淀,这些硅片通过各种热处理和各种高温预热进行处理。从红外透射光谱我们了解到沉淀物的形态已经在成核和稳定化退火过程中形成,而化学计量仍然在板状团簇的沉淀过程中演变。球形二氧化硅沉淀的化学计量变化低于检测限。高温预退火的效果影响所有的沉淀物,这些沉淀物的体积分数随着预退火温度的降低而降低。这种效应在来自晶锭籽晶的晶片中更明显,在晶锭籽晶中,晶片的温度历史比接近晶锭末端的晶片更显著。由于吸收光谱对盘状沉淀物的敏感性增加,我们能够更好地观察到板状沉淀物的化学计量和纵横比的变化,而不是球状沉淀物的变化。