
扫码添加微信,获取更多半导体相关资料
本文章将对表面组织工艺优化进行研究,多晶硅晶片表面组织化工艺主要分为干法和湿法,其中利用酸或碱性溶液的湿法蚀刻工艺在时间和成本上都比较优秀,主要适用于太阳能电池量产工艺。本研究在多晶晶片表面组织化工艺常用的HF/HNO3混合溶液中加入CH3COOH进行了实验,通过湿法蚀刻工艺得到的多晶硅晶片的反射率和太阳能电池的光转换效率变化,试图为湿法蚀刻找到合适的条件。
湿法蚀刻工艺主要用于多晶晶片的表面组织化,在多晶晶片中,每个晶粒的蚀刻形状都不同,因此采用酸溶液各向同性蚀刻,湿法蚀刻的酸溶液是HF和HNO3,虽然常见的是与DI混合的溶液,但也会加入CH3COOH,观察各溶液的化学反应式和机理,HNO3与Si作用首先产生SiO2氧化物,SiO2被HF蚀刻生成H2O和H2SiF6,H2SiF6 由于是水溶性物质,对化学反应作用影响不大。
通过改变湿法蚀刻溶液中HNO3和HF的浓度,可以改变蚀刻速度和表面组织化,H2O稀释了HNO3的浓度,CH3COOH减少了HNO3的降解,从而对蚀刻速度产生影响。 本实验通过相同条件的溶液给蚀刻时间以变化(15秒、30秒、45秒、60秒),分析表面形貌变化,并进行反射率及效率测定。实验使用的基片为boron兴奋剂的p-type多晶晶片,具有1~3·cm,具有非电阻、200微米厚、尺寸为15.6×15.6 cm2.实验进行顺序如图1所示。
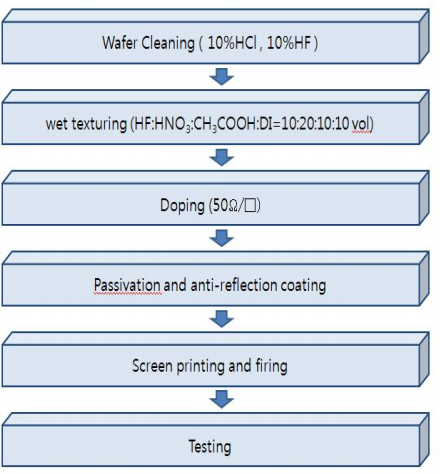
图1
用HF(50%)对基片进行表面组织, 采用HNO3(65%)、CH3COOH(99%)和DI(校准)water,并以10:20:10:10(vol)的比例混合。为了分析texturing时间可变后的太阳能电池特性,将texturing时间可变为15秒、30秒、45秒、60秒。 在Texturing工艺后,用光学显微镜(OM)分析了表面现象,并用UV-VIS/NIR spectrophotometer在300~1200nm波长范围内测量了反射率,为了将氮化硅膜用作防反射膜,利用PECVD设备,所用气体为SiH4、NH3和Ar,混合气体的比例为1:2:25.利用Elipsom测量的厚度和折射率分别为75nm和2.1。防反光膜沉积后进行了电极形成工艺,利用了网印的方式,后印、干燥后前印、干燥的顺序形成电极,电极材料与常规工艺一样,背面采用Al菲,正面采用Ag菲 (c)正面的图案采用了具有80μm finger厚度、2.4 mm finger间距、2mm busbar厚度的图案。
为了电极形成后硅基板与电极的contact,进行了烧成工艺,采用了5个区间温度可控的inline beltfurnace,所用温度条件为400-425-450-550-880度,烧成工艺 后采用532nm Q-Switched Nd:YVO4 laser进行了侧向分离工艺。
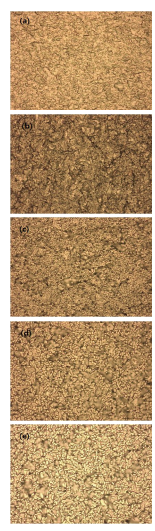
图2
图2显示了HF(5O%): HNO3(65%): CH3COOH(99%):DI中的10:20:10: 在以10(vol)的比例混合的溶液中加入15秒,30秒, 通过45秒、60秒的时间变化,用光学显微镜(OM)观察变化的样子,在15秒的条件下,硅微泡表面还没有形成表面组织,随着时间的推移,我们会看到组织的形成,在15秒工艺条件下,可以看出原来体积较小的表面组织形貌随着时间的推移逐渐增大,数量减少,这是随着工艺时间的延长而形成的表面组织相互合并而形成的。 即尺寸增大的同时数目逐渐减少,表面组织的大小和数目对晶体晶片的反射率有影响,而随着工艺时间的延长,蚀刻量增加,厚度越来越薄。
表面形态及厚度随时间变化的平均反射率测量结果显示在图3中,在300~1200nm波长范围内,barewafer的反射率为32%,但随着工艺时间的延长,在15秒时 反射率为24.7%,30秒后平均反射率上升。
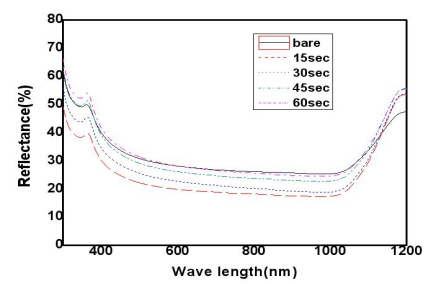
图3
图3是反射率测量结果的曲线图,在400∼600纳米波长范围内,60秒时反射率最高,在600∼1000纳米波长范围内,bare状态的反射率最高。在1000∼1200纳米波长范围内,反射率最高,bare状态的反射率很低,综合来看,最初bare状态下,通过texturing在表面上没有形成表面组织,所以平均反射率很高,给15秒的时间,表面组织的形态细长,形成了,光入射的角度也提高了,形成了一个能锁住很多光的结构,反射率最低,但是随着时间的推移,像针孔这样的窄宽度表面组织的数量增加了,多晶硅晶片在acid溶液中的texturing过程是可以理解的,HNO3溶液中的O2在texturing过程中形成氧化膜,有助于部分蚀刻,但随着texturing时间的增加,O2含量减少,最终表面逐渐polishing,反射率降低。
本研究了解了多晶硅太阳能电池表面形态的反射率和效率变化, 以相同溶液为基准,从晶片表面随时间的变化来看,在15秒时反射率最低,并且可以看到反射率随时间增加的现象。在45秒时,光转换效率最高,15秒时效率最低,确定了低反射率与高效率不直接相关。这是因为表面状态不同对后续工艺的影响较大,其中电极形成工艺受影响较大。考虑了后续工艺的表面,组织研究将是必要的,特别是对低反射率和易于形成电极的表面进行研究。 总之,为了接近太阳能电池的低价化和高效率,可能需要通过大量的研究来分析部分因素,并向更高的效率靠拢。