1理论分析化合物半导体器件绝大多数都是采用外延层做有源层,单晶做衬底。影响晶片表面质量的抛光及抛光后表面的清洗处理成为影响外延质量的重要因素。高质量的免洗抛光片的表面应当具备以下要素:表面无颗粒、有机物、金属离子沾污;表面氧化层必须能够在高温处理下完全去除;抛光片表面去除氧化层后必须平坦均一。微粒往往被认为是表面污染源的点源,表面颗粒会引起图形缺陷、影响外延质量布线的完整性以及键合强度和表层质量。研究表明,当表面颗粒度小于10@013μm时,不会影响外延质量。金属离子沾污会破坏薄氧化层的完整性,增加漏电流密度,影响器件的稳定性,增加暗电流,造成结构缺陷或雾状缺陷。Cu、Au、Fe等重金属元素形成深能级而降低少数载流子的寿命,并产生晶格缺陷。因此,清除这些金属杂质是十分必要的。在晶片中,金属离子污染物个数必须被控制在1010/cm2甚至更少。表面有机沾污容易使外延片表面出现白斑,蜡和有机试剂是重要的污染源,因此表面去蜡和去除有机试剂必须彻底。尽管抛光片包装在惰性气氛下,但晶片表面自然氧化层早已在包装前形成。当外延生长温度加热到580℃以上时,GaAs晶片表面的自然氧化层便会自动分解去除。但当温度高于450℃时,由于As2O3的挥发,原来的Ga2O3和As2O3按化学计量比组成的混合物将变成纯净的Ga2O3。研究表明,在去除表面氧化层的过程中有挥发性的Ga2O的产生,反应过程为

当氧化层很薄时,氧化层与衬底交界面的反应很容易穿越表面使得Ga2O3的去除非常容易;但是当氧化层较厚时,反应仅发生在氧化层比较薄的地方,氧化层的去除将会不协调并在表面形成岛状。所以表面具有均匀的富As的薄氧化层非常必要。
2清洗过程分析
2.1清洗前准备晶片采用低温液体蜡(SKYLIQUIDGP3011AT2)进行粘片,通过化学机械抛光后,将晶片从陶瓷盘上取下装入洁净的白花篮中准备去蜡。
2.2背面蜡层去除去蜡通常采用有机溶剂浸泡溶解或专用去蜡水超声去蜡的方法。通常采用KILALACLEAN101去蜡水超声去蜡,但由于去蜡水本身的强碱性,As2O3和Ga2O3均为偏酸性两性氧化物,采用去蜡水去蜡后将会使晶片表面抛光后形成的氧化层溶解,使得抛光片表面的砷镓元素化学计量比发生偏移,改变表面的微观形貌。为了尽可能的保持晶片抛光后的表面状况,采用MOS级异丙醇超声去蜡。去蜡在通风橱内进行,采用超声波清洗机分3次超声去蜡,每次5min,温度控制在25~30℃。由于液体蜡在异丙醇中的溶解度很高,异丙醇为中性有机溶剂,又极易溶于水,相对于使用的液体蜡,是一种理想的去蜡剂。
2.3表面颗粒、残留有机物和沾污金属离子的去除兆声波清洗是湿法化学清洗的重要方法,极利于表面微粒的去除,兆声波清洗的机理是利用高能(850kHz)频振效应并结合化学清洗剂的化学反应对晶片进行清洗的。清洗时不形成超声波清洗那样的气泡,只以高速的流体连续冲击晶片表面,使晶片表面附着的污染物和微粒被强制除去并进入到清洗液中[1],兆声波清洗原理如图1所示。这种方法能同时起到机械擦片和化学清洗两种方法的作用。采用5种不同配比的溶液进行兆声清洗,溶液中均添加一定量的表面活性剂。工艺过程如表1所示。
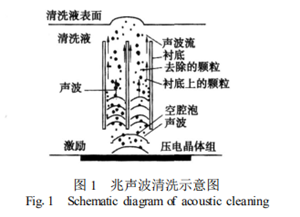

表1中所用试剂均为高纯试剂,NH4OH为氨水;H2O2为双氧水;KOH为40%氢氧化钾。
3测试结果分析311表面金属离子浓度测试通过全反射X荧光光谱(TXRF)对表面金属离子浓度进行测试,测试结果如表2所示(表中Natom为离子个数)。通过H2O2的强氧化和NH4OH的溶解作用,使有机物沾污变成水溶性的化合物,随去离子水的冲洗而被排除。由于溶液有强氧化性和络合性,能氧化Al、Fe、Mg等使其变成高价离子,然后进一步与碱作用,生成可溶性络合物随去离子水的冲洗而去除。但这种清洗很难完全去除Cu、Au等贵金属,必须采用电负性更强的盐酸或氢氟酸与双氧水混合溶液来去除。通过数据测试发现方案3的金属离子浓度总体较低。

3.2表面As/Ga比和表面粗糙度测试通过XPS对表面As/Ga原子物质的量浓度比进行测试并采用Tencor2AS2500台阶仪测试晶片表面粗糙度,结果如表3。

GaAs抛光片表面的自然氧化层主要由Ga2O3、As2O3、As2O5和As组成[2],As2O3、As2O5和Ga2O3均为偏酸性的两性氧化物,在碱性溶液中形成可溶性的亚砷酸盐、砷酸盐和镓酸盐,在酸性溶液中形成各自的盐溶液,其反应式为
H2O2→H2O+(O)(2)
2GaAs+6(O)→Ga2O3·As2O3(3)
Ga2O3·As2O3+12[H+]→2As3++2Ga3++6H2O(4)
As2O5+10[H+]→2As5++5H2O(5)
Ga2O3·As2O3+12[OH-]→2AsO3-3+2GaO3-3+6H2O(6)
s2O5+6OH-→2AsO3-4+3H2O(7)

5结语为了提高LED热阻测试精度,应根据功率电流来选择适当的测试电流,选择多点拟合出温度系数,精确控制和测量壳温,选择恰当的功率加热时间。本文根据实验室积累多年的热阻测试数据和统计结果,列出大功率LED稳态结到壳热阻的测试步骤,根据各个步骤的误差来源提出较准确的修正方法,并设计简单的试验来验证测试结果,希望能够为LED热阻测试标准提供参考。
免责声明:文章来源于网络,如有侵权请联系本网站删除。