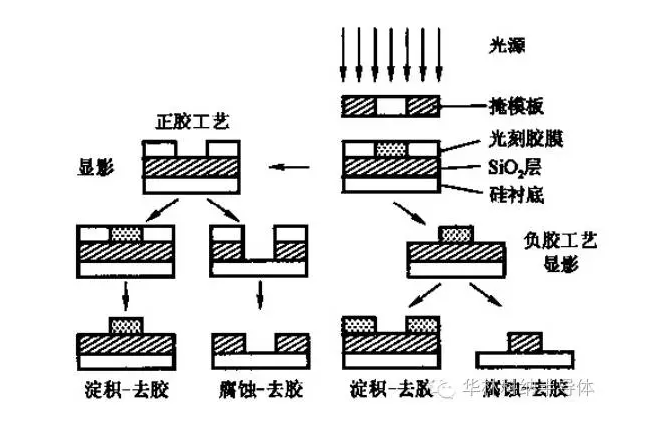
光刻的作用是把掩模版上的图形转换成晶圆上的器件结构,它对集成电路图形结构的形成,如各层薄膜的图形及掺杂区域等,均起着决定性的作用。
光刻的基本流程:前处理——涂胶——对版曝光——显影——显影检查——后烘——腐蚀——腐蚀检查——去胶——检验归批。
前处理
硅片容易吸附潮气到它的表面,硅片暴露在潮气中叫做亲水性。对于光刻胶的粘附性,具有干燥成疏水性的硅片表面非常重要,所以在成底膜和光刻胶旋涂前要进行脱水烘焙。典型的烘焙是在传统的充满惰性气体(如氮气)的烘箱或者真空烘箱中完成,实际的烘焙温度是可变的,常用的温度是200—250℃。
脱水后的硅片马上要用OAP (常用HMDS溶液:六甲基二硅胺烷)成底膜进行表面处理,它起到提高粘附力的作用。在硅片成底膜操作后尽快涂胶,使潮气问题达到最小化。成底膜的方法有:
1、滴浸润液和旋涂:温度和用量容易控制,但系统需要排液和排气装置,HMDS溶液消耗量大。
2、喷雾分滴和旋转:优点是喷雾有助于硅片上颗粒的去除,缺点是处理时间长和HMDS消耗大。
3、气相成底膜和脱水烘焙:最常用,气相成底膜一般200—250℃下约30S完成。优点是由于没有与硅片接触减少了来自液体HMDS颗粒沾污的可能,HMDS的消耗量也小。一种方法是先进行脱水烘焙,再将单个硅片置于热板上通过热传导熏蒸形成底膜,这种方法优点是硅片由里向外烘焙,低缺陷密度,均匀加热和可重复性。另一种方法是以氮气携带HMDS气体进入真空腔。
OAP处理主要是为了改善亲水性表面如二氧化硅表面等,Al淀积后的表面是疏水性,不需进行OAP处理。所以,对于未淀积金属的硅片表面光刻前需要通入HMDS气体,而淀积金属后只进行烘焙,工艺温度一般为(145±10)℃,10min左右,具体时间视产品而定。
涂胶
光刻胶一般有两种:正性光刻胶和负性光刻胶。正胶受光或紫外线照射后感光的部分发生光分解反应,可溶于显影液,未感光的部分显影后仍然留在晶圆的表面,它一般适合做长条形状;负胶的未感光部分溶于显影液中,而感光部分显影后仍然留在基片表面,它一般适合做窗口结构,如接触孔、焊盘等。
光刻胶对大部分可见光敏感,对黄光不敏感。因此光刻通常在黄光室内进行。
涂胶是在涂胶机上进行(非真空),我们华林科纳有生产涂胶机,目前采用的光刻胶的粘度主要有有30、60、100mPas以及PW-1500等,一到四次光刻光刻胶一般采用负胶,类型有OMR 83环化光刻胶、HTR-80环化光刻胶、HTR 3-50、HTR 3-100光刻胶等,而钝化层光刻采用聚酰亚胺光刻胶,它是正胶(也有部分聚酰亚胺负胶,但是很少用),涂胶的具体步骤为:
1、上料;
2、传送;
3、预旋转:硅片旋转甩掉表面的脏物;
4、停止旋转,滴胶;
5、推胶:硅片旋转将胶慢慢涂布满整个硅片的表面;
6、匀胶:将将胶涂匀在表面,光刻胶粘度越大,转速越高,这样得到的膜更均匀;
7、甩胶:硅片旋转将多余的胶甩在残胶回收器中;
8、背喷:在甩胶过程中,光刻胶可能会溅射到回收器壁上后回弹至硅片背面,从而使得背面沾上光刻胶,而使得沾胶处的二氧化硅在后续喷砂减薄工序中不能去除(但是磨片减薄可以去除),从而使得硅片背面不平整(有黑点),为此在甩胶后从硅片背面喷出显影液将胶去除;
9、前烘(软烘):
目的是将光刻胶的溶剂去除,增强光刻胶的粘附性以便显影时光刻胶能很好粘附,防止光刻胶沾到设备上,缓和在旋转过程中光刻胶薄膜内产生的应力,改善光刻胶的均匀性、抗蚀性,优化光刻胶的光吸收特性等。
前烘温度和时间视光刻胶和工艺条件而定。温度一般控制在120℃左右,时间根据光刻胶种类和厚度不同而变化,通常在20-60S。
光刻胶粘度越大,烘烤温度越高;为了提高产能,减少硅片的等待时间,SVG 8000有两个热板,可以同时加热。
前烘时间过长或温度过高,显影后容易产生底膜现象;前烘时间过短或者温度过低,显影后容易产生脱胶现象。
10、下料。
对版曝光
光刻室黄光为安全光,曝光是利用曝光机进行,一般采用接触式曝光,又分为硬接触(真空状态下接触)和软接触(半真空状态下接触),一般采用软接触,掩膜版的铬膜朝下,和硅片接触。对于首次光刻的硅片,只要硅片在掩膜版的图形范围内就可以自动对版光刻,而以后的光刻必须手动对版曝光,曝光时间根据产品和选择的胶来确定,一般在6S左右,曝光光源常用高压汞灯发出的紫外光(紫外曝光),曝光时间根据胶的粘度来确定,粘度越大,曝光时间越长。
显影(去胶机)
在显影机清洗机(去胶机)上进行,显影的具体步骤为:
1、上料旋转;
2、显影:环化光刻胶利用环化胶显影液显影,而聚酰亚胺利用聚酰亚胺显影液显影;
3、漂洗:利用环化胶漂洗液进行漂洗,聚酰亚胺利用异丙醇漂洗;
4、下料。
显影后检查
1、窗口内无残留SiO2残留、无氧化物小岛、无过腐蚀、无染色现象、氧化膜无腐蚀针孔、氧化膜无划伤等;
2、无连铝、铝过腐蚀、铝条间残铝、铝条不过细、铝条氧化、铝条变色(灰、黑、黄)等现象;
3、无残胶、残液、残迹,窗口无二氧化硅或铝残留等;
4、掩膜版对版时位置准确,没有倾斜、错版、错位、反向等,掩膜版要与硅片接触。
后烘坚膜
在通有N2的烘箱中烘烤坚膜,负胶的坚膜温度一般为(140-150)℃左右,负胶的坚膜时间在40min左右。聚酰亚胺胶的固化温度大约为250-300℃,固化5小时左右。
坚膜时间太长,光刻胶会流动,破坏图形;坚膜时间太短,溶剂没有完全蒸发,胶与硅片的粘附性差,腐蚀时会出现脱胶,导致圆片报废。
聚酰亚胺(PIQ)是一种高温环链高分子聚合物,它热稳定性好,热膨胀系数小,台阶覆盖性、抗辐射性好,并且具有耐各种有机溶剂的优良化学特性,绝缘性好,有负电效应,电学、微电子学性能优良,因此常用作表面钝化。
PIQ具有感光性,使用方法就像光刻涂胶一样,用涂胶机均匀地将聚酰亚胺液涂敷于待钝化的硅片上,再在高温下使之转变为聚酰亚胺,这一加温处理过程称为亚胺化。亚胺化过程很有讲究,如果亚胺化温度低,则会有较多的聚酰胺酸未转变为亚胺结构,降低了绝缘性能;如果温度升的太快,溶剂挥发过急,就容易产生气泡,使薄膜粘附不牢。
正性聚酰亚胺胶(PW-1500)是红色粘稠液态物质,经过曝光显影后变成金黄色或黄色。它一般采用手动显影,在常温下的正胶显影液浸泡50-60S,并且用N2鼓泡,然后用纯水冲洗干净甩干。
聚酰亚胺光刻胶用HDK-2型等离子刻蚀去胶机去胶,在去胶机内通入O2,刻蚀气体是CF4。
聚酰亚胺光刻返工:如果聚酰亚胺曝光显影后未坚膜,发现异常需要返工的话可以将圆片钝化层全部曝光后再显影去除聚酰亚胺;如果聚酰亚胺坚膜固化后,显影不能除去,需要放入HDK-2型等离子刻蚀去胶机中用O2和CF4将固化的聚酰亚胺干法刻蚀去除。
更多的半导体清洗设备相关资讯可以关注华林科纳CSE官网(www.hlkncas.com),现在热线咨询400-8768-096可立即获取免费的半导体清洗解决方案。