RENA前后清洗工艺
什么是太阳能电池?
1. 太阳能电池的原理
太阳电池是利用光生伏特效应,把光能直接转换成电能的一种器件。
它的工作原理可以概括成下面几个主要过程:第一,必须有光的照射,可以是单色光,太阳光或我们测试用的模拟太阳光源。第二,光子注入到半导体后,激发出电子—空穴对。这些电子空穴对必须有足够的寿命保证不会在分离前被附和。第三,必须有个静电场(PN结),起分离电子空穴的作用。第四,被分离的电子空穴,经电极收集输出到电池体外,形成电流。
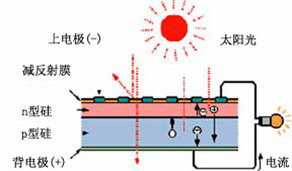
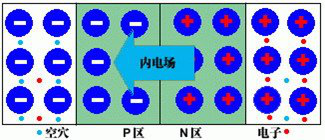
2. 制造太阳能电池的基本工艺流程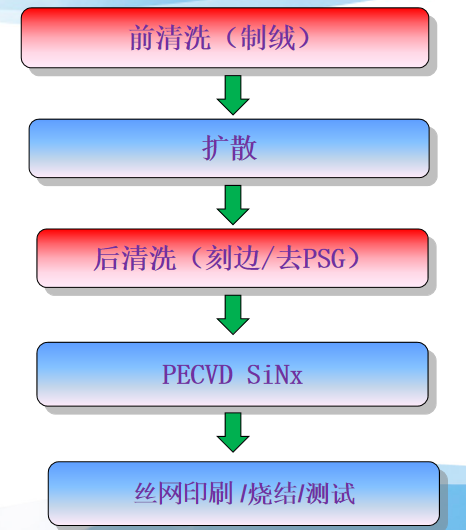
二、前清洗(制绒)
1. 制绒工艺的分类:
制绒按工艺不同可分为碱制绒和酸制绒:
利用碱溶液对单晶硅不同晶面有不同的腐蚀速率(各向异性腐蚀),对(100)面腐蚀快,对(111)面腐蚀慢。如果将(100)作为电池的表面,经过腐蚀、在表面会出现以 (111)面形成的锥体密布表面(金字塔状),称为表面织构化。
但是对于多晶硅,由于晶体排列方式杂乱,如果利用碱液,无法进行腐蚀得到良好的金字塔织构化表面,此时只能用酸溶液进行各向同性腐蚀,获得表面存在许多凹坑的表面结构,也能起到良好的陷光作用。
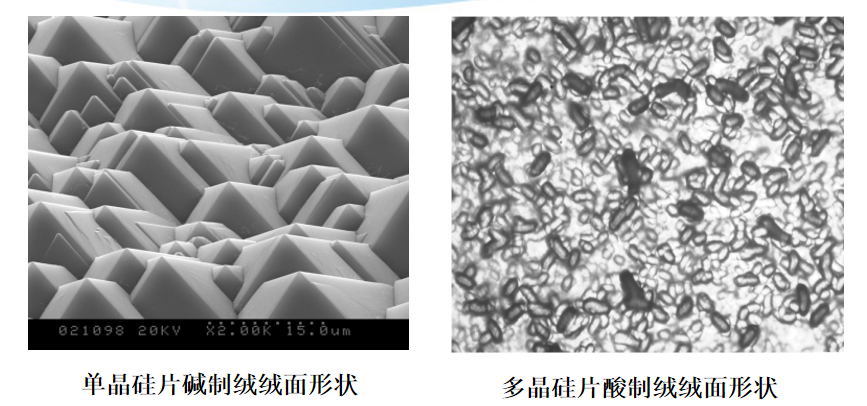
2. 陷光原理:

当入射光入射到一定角度的斜面,光会反射到另一角度的斜面形成二次吸收或者多次吸收,从而增加吸收率。
腐蚀深度在4.4± 0.4µm 时,制绒后的硅片表面反射率要一般在20%~25%之间,此时得到的电性能较好。
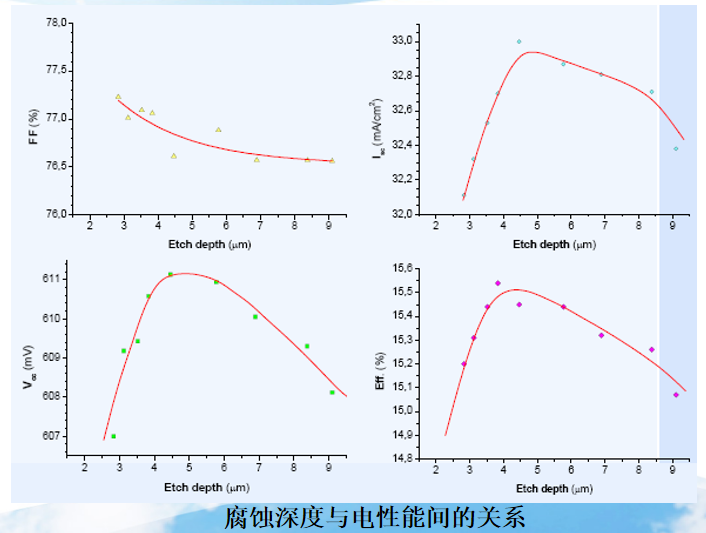
在绒面硅片上制成PN结太阳电池,它有以下特点:
(l)绒面电池比光面电池的反射损失小,如果再加减反射膜,其反射率可进一步降低。
(2)入射光在光锥表面多次折射,改变了入射光在硅中的前进方向,不仅延长了光程,增加了对红外光子的吸收,而且有较多的光子在靠近PN结附近产生光生载流子,从而增加了光生载流子的收集几率。
(3)在同样尺寸的基片上,绒面电池的PN结面积比光面大得多,因而可以提高短路电流,转换效率也有相应提高。
(4)绒面也带来了一些缺点:一是工艺要求提高了;二是由于它减反射的无选择性,不能产生电子空穴对的有害红外辐射也被有效地耦合入电池,使电池发热;三是易造成金属接触电极与硅片表面的点接触,使接触电阻损耗增加。
三、RENA Intex前清洗(酸制绒)工艺
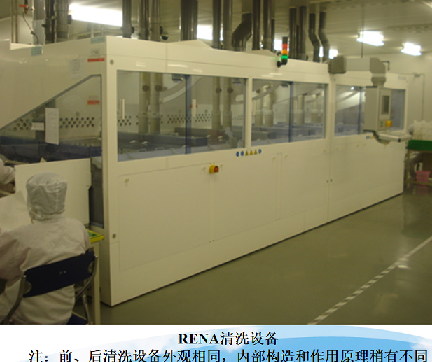
1. RENA前清洗工序的目的:
①去除硅片表面的机械损伤层(来自硅棒切割的物理损伤)
②清除表面油污(利用HF)和金属杂质(利用HCl)
③形成起伏不平的绒面,增加对太阳光的吸收,增加PN结面积,提高短路电流(Isc),最终提高电池光电转换效率。
2. 设备构造
前清洗工艺步骤: 制绒→碱洗 →酸洗→吹干
RENA Intex前清洗设备的主体分为以下八个槽,此外还有滚轮、排风系统、自动及手动补液系统、循环系统和温度控制系统等。
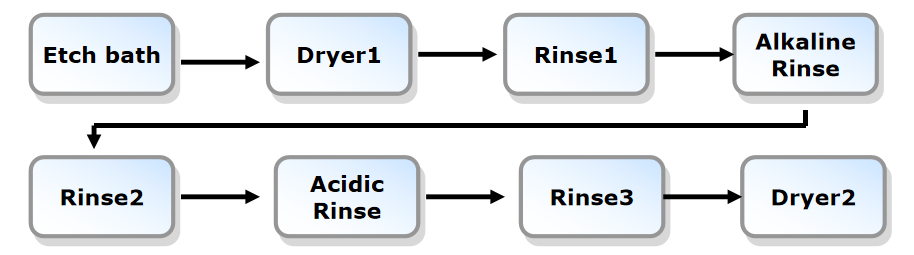
Etch bath:刻蚀槽,用于制绒。 所用溶液为HF+HNO3 ,作用:
1.去除硅片表面的机械损伤层;
2.形成无规则绒面。
Alkaline Rinse:碱洗槽 。 所用溶液为KOH,作用:
1. 对形成的多孔硅表面进行清洗;
2.中和前道刻蚀后残留在硅片表面的酸液。
Acidic Rinse:酸洗槽 。 所用溶液为HCl+HF,作用:
1.中和前道碱洗后残留在硅片表面的碱液;
2.HF可去除硅片表面氧化层(SiO2),形成疏水表面,便于吹干;
3.HCl中的Cl-有携带金属离子的能力,可以用于去除硅片表面金属离子。
3. 酸制绒工艺涉及的反应方程式:
HNO3+Si=SiO2+NOx↑+H2O
SiO2+ 4HF=SiF4+2H2O
SiF4+2HF=H2[SiF6]
Si+2KOH+H2O →K2SiO3 +2H2
NO2 + H2O = HNO3 + HNO2
Si + HNO2 = SiO2 + NO +H2O
HNO3 + NO + H2O = HNO2
四、前清洗工序工艺要求
①片子表面5S控制
不容许用手摸片子的表片,要勤换手套,避免扩散后出现脏片。
②称重
1.每批片子的腐蚀深度都要检测,不允许编造数据,搞混批次等。
2.要求每批测量4片。
3.放测量片时,把握均衡原则。如第一批放在1.3.5.7道,下一批则放在2.4.6.8道,便于检测设备稳定性以及溶液的均匀性。
刻蚀槽液面的注意事项:
正常情况下液面均处于绿色,如果一旦在流片过程中颜色改变,立即通知工艺人员。
产线上没有充足的片源时,工艺要求:
1.停机1小时以上,要将刻蚀槽的药液排到tank,减少药液的挥发。
2.停机15分钟以上要用水枪冲洗碱槽喷淋及风刀,以防酸碱形成的结晶盐堵塞喷淋口及风刀。
3.停机1h以上,要跑假片,至少一批(400片)且要在生产前半小时用水枪冲洗风刀处的滚轮,杜绝制绒后的片子有滚轮印。
前清洗到扩散的产品时间:
最长不能超过4小时,时间过长硅片会污染氧化,到扩散污染炉管,从 而影响后面的电性能及效率
五、RENA InOxSide后清洗工艺
1. 后清洗的目与原理
扩散过程中,虽然采用背靠背扩散,硅片的边缘将不可避免地扩散上磷。PN结的正面所收集到的光生电子会沿着边缘扩散有磷的区域流到PN结的背面,而造成短路。此短路通道等效于降低并联电阻。
同时,由于在扩散过程中氧的通入,在硅片表面形成一层二氧化硅,在高温下POCl3与O2形成的P2O5,部分P原子进入Si取代部分晶格上的Si原子形成n型半导体,部分则留在了SiO2中形成PSG。
后清洗的目的就是进行湿法刻蚀和去除PSG。
2.湿法刻蚀原理:
利用HNO3和HF的混合液体对扩散后硅片下表面和边缘进行腐蚀,去除边缘的N型硅,使得硅片的上下表面相互绝缘。

边缘刻蚀原理反应方程式:
3Si + 4HNO3+18HF =3H2 [SiF6] + 4NO2 + 8H2O
3.刻蚀中容易产生的问题及检测方法:
1.刻蚀不足:边缘漏电,Rsh下降,严重可导致失效
检测方法:测绝缘电阻
2.过刻:正面金属栅线与P型硅接触,造成短路
检测方法:称重及目测
SPC控制:当硅片从设备中流转出来时,工艺需检查硅片表面状态,绒面无明显斑迹,无药液残留。125单晶该工序产品单要求面腐蚀深度控制在0.8~1.6μm范围之内,且硅片表面刻蚀宽度不超过2mm, 同时需要保证刻蚀边缘绝缘电阻大于1K欧姆。
4.去除磷硅玻璃的目的:
1) 磷硅玻璃的存在使得硅片在空气中表面容易受潮,导致电流的降低和功率的衰减。
2) 死层的存在大大增加了发射区电子的复合,会导致少子寿命的降低,进而降低了Voc和Isc。
3) 磷硅玻璃的存在使得PECVD后产生色差。
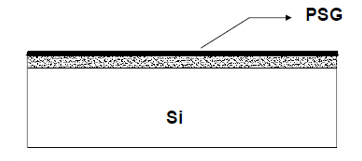
去PSG原理方程式:
SiO2+4HF=SiF4+2H2O
SiF4+2HF=H2[SiF6]
SiO2+ 6HF=H2[SiF6]+2H2O
去PSG工序检验方法:
当硅片从HF槽出来时,观察其表面是否脱水,如果脱水,则表明磷硅玻璃已去除干净;如果表面还沾有水珠,则表明磷硅玻璃未被去除干净,可在HF槽中适当补些HF。
5.后清洗设备构造
后清洗工艺步骤: 边缘刻蚀→碱洗 →酸洗→吹干
RENA InOxSide后清洗设备的主体分为以下七个槽,此外还有滚轮、排风系统、自动及手动补液系统、循环系统和温度控制系统等。
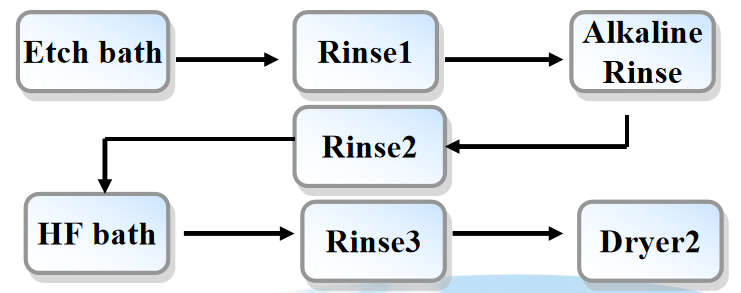
Etch bath:刻蚀槽,用于边缘刻蚀。 所用溶液为HF+HNO3+H2SO4,
作用:边缘刻蚀,除去边缘PN结,使电流朝同一方向流动。
注意扩散面须向上放置, H2SO4的作用主要是增大液体浮力,使硅片很好的浮于反应液上(仅上边缘2mm左右和下表面与液体接触)。
Alkaline Rinse:碱洗槽 。 所用溶液为KOH,
作用:中和前道刻蚀后残留在硅片表面的酸液。
HF Bath:HF酸槽 。 所用溶液为HF,
作用:中和前道碱洗后残留在硅片表面的碱液;去PSG
(免责声明:文章来源于网络,如有侵权请联系作者删除。)