用于制造微电子器件的薄膜都是使用某种沉积技术形成的,该术语是指在基板上形成沉积物。在半导体器件制造中,以下沉积技术(及其常用的缩写)为:
低压化学气相沉积-LPCVD
等离子体增强化学气相沉积-PECVD
低于大气压的化学气相沉积-SACVD
大气压化学气相沉积-APCVD
原子层沉积-ALD
物理气相沉积-PVD
超高真空化学气相沉积-UHV-CVD
类金刚石碳-DLC
商业电影-CF
外延沉积-Epi
化学气相沉积和薄膜形成
化学气相沉积法可以定义为其中通过气相吸附的前体的表面介导反应在基材上形成固体薄膜的任何方法。CVD工艺的反应性使其与物理工艺(如PVD中采用的蒸发和溅射)区别开来。术语“表面介导的”是指固体膜是由在基材表面发生的异质反应形成的。有关其他信息,请参见 化学气相沉积物理。
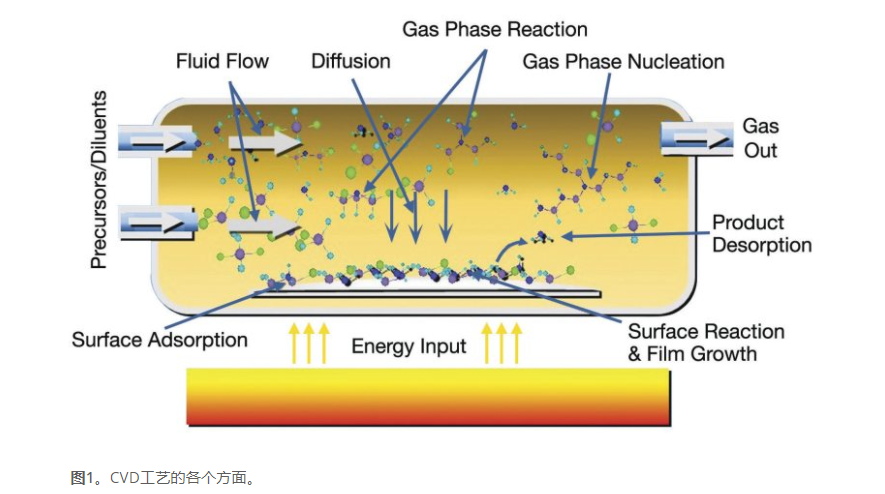
图1显示了有助于理解CVD反应器中不同过程的示意图。化学气相沉积过程可分为多个离散步骤:首先,必须将前体化学物质送入CVD反应器。一旦进入反应器,通常必须通过流体传输和扩散的组合将前体分子传输到基底表面。一旦在表面上,前体分子必须保持足够长的时间才能反应。反应发生后,产物薄膜原子必须保留在表面上,而副产物分子必须从基材表面解吸,从而为更多的传入前体分子腾出空间。
典型的CVD工艺薄膜
CVD工艺生产的典型薄膜包括:
外延硅
外延化合物半导体
多晶硅
介电薄膜
二氧化硅(包括P和B掺杂的氧化物)
氧化铝
低介电常数(SiO-F,DLC,非晶CF)
氮化硅
氮化钛
氮化钽
过渡金属氧化物(即TiO 2,ZrO 2,Hf 2 O 5,Ta 2 O 5)
金属(Al,W,Cu)
硅化物(WSix,CoSix)
低压化学气相沉积(LPCVD)
LPCVD沉积系统通常在0.1到10托的压力下运行。已用于LPCVD薄膜工艺的反应器配置包括电阻加热管式热壁反应器,垂直流间歇反应器和单晶片反应器。由于晶圆处理,有效的颗粒和工艺控制以及工艺集成方面的优势,现代晶圆厂已大量迁移到将单个晶圆簇工具用于CVD和其他处理需求。有关其他信息,请参见低压化学气相沉积系统。
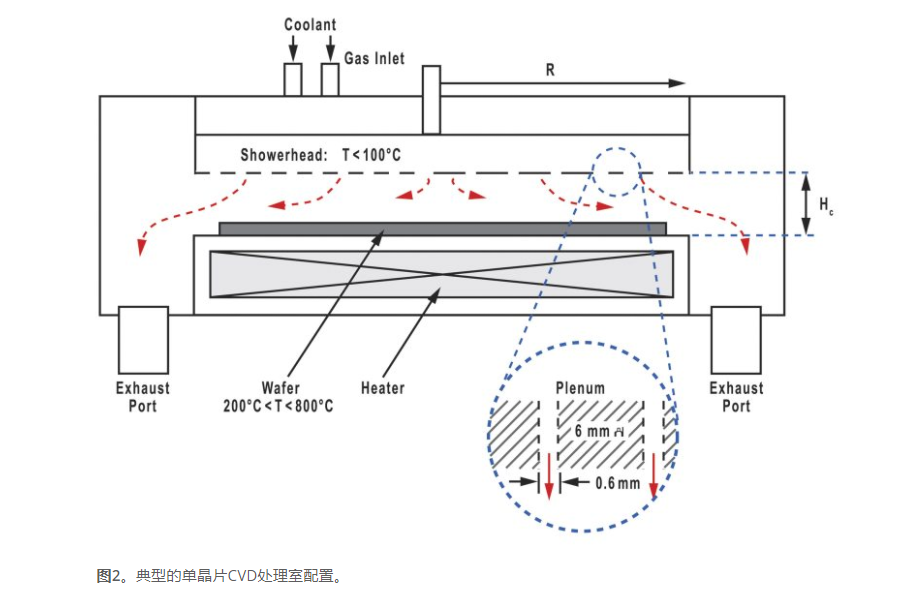
等离子体增强化学气相沉积(PECVD)
等离子增强型CVD系统与LPCVD系统一样,最初是批处理机,一次最多可装载100个晶片。使用PECVD与LPCVD相比,所寻求的关键优势在于能够在保持或提高沉积速率的同时降低工艺温度。随着器件的几何尺寸越来越小,限制温度持续时间对于保持已部分制造的器件上已经存在的组件的材料特性和电气特性变得更加重要。随着PECVD工艺的成熟,其他优势,例如操纵薄膜材料的能力和构象特性也变得显而易见。PECVD处理的早期商业配置是从当时的LPCVD技术衍生而来的,PECVD处理是在真空(2-10托)的热壁管反应器环境中进行的(图3)。等离子增强化学气相沉积系统,了解更多信息。
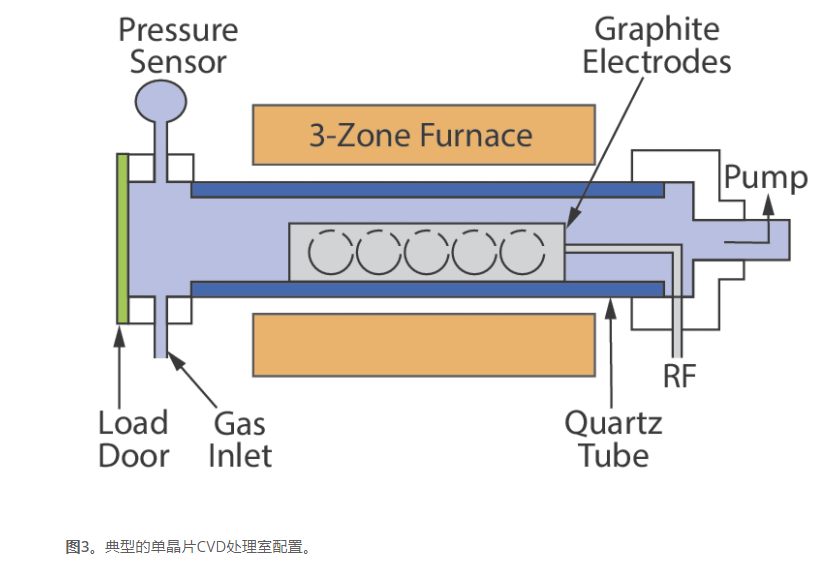
低于大气压的化学气相沉积(SACVD)
SACVD设备的主要应用是在TEOS /臭氧二氧化硅CVD工艺中。TEOS / O 3工艺满足了用于ULSI的层间介电工艺中缩短温度时间的需求。另外,TEOS / O3具有优于其他二氧化硅薄膜沉积工艺的自平坦特性。
原子层沉积(ALD)
原子层沉积与LPCVD相似,不同之处在于化学过程分为可分离不同吸附步骤和反应步骤以进行自限反应的步骤。该方法采用依次通过处理室的前驱物和反应物的独立脉冲。图4说明了ALD过程。在将衬底置于处理室中并在高真空下的情况下,将初始前体引入到处理室中。前体的分子特征是,它将在基材表面上形成化学键合的单分子层(步骤1)。单层以外的任何层都仅受足够弱的物理吸附力约束,以至于在高真空下可以将除单层中的前驱物以外的任何前驱物抽走。一旦单分子层存在于基材上,将腔室重新排空并吹扫以去除任何多余的前体(步骤2)。接下来,将反应物引入处理室(步骤3)。它与单层材料反应,在基材表面上形成所需化合物(步骤4)。该反应的副产物被抽走。看到原子层沉积以获取更多信息。
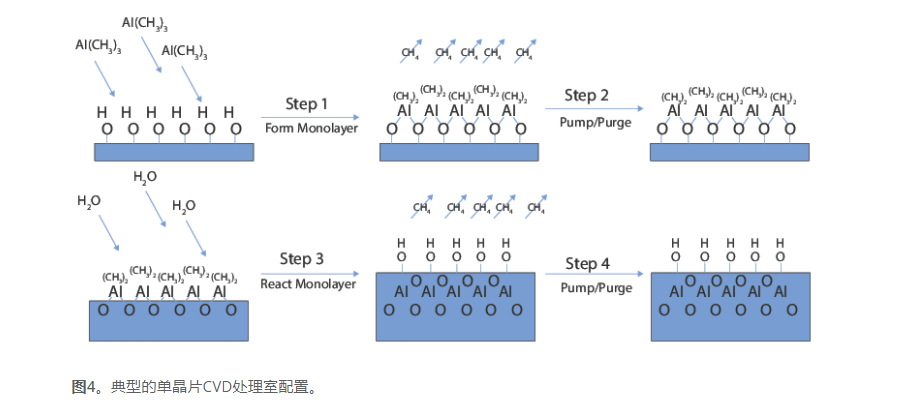
物理气相沉积(PVD)
物理气相沉积(PVD)工艺通过使用物理工艺(例如蒸发或溅射)来沉积薄膜。这些工艺在高温/高真空或等离子体下从固体源蒸发材料,并将材料重新沉积在基板表面上。热蒸发和溅射是PVD的主要方法。热蒸发通过在真空中加热来蒸发源材料,而溅射使用等离子体产生离子轰击(通常是氩离子),从而从源材料中产生蒸汽。可以通过PVD沉积的膜包括大多数金属和介电材料。
薄膜沉积产品
前体交付产品(ALD除外)
基于热和压力的质量流量控制器(MFC)和仪表(MFM)旨在满足各种加工应用。大多数MKS质量流量控制和计量产品都提供带有嵌入式Modbus和以太网用户界面的模拟(0-5 VDC; 4-20 mA)和数字(Devicenet,Profibus,EtherCAT,RS485)I / O。
臭氧气体输送产品适用于多种目的,包括TEOS / O 3 SACVD。它们结合了经过现场验证的高浓度超净臭氧发生技术,以及集成的臭氧浓度监测器,流量控制和功率分配。在某些型号上提供安全监视器,状态指示器和臭氧破坏功能。