化学机械抛光设备及其操作方法

图1
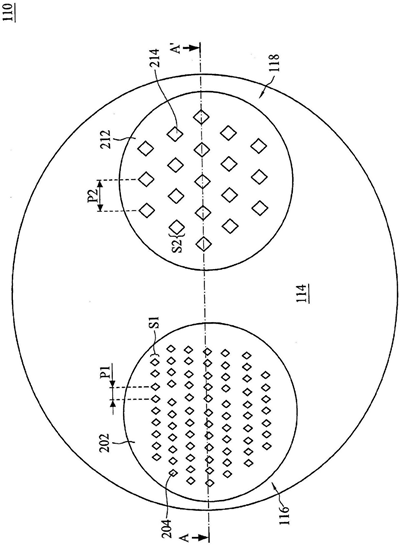
图2A
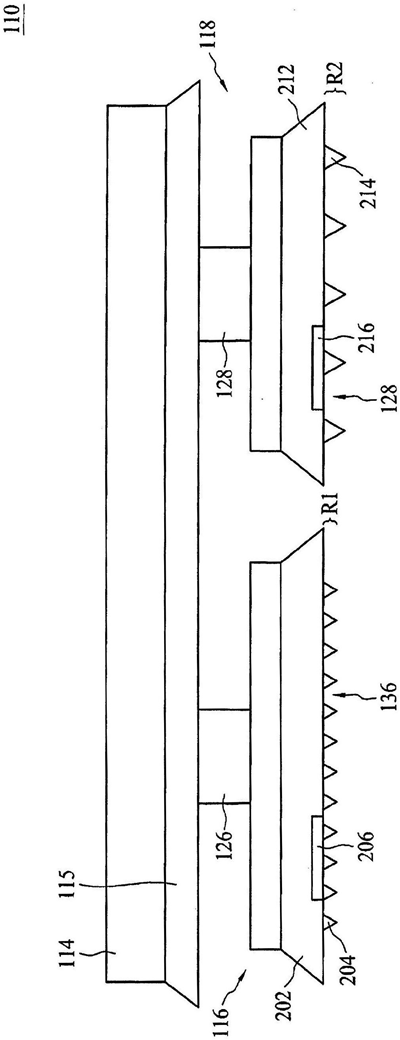
图2B
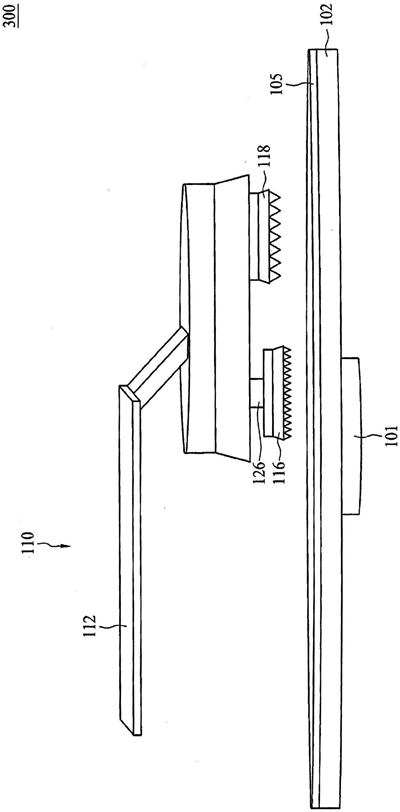
图3
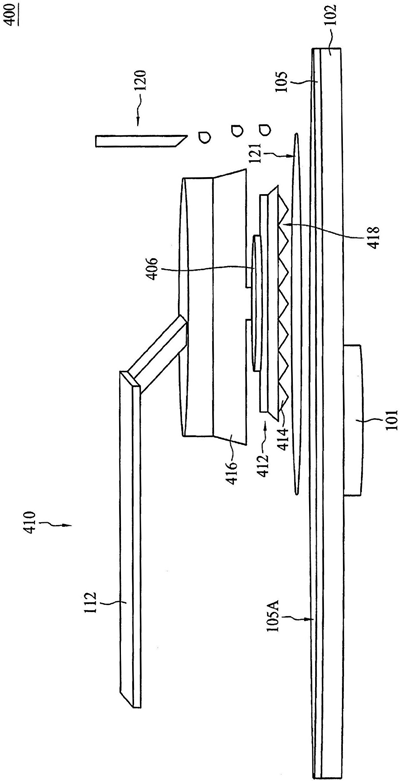
图4
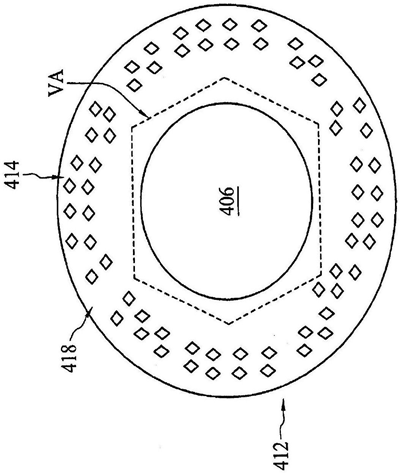
图5A

图5B
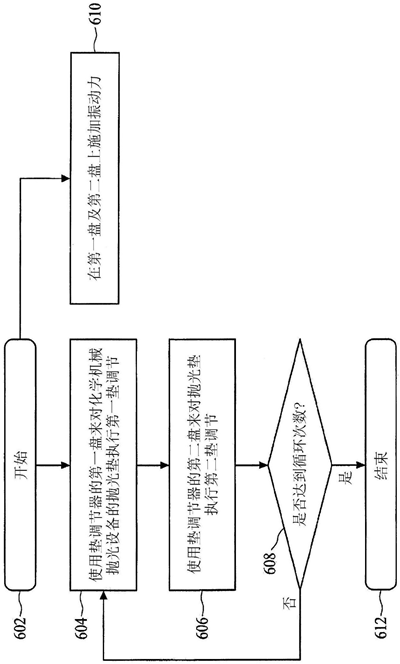
图6
图1是绘示根据一些实施例的CMP设备的示意图。
图2A是根据一些实施例的图1中的CMP设备的垫调节器的示意仰视图。
图2B是根据一些实施例的图1中的CMP设备的垫调节器的示意横截面图。
图3是绘示根据一些实施例的CMP设备的示意图。
图4是绘示根据一些实施例的CMP设备的示意图。
图5A及5B是根据一些实施例的图4中的CMP设备的垫调节器的示意仰视图。
图6是绘示根据一些实施例的操作CMP设备的方法的示意流程图。
图1是绘示根据一些实施例的CMP设备100的示意图。如图1中所展示,CMP设备100
包含压板102、晶片载体104及垫调节器110。抛光垫105安置于压板102上且包含面向晶片载体104及垫调节器110的抛光表面105A。在一些实施例中,压板102可由基座101支撑且可使抛光垫105围绕第一轴线103旋转。
晶片载体104包含轴件106及耦合到轴件106的平板107。轴件106经配置以围绕第
二轴线113旋转。平板107经配置以固持工件108,例如半导体晶片。在一些实施例中,晶片载体104经配置以向上或向下移动晶片108,使得晶片108可与抛光表面105A接合。在一些实施例中,平板107可通过真空、静电电荷(ESC)等来固持晶片108。在操作期间,抛光垫105围绕第一轴线103旋转且晶片载体104围绕第二轴线113旋转。晶片108接触抛光垫105以借此引起晶片108上的一层或材料的一定量被抛光。压板102及晶片载体104可沿相同方向旋转或可沿不同方向旋转。在一些实施例中,晶片载体104还可围绕第一轴线103旋转,但不限于此。在一些实施例中,压板102可相对于晶片载体104垂直移动,使得晶片载体104可与晶片108接触以抛光晶片108。
在一些实施例中,晶片108包含半导体衬底(图中未单独展示),例如块状半导体衬底。块状半导体衬底可包含:元素半导体,例如硅;化合物半导体,例如硅锗或碳化硅;或其组合。在一些实施例中,晶片108包含各具有形成于晶片108上或晶片108中的若干装置(例
如电路、晶体管等等)的裸片阵列。在一些实施例中,形成于晶片108上或晶片108中的电路可为适用于一特定应用的任何类型的电路。在一些实施例中,晶片108可包含CMOS衬底。在一些实施例中,晶片108可包含堆叠晶片。在一些实施例中,晶片108中的衬底的背面(其上未形成电路)面向抛光垫105且透过CMP操作变薄或抛光。在一些实施例中,面向抛光垫105的晶片108的层是待薄化的电路的介电或导电层。
垫调节器110包含臂112、主体114、母盘115、第一盘116及第二盘118。第一盘116及
第二盘118是用于执行垫修整或垫调节的抛光盘。在一些实施例中,第一盘116及第二盘118安置于母盘115的相同侧上方。主体114耦合到第一盘116及第二盘118。臂112固持主体114且经配置以在抛光表面105A上方且横跨抛光表面105A移动垫调节器110。主体114将臂112与母盘115耦合。在一些实施例中,臂112经配置以透过主体114及母盘115对第一盘116及第二盘118施加向下力。
在操作期间,抛光垫105围绕第一轴线103旋转且母盘115围绕第三轴线123旋转。
压板102及母盘115可沿相同方向或不同方向旋转。在一些实施例中,垫调节器110的母盘115也可围绕第一轴线103旋转,但本揭露不限于此。在一些实施例中,压板102可相对于垫调节器110垂直移动,使得抛光垫105可接触第一盘116或第二盘118以执行垫调节。
在一些实施例中,母盘115、第一盘116及第二盘118具有小于约500rpm的旋转速
度。垫调节器110的两个盘的描绘配置仅供绘示。垫调节器110的盘数目可为2个以上。在多盘配置中,各种盘可安置于母盘115下方且依一行星运动由母盘115旋转。在一些实施例中,各种盘可具有其自身旋转方向及旋转速度。
第一盘116透过第一轴件126耦合到母盘115。在操作期间,垫调节器110的母盘115围绕第三轴线123旋转,且第一盘116围绕第一轴件126的第四轴线133旋转。母盘115及第一盘116可沿相同方向或不同方向旋转。在一些实施例中,第一盘116还可围绕第三轴线123旋转,但本揭露不限于此。
第二盘118透过第二轴件128耦合到母盘115。在操作期间,母盘115围绕第三轴线
123旋转,且第二盘118围绕第五轴线143旋转。母盘115及第二盘118可沿相同方向或不同方向旋转。在一些实施例中,第一盘116及第二盘118可沿相同方向或不同方向旋转。在一些实施例中,第二盘118还可围绕第三轴线123旋转,但本揭露不限于此。第一轴件126及第二轴件128经配置以分别固持第一盘116及第二盘118。此外,第一盘116具有第一表面136,其具有面向抛光垫105的抛光表面105A的粗糙结构。在一些实施例中,第一表面136包含一些抛光齿或磨粒。在一些实施例中,第一轴件126可移动或可伸缩以移动第一盘116来使第一表面136与抛光表面105A接合。在一些实施例中,第一轴件126包含用于实现第一轴件126的移动的泵。在一些实施例中,第一轴件126由可类似于臂112的臂结构替换且可经折叠以向上及向下移动第一盘116。
类似地,第二盘118具有第二表面138,其具有面向抛光表面105A的粗糙结构。第二
轴件128可移动或可伸缩以移动第二盘118来使第二表面138与抛光表面105A接合。在一些实施例中,第二轴件128包含用于实现第二轴件128的移动的泵。在一些实施例中,第二轴件128由可类似于臂112的臂结构替换且可经折叠以向上及向下移动第二盘118。在一些实施例中,第二表面138包含若干抛光齿或磨粒。
在一些实施例中,CMP设备100进一步包含耦合到垫调节器110的控制模块130。控制模块130可经配置以将控制信号传输到垫调节器110以传送母盘115、第一盘116及第二盘
118的抛光参数,例如工作盘、旋转速度、旋转方向等的选择。在一些实施例中,控制模块130经配置以传送第一轴件126及第二轴件128的配置参数(例如延伸及缩回)。在一些实施例中,控制模块130可使用电子电路来实施且可包含(例如)微控制器、存储器、FPGA等。
在一些实施例中,第一盘116及第二盘118分别包含第一传感器206及第二传感器216。在一些实施例中,第一传感器206及第二传感器216面向垫表面105A。在一些实施例中,
第一传感器206或第二传感器216分别透过第一表面136或第二表面138暴露。在一些实施例中,第一传感器206或第二传感器216可有助于在抛光操作期间检测压力值的压力传感器。将所检测的压力值的测量传输到控制模块130以确定适当压合压力。在一些实施例中,第一传感器206或第二传感器216是经配置以检测垫表面105A与第一盘116或第二盘118之间的间隙的近接传感器或测距传感器。相应地,可使第一表面136及第二表面138维持相等高度或不同高度。可优选管理第一盘116及第二盘118的操作因数。
在一些实施例中,CMP设备100进一步包含用于将研浆121施配到抛光垫105的抛光
表面105A的研浆供给器120。研浆121可依液体或水溶液形式经由研浆供给器120的喷嘴提供。典型研浆121是水基溶液且含有用于与抛光垫105一起抛光晶片108的化学物及物理磨粒。在一些实施例中,研浆121中的磨粒可具有不同形状,例如球体形状、似球体形状、椭球体形状等。在一些实施例中,研浆121中的磨粒由金属陶瓷复合物制成。在一些实施例中,研浆121中的磨粒由刚玉、碳化钨、碳化硅(金刚砂)、碳化钛、硼、氮化硼、二硼化铼、超石英、二硼化钛、金刚石、黑金刚石等制成。
图2A是根据一些实施例的图1中的CMP设备100的垫调节器110的示意仰视图。图2B是沿截面线AA'取得的垫调节器110的示意横截面图。为了清楚及简化,从图2A省略垫调节器110的一些装置,例如第一轴件126及第二轴件128。第一盘116包含第一基底材料202及固定于第一基底材料202中的多个第一磨粒204。在一些实施例中,第一基底材料202可包含聚合材料、复合材料等。第一基底材料202可经配置为用于固定多个第一磨粒204的模塑层。在一些实施例中,第一磨粒204可由刚玉、碳化钨、碳化硅(金刚砂)、碳化钛、硼、氮化硼、二硼化铼、超石英、二硼化钛、金刚石、黑金刚石等形成。在一些实施例中,第一磨粒204可具有球体形状、似球体形状、椭球体形状等。在一些实施例中,第一磨粒204可具有多面形状且可包含多刻面锥形形状、多刻面圆柱形形状、多刻面球体形状等。第一磨粒204中的若干个从第一基底材料202的相对光滑表面突出以导致第一表面136的粗糙结构(参阅图2B)。在一些实施例中,第一磨粒204具有从第一表面136突出的尖端。作为形成第一表面136的示范性方法,可使第一磨粒204依流体形式混合于第一基底材料202中。在固化之后,多个第一磨粒204可含于第一基底材料202内,且第一磨粒204中的若干个从第一基底材料202突出。在一些实施例中,第一基底材料202由金属形成且多个第一磨粒204安装于此金属的表面上。抛光垫表面105A的粗糙度可取决于磨粒204或214的因数,其包含磨粒粒径、磨粒表面密度及磨粒节距中的至少一个。在一实施例中,将垫表面105A的粗糙度值Ra计算为从平均线(图中未单独展示)的表面轮廓高度偏差的绝对值的算术平均值。简单来说,粗糙度值Ra是垫表面105A的尖峰及凹谷的一组个别测量的平均值。
在一些实施例,第一磨粒204具有第一配置。例如,第一磨粒204可随机或均匀分布于第一基底材料202中。在所描绘的实例中,第一磨粒204大体上均匀地分布布置。第一配置
可经确定以将相对较低修整压力或力施加于垫表面105A上。参考图2B,在一些实施例中,第一表面136上的第一磨粒204的第一配置具有第一节距P1。在一些实施例中,第一节距P1在约100μm到约250μm之间,例如150μm。在一些实施例中,第一配置具有第一磨粒204的第一表面密度D1。在一些实施例中,第一表面密度D1大于约2000格令/cm2。在一些实施例中,第一表面密度D1在约2000格令/cm2到约5000格令/cm2之间,例如4500格令/cm2。返回参考图2A,在一些实施例中,第一配置具有第一磨粒204的平均粒径S1。磨粒粒径可由其几何形状(例如其宽度、长度、直径等)界定。在一些实施例中,第一磨粒204的平均粒径是指第一磨粒204的算术或几何平均值。在一些实施例中,第一平均粒径S1小于约100μm。在一些实施例中,第一平均粒径S1在约20μm到约100μm之间,例如50μm。
第二盘118包含第二基底材料212及固定于第二基底材料212中的多个第二磨粒214。在一些实施例中,第二基底材料212可包含聚合材料、复合材料等。第二基底材料212可经配置为用于固定多个第二磨粒214的模塑层。在一些实施例中,第二磨粒214可由刚玉、碳
化钨、碳化硅(金刚砂)、碳化钛、硼、氮化硼、二硼化铼、超石英、二硼化钛、金刚石、黑金刚石等形成。在一些实施例中,第二基底材料212及第二磨粒214可拥有分别类似于第一基底材料202及第一磨粒204的材料的材料。第二磨粒214从第二基底材料212的相对光滑表面突出以导致第二表面138的粗糙结构(参阅图2B)。在一些实施例中,第二磨粒214具有从第二表面138突出的尖端。
在一些实施例中,第二磨粒214可具有第二磨粒配置。例如,第二磨粒214可随机或均匀分布于第二基底材料212中。在所描绘的实例中,第二磨粒214大体上均匀地分布布置。
第二配置可经确定以将相对较高修整压力或力施加于垫表面105A上。参考图2B,在一些实
施例中,第二磨粒214的第二配置具有第二表面138上的第二节距P2。在一些实施例中,第二节距P2大于约250μm。在一些实施例中,第二节距P2在约250μm到约600μm之间,例如500μm。在一些实施例中,第二磨粒214的第二配置具有第二表面密度D2。在一些实施例中,第二表面密度D2小于约1000格令/cm2。在一些实施例中,第二表面密度D2在约100格令/cm2到约1000格令/cm2之间,例如400格令/cm2。返回参考图2A,在一些实施例中,第二配置具有第二磨粒214的平均粒径S2。在一些实施例中,第二平均粒径S2大于约150μm。在一些实施例中,第二平均粒径S2在约150μm到约400μm之间,例如200μm。
在本实施例中,第一节距P1小于第二节距P2。在一些实施例中,第一平均粒径S1小
于第二平均粒径S2。在一些实施例中,第一表面密度D1大于第二表面密度D2。在上述一些实施例中,施加到第一磨粒204的向下力或压力小于施加到第二磨粒214的向下力或压力。第一磨粒204及第二磨粒214的不同配置可有助于提高垫调节器110的垫调节性能。垫调节性能的因数至少包含切割速率、抛光垫表面均匀性、垫表面缺陷及其它因数。人们已发现,使用抛光盘及较大修整力(例如,使用较大磨粒粒径)的垫调节器提供抛光垫的较高切割速率且从垫表面105A上的沟槽优选去除残屑。然而,此布置会产生更深孔且降低层级均匀性及留下更多表面缺陷,例如垫表面105A上的沟槽上的毛边结构。此外,使用抛光盘及较小修整力(例如,使用较小磨粒粒径)的垫调节器提高层级均匀性且在沟槽上留下较少毛边,但切割效率降低。鉴于上述情况,所提出的多盘垫调节器110利用大抛光盘118及小抛光盘116两者的优点来重新粗糙化抛光垫105的垫表面105A。可通过使大抛光盘118及小抛光盘116两者组合使用来显著减少单独采用大抛光盘118或小抛光盘116的缺点。
图3是绘示根据一些实施例的CMP设备300的示意图。CMP设备300及图1中所展示的CMP设备100被视为在不同模式下操作的类似设备。因此,基于图1及3中所展示的至少不同模式来应用操作与CMP设备100相关联的CMP设备的方法。第一轴件126及第二轴件128可经伸缩以在抛光垫105上方分别垂直向下及向上移动第一盘116及第二盘118。在图1中,操作双盘模式,其中第一轴件126及第二轴件128同时朝向抛光垫105延伸。在图3中,使用单盘模式,其中第二轴件128从抛光垫105缩回且第一轴件126保持朝向抛光垫105延伸,使得第一盘116及第二盘118安置于不同位准处。第一轴件126可缩回以在双盘模式期间依类似方式移动第一盘116远离垫表面105A,使得第一盘116及第二盘118与垫表面105交替接合。透过模式切换,第一盘116及第二盘118可同时或交替修整抛光垫105。在单盘模式的实施例中,可多次重复通过第一盘116及第二盘118的交替垫调节,直到获得所要垫表面105A。在一实施例中,确定垫调节序列,其中具有相对较大平均磨粒粒径(替代地,较大磨粒节距或较小磨粒密度)的第二盘118经配置以修整抛光垫105作为垫调节序列的开始阶段。在一实施例中,在垫调节序列中,具有较小平均磨粒粒径(替代地,较小磨粒节距或较高磨粒密度)的第一盘116经配置以修整抛光垫105作为垫调节序列的结束阶段。
图4是绘示根据一些实施例的CMP设备400的示意图。CMP设备400包含压板102及垫
调节器410。抛光垫105安置于压板102上且包含面向垫调节器410的抛光表面105A。CMP设备400可包含晶片载体104,但图4中未绘示。压板102经配置以固定抛光垫105且由基座101支撑。垫调节器410安置于抛光垫105上方。垫调节器410包含臂112、主体416、修整盘412及振动模块406。在一些实施例中,母盘可安置于CMP设备400的主体416与修整盘412之间。修整盘412具有构成粗糙表面418的磨粒414。修整盘412的配置及操作方法类似于图1及3中所绘示的第一盘116或第二盘118的配置及操作方法。
振动模块406经配置以使修整盘412振动。在一实施例中,振动模块406安置于修整
盘412上方。在一实施例中,振动模块406安置于臂112与修整盘412之间。在一实施例中,振动模块406安置于主体416与修整盘412之间。在一实施例中,振动模块406与主体416整合。在一实施例中,振动模块406与修整盘412接触,例如,振动模块406安置于修整盘412的上表面上以使修整盘412更有效振动。
在一实施例中,振动模块406引起修整盘412的磨粒414在垫调节程序期间振动。在一实施例中,振动模块406经配置以产生具有高于音波的超声波频率的声波。在一实施例中,振动模块406可朝向抛光垫105与修整盘412之间的研浆121传输能量。在一实施例中,声波具有高于约20千赫兹的频率,例如在约20千赫兹到约200千赫兹之间。在一实施例中,振动模块406经配置以产生具有约0.8兆赫兹到约2兆赫兹的范围内的超高频音波频率的声波。在一实施例中,振动模块406可引起流体研浆121内的声流效应。另外,振动模块406可产生空穴或气泡效应以促进从垫表面105A清除残屑。由空穴效应导致的内爆现象可有助于使研浆121中的粒子及抛光程序中留下的残屑的聚结物碎成较小块且使破粒或残屑更快从表面105A移走。在一些实施例中,声波引起磨粒414在垫调节期间沿非单调移动轨迹移动且可在抛光垫105上提供垂直切割力及横向切割力。可同时获得用于修整抛光垫105的减小垫粗糙度及增大去除速率。图4中所展示的振动模块406仅供绘示。在一些实施例中,振动模块406可整合到图1中所展示的CMP设备100中以与多个抛光盘(例如第一盘116及第二盘118)合作。
可依许多方式实施振动模块406。在一实施例中,振动模块406包括声音传感器。在
一些实施例中,振动模块406可由夹于前金属与后金属(图中未单独展示)之间的压电材料
组成且产生具有逆压电效应的声波。在一些其它实施例中,振动模块406可由磁体及线圈
(图中未单独展示)形成,其中依电磁原理产生声波。
图5A是根据一些实施例的图4中的CMP设备400的垫调节器410的示意仰视图。为了简化及清楚,从图4省略垫调节器410的一些装置,例如臂112及主体416。在一实施例中,振动模块406经配置以在修整盘412的粗糙表面418周围产生具有建设性干扰的声波以放大施加到修整盘412及研浆121上的声波的振动效应。此建设性或破坏性干扰可确定声波的最终振动效应及由振动模块406产生的波强度。在一些实施例中,表面418上由虚线绘示的净空区域VA界定于修整盘412的中央区域中,其中大体上未安置磨粒以促进声波的建设性干扰。在一些实施例中,磨粒414在区域VA外具有大于区域VA内的第二表面密度的第一表面密度。在一实施例中,第二表面密度大体上为零。声波可促成表面418周围的区域VA内的建设性干扰。在一些实施例中,将净空区域VA设定为多边形形状(例如四边形形状或六边形形状(如图5A中所展示))、圆形形状等。在一些实施例中,振动模块406在区域VA内具有突出区域,使得振动模块406与磨粒414水平间隔开。在一实施例中,修整盘412的磨粒414可不均匀分布于表面418上。在一实施例中,磨粒414分布于修整盘412的外围中。在一些实施例中,磨粒414在表面418上分布成环形形状。在一些实施例中,磨粒414分布于表面418的拐角处。参考图5B,磨粒414分布于区域VA外且在表面418上形成径向线。图5A及5B中所展示的磨粒配置可应用于图1中所展示的垫调节器110中的多个盘中的每一个。
图6是绘示根据一些实施例的操作CMP设备的方法600的示意流程图。方法开始于步骤602。在一些实施例中,垫调节循环可包括使用图1中所绘示的第一盘116的第一垫调节
及接着使用图1中所绘示的第二盘118的第二垫调节。在一些实施例中,垫调节循环可包括
使用第二盘118的第一垫调节及接着使用第一盘116的第二垫调节。第一垫调节及第二垫调
节中的每一个可持续约30秒到约30分钟的周期。当开始方法600时,确定将进行多少次垫调节循环。在步骤604中,使用垫调节器的第一盘来对CMP设备的抛光垫执行第一垫调节。第一垫含有具有第一平均粒径的多个第一磨粒。在步骤606中,使用垫调节器的第二盘来对抛光垫执行第二垫调节。第二盘含有具有不同于(例如,大于或小于)第一平均粒径的第二平均粒径的多个第二磨粒。在一些实施例中,在相同循环期间同时执行第一垫调节及第二垫调节。
在步骤610中,在第一垫调节及第二垫调节期间将振动力施加到第一盘及第二盘。方法600继续步骤608以确定是否达到循环次数。如果为否定的,那么方法600返回到步骤604以重复另一垫调节循环。如果循环次数已达到预定值,那么结束垫调节。根据一实施例,一种用于化学机械抛光的设备包含垫调节器。所述垫调节器包含具有第一表面的第一盘及具有第二表面的第二盘。所述第一表面含有具有第一平均粒径的多个第一磨粒且所述第二表面含有具有大于所述第一平均粒径的第二平均粒径的多个第二磨粒。
根据一实施例,一种化学机械抛光的设备包含垫调节器。所述垫调节器具有面向抛光垫的修整盘及经配置以使所述修整盘振动的振动模块。
根据一实施例,一种操作化学机械抛光(CMP)设备的方法包含由以下组成的垫调节序列:提供用于所述CMP设备的抛光垫,所述抛光垫包括位于相同侧上的第一盘及第二盘,所述第一盘含有具有第一平均粒径的多个第一磨粒且所述第二盘含有具有小于所述第一平均粒径的第二平均粒径的多个第二磨粒;使用所述垫调节器的所述第一盘来对所述CMP设备的所述抛光垫执行第一垫调节;及使用所述垫调节器的所述第二盘来对所述抛光垫执行第二垫调节。
免责声明:文章来源于网络,如有侵权请联系作者删除。