
扫码添加微信,获取更多半导体相关资料
摘要
为了评估在300 mm直径硅片的湿法清洗槽中产生气泡运动的主导力,使用摄像机和光学显微镜研究了由兆频超声波产生的小气泡的典型运动。在MS波作用下,直径为10–30和200–300米的气泡的上升速度分别为0.002–0.003和0.02–0.08米/秒。直径为200-300米的气泡的速度取决于三个力,即浮力、毫秒波和水流。直径为10-30米的气泡的运动主要由横波驱动;浮力的影响很小。可以通过调节质谱波功率来改变紧靠晶片支撑杆上方的气泡路径。
介绍
在制造半导体硅微电子器件的整个过程中,非常干净的硅表面是必要的。在各种器件制造过程中存在的各种污染物通过使用超纯水和各种化学试剂的湿法清洗过程被去除,通常伴随着被称为兆频超声波的高频声波谱波产生微泡,这些微泡已经被用于各种工业领域的许多清洗技术.然而,质谱波经常导致图案塌陷和对硅表面上形成的非常小的结构的一些损坏。
在本文研究中,作为我们先前研究的延伸,使用了带有质谱波模块的无载体湿式清洗槽来观察排列的晶片之间和晶片支撑杆附近的气泡运动。根据气泡直径和向上速度之间的关系,并考虑到斯托克斯定律理论上给出的速度,评估了浮力、质谱波和水流的影响。
实验
图1和图2显示了实验中使用的带有气泡可视化工具的无载体湿式清洗槽的示意图。两个系统都由一个槽、300毫米直径的晶片、三个晶片支撑杆和两个水喷嘴组成。浴缸和水喷嘴是由石英玻璃制成的。晶片支撑杆由碳氟树脂制成。这项研究中使用的大部分晶片都是由透明的耐热玻璃制成的,选择这种玻璃是为了能够从不同方向观察晶片之间的气泡运动。晶片之间的距离是10毫米。湿式清洗槽的容积约为40 L。三个晶片支撑杆支撑着浴槽中的晶片。浴缸中小气泡的运动是通过连接到个人电脑的投影仪产生的一片光来照明的。直径非常小的气泡的运动气泡A是使用光学显微镜USB显微镜,被插入水中,如图1.使用连接到DVS-3000系统的超级眼睛C2847摄像机捕捉较大尺寸气泡B的运动。如图2.使用捕获的视频评估气泡的直径和速度。

图1 使用光学显微镜观察气泡a的300毫米直径硅片的湿法清洗槽
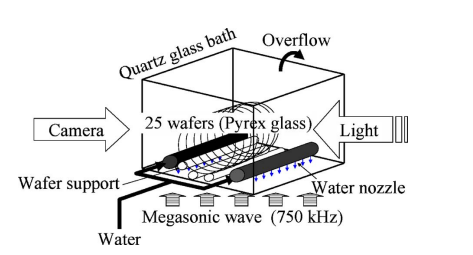
图2 300 mm直径硅片的彩色在线湿法清洗槽,用于从槽外使用超级眼观察气泡
讨论
在本节中,评估和讨论了气泡A和B的速度。首先,在图中详细讨论了气泡B的速度。.根据本文的实验,驱动气泡的力可以进行分类。在图中。5、B、M、W的箭头分别表示浮力、MS波和水流的驱动力。 气泡B的上升速度取决于质谱波的功率。在质波功率为1000W时,质波可引起约0.04m/s的上升速度,水流可以在0.03m/s以下的范围内增加气泡B的速度。这里,将气泡BMS的速度外推到0W的MS波功率给出一个小于0.02m/s的值,这可能对应于只有浮力产生的速度。总的来说,浮力、质波和水流三种动力对气泡B的速度的影响对气泡B的速度有相当的影响。当气泡B在质波功率为0W时,在图中假设是由于浮力,其他力的影响也可以被理解为有效的。因此,我们评估了浮力对空气压力的影响。此外,我们还将气泡A的速度与斯托克斯定律预测的速度进行了比较。
结论
研究了300 mm直径硅片湿法清洗槽中各种力对气泡运动的影响。直径为200-300米的小气泡上升速度为0.02-0.08米/秒,并随MS波的增大而增大力量。根据基于斯托克斯定律的评估,MS波被认为对驱动直径为200-300米的气泡运动的贡献大于浮力和水流。直径为10–30米的非常小的气泡被认为主要由质谱波驱动。通过调节质谱波功率,可以控制紧靠晶片支撑杆上方的气泡路径。
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁