
扫码添加微信,获取更多半导体相关资料
摘要
本文研究了HF、HNO3和H2O体系中硅的蚀刻动力学作为蚀刻剂组成的函数。蚀刻速率与蚀刻剂组成的三轴图显示了两种极端的行为模式。在高硝酸组成的区域,蚀刻速率仅是氢氟酸浓度的函数。在高氢氟酸组成的区域,硝酸浓度决定了蚀刻速率。后一区域的动力学行为因涉及硝酸还原产物的自催化而变得复杂。反应经过一个氧化步骤,然后是氧化物的溶解。在高氢氟酸区域,氧化步骤是限速的。在高硝酸区域,溶解步骤是限速的。在这两个区域,试剂通过扩散流动到表面决定了蚀刻速率。蚀刻速率作为速率限制试剂浓度的函数的图表明了蚀刻速率和浓度之间的指数关系。这种关系已经根据第二种非化学自催化因子,即反应的热进行了定性的解释。
介绍
本研究的目的是阐明确定酸蚀刻溶液行为的物理和化学过程。选择HF、次硝酸~、H~O系统进行研究,因为从组成的角度来看,它是硅上使用的所有酸蚀刻系统中最简单的一种。人们认为,理解简单的系统是理解更复杂的系统中包含如醋酸、溴或重金属盐的添加剂的先决条件。
实验步骤
所有的蚀刻都是在特氟隆烧杯中进行的,浸泡在25℃调节的恒温浴中,然而,烧杯的传热性非常差,不一定能在蚀刻溶液中保持25℃的温度。由于蚀刻周期一般小于1min,而且通常只有几秒钟,因此极不可能保持热平衡,而且反应可能被认为是在基本绝热条件下运行的。
在准备去势方案时,HF被重量输出到-0.01g . HNO3和水的重量被转换为体积,并在化油器中测量到cc。蚀刻溶液组成的控制是通过分析制作溶液的原酸和将这些原酸调整到适当的浓度,这是任意作为第一批试剂的分析。
为了得到晶体取向的影响和可以检查蚀刻速率上的电阻率类型,沿111、110和100个平面定向的p型和n型硅的样品,以及小硅球,以随机选择的几种成分进行蚀刻。
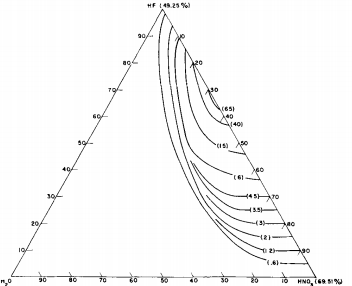
图1.模具厚度恒定变化率(每分钟毫升)作为蚀刻成分的曲线(系统中重量%为49.25%HF、69.51%HNO3和水)
结果和讨论
图1是蚀刻率的图(括号内的数字是每分钟毫里为单位的模具厚度的减小)作为蚀刻剂组成的函数。本研究中使用的试剂可以去除正常可获得的浓缩酸,即49%HF和70%次硝酸~。稍后将发现,通过使用这些试剂可获得的成分范围不足以阐明富高频区的机制,因此有必要通过使用更浓缩的试剂,即60%HF和90%硝酸来扩大该范围。与该系统对应的数据如图所示2.
在图中2,蚀刻速率最初对在高高频和高HINO2区域添加大量的水不敏感,前提是所考虑区域中速率决定物种的浓度保持不变。然而,在一个相当确定的组成下,系统突然对水的加入产生关键影响,蚀刻速率随着水浓度的轻微增加而迅速消失。下面将显示,蚀刻速率是由动力学上重要的物种到硅表面的扩散速率决定的。因此,蚀刻速率对添加的催化剂的浓度或由添加水引起的硝酸的氧化电位的变化没有反应。然而,在水的临界浓度下,溶液的氧化电位已经降低,使Si表面不再是硝酸几乎完美的汇,蚀刻速率略有下降。此时,催化剂的浓度开始发挥动力学作用。
催化剂产量的减少放大了蚀刻速率的轻微下降,因此在进一步加入水时,蚀刻速率迅速消失,即使速率测定试剂保持在相同的浓度。需要指出的是,常规浓缩的高频只包含临界量,因此非常高的高频区域的蚀刻率轮廓的斜率才刚刚开始与恒定的次硝酸线平行浓度。
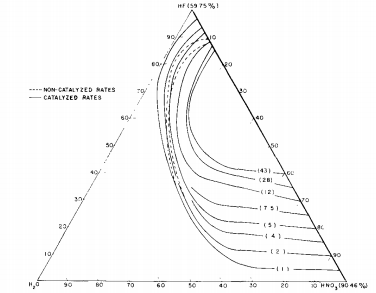
图2.模具厚度的恒定变化速率(每分钟毫升)作为蚀刻成分的变化曲线(系统中重量%59.75%HF、90.45%HNO3和水)
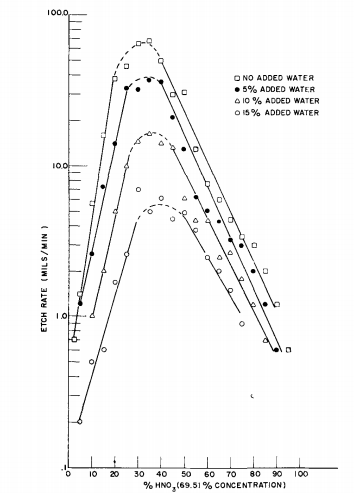
图3 模具厚度变化作为HNOs浓度函数的对数
结论 略
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁