
扫码添加微信,获取更多半导体相关资料
摘要
本文研究了在不同条件下单晶锗的蚀刻速率。为简单起见,所使用的主要蚀刻剂只由h2O2、HF和水组成。给出了速率作为温度和蚀刻剂成分的函数,以及作为晶体的取向和杂质含量的函数的数据。一个假设在表面依次发生两个反应的方程拟合实验误差范围内的速率与温度数据。在所研究的范围内,速率控制过程对样品取向很敏感。从蚀刻数据中,得到了由于研磨造成的扰动表面层厚度的值。这在2-10u范围内,取决于样品取向和磨料粒径。给出了两种比较复杂成分的常见蚀刻剂的比较数据。
介绍
为了进一步了解这些过程,人们对锗晶体在不同条件下的蚀刻速率进行了研究。为简单起见,大多数作品都局限于只含有HF、H202和水的蚀刻剂。为了确保样品的均匀性,所有样品都从一个掺杂n型锗的大单晶中切下来。由于晶体的电阻率随其长度变化缓慢,通过从晶体的适当区域选择样品,可以得到1~9欧姆厘米之间的电阻率。样品较薄,通常厚度在30英里左右,因此面面积与边缘面积之比较大。将边缘区域纳入与面相同的方向所引入的误差小于2%。样品用聚乙烯涂层的镊子保存,接触面积足够小,可以忽略。蚀刻率是通过测量已知蚀刻时间后样品的重量损失来获得的。体重被测量到0.2毫克,体重差异通常为大约是20毫克。人们相当注意蚀刻剂的新鲜度和组成以及样品的表面制备。为了使蚀刻溶液的循环不应该影响结果,所有的实验都是在足够剧烈的搅拌条件下进行的,因此搅拌的实质性变化对蚀刻速率没有影响。
蚀刻时间
在玻璃板上用305号磨料均匀磨表面,制备了一些薄样品。它们称重,在恒温下用2号蚀刻进行短暂蚀刻,然后再次称重。然后计算这个区间的平均蚀刻率。重复蚀刻和称重过程,直到速率保持不变。在各自间隔的中点绘制平均速率,并得到rate-vs.-time曲线。实验结果的一个代表性样本如图所示 2。所示的值是从相同的9欧姆厘米晶体中切割出的三个不同方向的样品。第二组数据是用1-6欧姆时代的样品获得的,得到了类似的曲线,这些样品的数据使用更粗的磨料。
在蚀刻速率变得恒定之前必须去除的层的厚度可以从图中的曲线中估计出来。得到了范围为2-10u的值。这些范围与寿命测量的Faust(1)和x射线线展宽的魏斯曼研究报告的无序层厚度值相同。据报道导致电阻率变化的扰动的厚度要小一个数量级。这表明,晶格影响寿命和线宽的性质被干扰到与表面被裂纹和凹坑的深度大致相同。如果这是真的,被扰动的表面层应该是晶体取向和磨料粒径的函数。如果扰动的极限被任意定义为蚀刻速率下降到其最终值的10%以内的深度,则结果如表1所示。
如果蚀刻过程确实通过氧化和随后的溶液进行,那么找出关于氧化过程的什么将是有兴趣的。如果形成了GeO,那么由于这是不溶的,很可能发生第二次氧化为二氧化锗。从方程可以看出,不能从恒定下的速率与浓度数据中了解这些步骤。因为如果有h个连续的反应涉及相同的反应物到相同的功率,那么方程的形式与这些h个反应只被一个取代的形式相同。因此,我们不能分离这些h阶段。如果有所提议的连续氧化,就会出现这种情况。
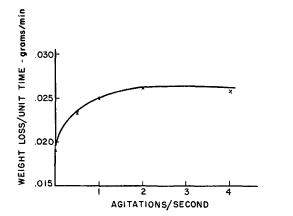
图1 搅拌作用对蚀刻速率的影响

图2 蚀刻速率与蚀刻时间和晶体取向的函数。蚀刻前,表面用305号磨料细磨
速率与杂质
图中8是9.4欧姆时代样品(111)表面蚀刻速率与温度依赖性的图。在同一图上绘制的是一个1欧姆时代的样品的点,(111)表面方向,作为温度的函数,以及在一个温度下的(100)和(110)表面的数据。单个温度点是多个观测结果的结果。仔细观察结果表明,9欧姆时代的材料蚀刻速度略高于1欧姆厘米时代的材料。差异接近实验误差的估计极限,但似乎是可重复的。这些样品都是掺砷的。
为了确定蚀刻速率是否与杂质类型有关,我们测量了含有钒(6ohm-em)、锑(2ohm时代)、镓和锑平衡(0.7ohm-cm)和铟(0.02ohm-cm)的样品。所有蚀刻都比2欧姆电阻率的砷掺杂材料快约10%。然而,对方向的控制很差,这些结果可能有15%的怀疑。至少没有显著的差异观察到。迄今为止,一些杂质对蚀刻速率有不同影响的最好证据来自于小球体的蚀刻。含有锑和铟平衡(6ohm-cm)、磷(0.1ohm-cm)、铊(0.8ohm-cm)和镓(0.3ohm-cm)的晶体球在2号蚀刻中蚀刻成平衡形式。其中,只有掺杂镓的样品与掺杂砷的样品有显著差异。这个差异并不大。对于单独掺杂镓的样品,平衡形式不是一个十二面体。这表明(110)水平并不是最快的蚀刻平面。
蚀刻剂的比较
在实践中使用了许多不同的蚀刻剂。附录中列出了一些最常见的情况。研究了2、3、4依特剂的rate-vs.-temperature依赖性。一些结果如图所示 9。3号蚀刻的数据非常不稳定,4号蚀刻的数据更差,因此无法绘制曲线。其中两点完全脱离了图。为获得这些数据所进行的一些实验表明,有时在锗表面会形成一层,以钝化或以其他方式抑制这些蚀刻剂的反应。例如,2号中的简短蚀刻将使样品在一段时间(一分钟蚀刻或更长时间)内几乎对3号蚀刻的作用免疫。在单独使用2时没有观察到这种抑制作用。因此,最好对通常使用3号或4号的操作使用2号蚀刻剂的浓缩版本。可以获得的速率可以从rate-vs.-dilution曲线,图。 6.未稀释的试剂H202和I-IF的混合物可以快速蚀刻。如果二氧化物最终在H2O2中形成,那么过氧化物和纯水应该蚀刻锗。
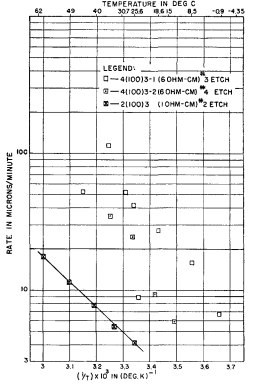
图 9 蚀刻率三种不同的蚀刻剂。3号和4号蚀刻剂的不稳定行为使得通过这些数据绘制曲线毫无用处
结论
本文已发现,HF和H2O2的水溶液是一种可靠的锗蚀刻剂。当在聚乙烯中储存时,它长时间稳定,当在剧烈搅拌条件下使用时,在广泛的温度和成分下产生容易重复的结果。通过适当的调整条件,可以在室温下获得低至0.03u/min或高达20u/min的速率。蚀刻速率取决于晶体取向、表面无序度和晶体杂质含量,(110)表面和纯锗的腐蚀速率最快。随表面无序度的增加与表面积的增加相当。蚀刻攻击显然受到两个明显独立的按顺序发生在晶体表面的过程的限制。
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁