
扫码添加微信,获取更多半导体相关资料
摘要
使用旋转圆盘电极在各种磷酸基电解质中研究了铜和铜/钽/硅晶片样品的电抛光,包括几种添加乙醇和其他物质作为稀释剂的电解质。稀释剂允许获得大范围的水浓度,还降低了铜电解抛光过程中的溶解速率,简化了镶嵌工艺的可能应用。对测得的极限电流密度进行莱维奇分析,证明水是速率决定步骤中涉及的受体物种。所确定的有效扩散系数与先前从电流体动力阻抗获得的几乎完全一致,这不需要了解极限物质。
介绍
电抛光长期以来在工业上用于各种目的,最常见的是用于进一步处理或分析的表面准备和用于美容目的的表面抛光。电抛光可包括表面平整和或表面光亮。尽管这些术语经常互换使用,但调平通常与大于1微米的表面特征的平滑有关,而与小于1微米的特征的增亮有关。尽管广泛使用,但这种机制电抛光通常发生在金属表面钝化的高阳极电位下的质量传递限制电流下。然而,研究人员提出了多种对电抛光至关重要的工艺,包括在电化学界面形成粘性膜,与该膜接近其溶解度极限相关的动态效应,以及溶解金属离子的溶液相受体种类。这些不同效应的相对重要性和相互依赖性仍不清楚。
在本报告中,我们介绍了铜在磷酸溶液中电抛光的研究,该溶液含有稀释剂,并确定水是速率确定步骤中涉及的受体物种。
实验
实验在两个不同的样品上进行,晶片样品被用作图案化晶片样品上铜电解抛光的对比,这将在别处报道。采用从含有硫酸铜、硫酸和苯并三唑的电解液中电沉积来将晶片样品上的覆盖铜膜厚度增加到大约3-4毫米。晶片样品通过聚四氟乙烯安装套筒附着在标准的派恩仪器RDE轴上。铜/钽/硅工作电极如图所示1,电连接不是通过硅晶片进行的,而是通过铜带围绕边缘进行的。贴上晶片后,晶片边缘涂上一层薄薄的环氧树脂。电解质粘度用布鲁克菲尔德同步电动粘度计测量。通过在容量瓶中称量电解质来测量电解质密度。除非另有说明,所有实验均在室温(22±6±1℃)下进行。
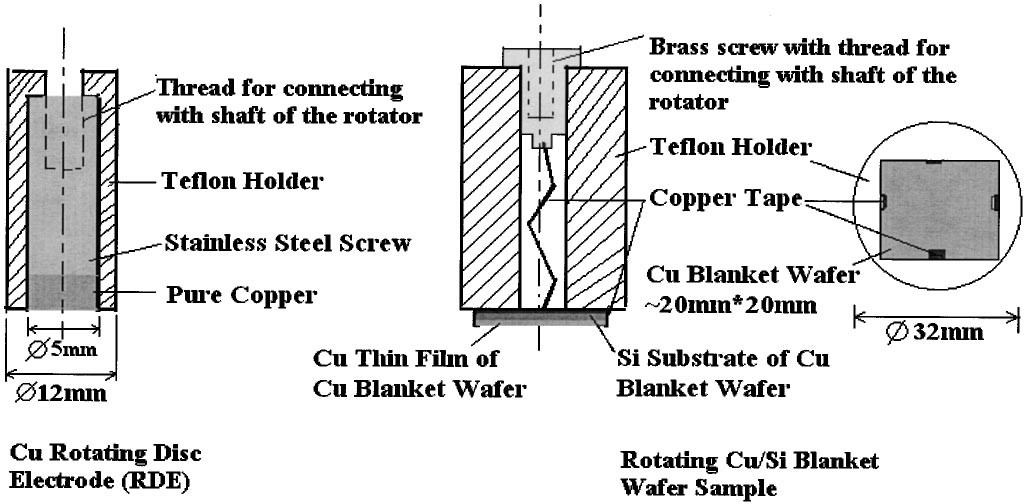
图1铜/钽/硅工作电极示意图
结果和讨论
图2显示了标准铜旋转圆盘电极的典型循环伏安图RDE和铜/钽/硅晶片样品,在100 rpm下,在含有12 M H3PO4和2.7 M C2H5OH的电解抛光电解液中。极限电流密度的差异小于后续测量之间的差异。这表明,尽管晶片边缘附近存在非理想的流体动力学和质量传递,但铜/钽/硅组件相当接近标准铜RDE.15在约0.75伏对。在极限电流平台上观察到SCE和电抛光。在一些伏安图中,由于样品尺寸的原因,极限电流平台不完全是水平的,因此拐点被视为极限电流密度的定义。这种影响也很明显,因为在铜/钽/硅样品中观察到了极限电流平台的电压滞后。
图4和图5显示了极限电流密度对磷酸盐和水浓度的依赖关系,每个浓度乘以n21/6。这些结果表明水,而不是含磷物质,参与了速率决定步骤。然而,莱维奇分析的简单性需要进一步讨论。正如薛和纽曼所讨论的,从理论上讲,莱维奇行为的偏差可以由各种不同的原因引起。对于在浓磷酸溶液中的铜电抛光,这种偏差很可能是由扩散层内的密度、粘度和有效扩散系数等物理性质的变化引起的。最重要的是,不同成分的电解质已包含在图中。
物理性质如密度、粘度和扩散层内的有效扩散系数的变化对莱维奇分析的影响难以定量解决 。他们讨论了表面粘度和体积粘度之间的差异对从莱维奇分析中获得的有效扩散系数的影响。图7显示了本研究中不含乙醇和含乙醇的磷酸电解质的粘度随水浓度的变化。在这两种情况下,由于在极限电流下地表水的浓度应该接近于零,所以表面粘度大约是整体粘度的两到三倍。在这种情况下,有效扩散系数可被视为与电极表面的有效扩散系数非常接近。
目前的研究和其他研究表明,水是参与速率决定步骤的受体物种。水扩散系数的唯一可用估计值是从电流体动力阻抗中获得的,它不需要了解所涉及的物种,得出的值为5X10-8 cm2/s.13这几乎与这里确定的有效扩散系数完全一致,此时假设sH值为6。

图2 标准铜旋转圆盘电极在5毫伏/秒和100转/分下获得的循环伏安图左侧!还有那个Cu/Ta/Si旋转晶圆电极!在14.6米H3PO4和14.1米H2O
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁