
扫码添加微信,获取更多半导体相关资料
介绍
在本研究中,我们使用不同的湿化学蚀刻条件来蚀刻硅、锗和硅锗,并将硅锗蚀刻速率数据扩展到锗摩尔分数在20%和100%之间。比较了三种情况下的刻蚀速率:I .在槽中的覆盖刻蚀,ii .在单晶片旋转处理器中的覆盖刻蚀,以及iii .硅锗/硅异质结构的横向刻蚀。
实验
通过减压化学气相沉积(RP-CVD)在Si100衬底上的厚的线性渐变Si1yGeY y x缓冲层上生长厚度约为1 μm的本征Si1xGeX层.14在生长的叠层上使用化学机械抛光来去除表面交叉影线。用卢瑟福背散射光谱法验证了不同合金中锗的含量。此外,为了进行比较,研究了在Si100 15和纯Si100晶片上的反相化学气相沉积生长的热循环2.5 m锗层。在蚀刻以形成合适的蚀刻步骤之前,用聚合物部分掩蔽样品。在蚀刻和去除掩模之后,使用Dektak 6M触针表面轮廓仪测量蚀刻步骤的高度。蚀刻时间在30秒到10分钟之间,在室温25℃和轻微搅拌下在聚丙烯烧杯中进行。
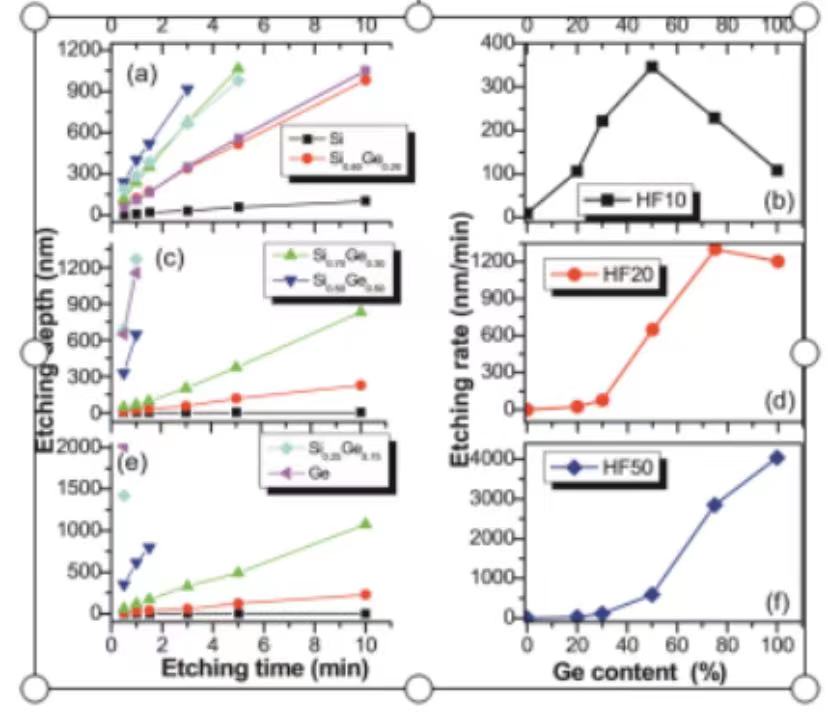
图 1
随着时间的推移,从新制备的溶液的低蚀刻速率开始,并在48小时后达到更高且恒定的蚀刻速率。老化对于获得H2O2、CH3COOH及其反应产物过乙酸(作为氧化物质)浓度的稳定平衡是必要的。
结果与讨论
初始实验表明,在新制备的溶液老化2天后获得的蚀刻速率至少稳定一周。因为溶液HF50导致锗含量较高的硅锗的蚀刻相当快,所以测试了使用更稀释的氟化氢的两种不同溶液,即HF20和HF10,以获得更慢和更合适的蚀刻速率。使用30 s、60 s、90 s、3分钟、5分钟和10分钟的蚀刻时间。通过在HF10中蚀刻获得的在纯硅、纯锗和几个具有不同锗含量的硅锗层中测量的蚀刻深度与时间的关系如图所示。1a . 结果表明,刻蚀深度几乎与时间成线性关系。蚀刻速率很大程度上取决于层中锗的含量。在研究次数和实验精度范围内,刻蚀深度随刻蚀时间线性增加。当锗含量达到约50原子%时,刻蚀速率也增加,当锗含量达到纯锗时,刻蚀速率略有下降。图1b显示了HF10溶液在所有应用的蚀刻时间内的平均蚀刻速率与锗含量的关系。蚀刻速率从纯硅的约10纳米/分钟增加到硅的最大值350纳米/分钟,然后再次降低到纯锗的值110纳米/分钟。蚀刻过程由两个独立的反应组成。该材料首先被过氧化氢和乙酸的混合物氧化,氧化物最后被氟化氢溶解。蚀刻速率受到两种工艺中最慢的工艺的限制。用称为HF20的蚀刻溶液进行了类似的实验,该溶液含有较高浓度的氟化氢。对于具有不同锗含量的纯硅、纯锗和硅锗层获得的相应蚀刻深度是蚀刻时间的函数
HF20中的数据如图1所示。1c . 对于HF10蚀刻,还观察到蚀刻深度随着时间的增加而线性增加。获得了显著更高的蚀刻速率,特别是对于更高的锗含量,而纯硅的蚀刻被延迟。对于阿格含量为75原子%的硅锗合金,测量到最高蚀刻速率。蚀刻速率在图2的所有数据点上平均。1c示于图1中。1d。最后,用HF50溶液进行蚀刻实验。已经报道了锗含量高达40原子%的用HF50在硅上选择性蚀刻硅锗的数据.12,17图1e显示了用HF50溶液蚀刻后在纯硅、纯锗以及具有不同锗含量的硅锗合金中获得的相应蚀刻台阶高度。同样在这种情况下,蚀刻深度随着蚀刻时间线性增加。对于HF50溶液,观察到高得多的选择性,该选择性定义为硅锗或纯锗的蚀刻速率除以硅蚀刻速率。高锗含量硅锗层和纯锗的蚀刻确实非常快。大约2000纳米的纯锗已经在HF50溶液中蚀刻了30秒。相应的蚀刻速率如图2所示。一般来说,对于含有较高含量氟化氢的蚀刻溶液,选择性较高。锗含量高的硅锗合金或纯锗层的腐蚀速率非常大。对于HF10、HF20和HF50溶液,蚀刻速率随着锗含量的增加而显著增加,并且分别发生在0-50、20-75和50-100的锗原子%范围内。这种效果允许根据层中锗的含量和所需的选择性选择合适的蚀刻溶液。
结论
进行详细的槽蚀刻实验以确定纯硅、Si0.8Ge0.2、Si0.7Ge0.3、Si0.5Ge0.5、Si0.25Ge0.75和纯锗的蚀刻深度对时间和蚀刻速率的关系。几个系列的样品在三种不同类型的溶液中被部分掩蔽和蚀刻,这三种溶液含有体积比为1∶2∶3的氟化氢、过氧化氢和三氯羟基甲烷.三种不同的溶液含有浓度为50%、20%和10%的氟化氢,并在蚀刻实验前老化2天。一般来说,定义为硅锗蚀刻速率除以硅蚀刻速率的选择性对于含有较高量的氟化氢的蚀刻溶液来说较高。锗含量高的硅锗合金或纯锗层的腐蚀速率非常大。这种效果允许根据特定的锗含量和所需的选择性选择合适的蚀刻溶液。将槽蚀刻实验与使用自动旋转蚀刻工具的平面蚀刻实验以及具有不同锗含量的硅/硅锗叠层的横向蚀刻进行比较。