
扫码添加微信,获取更多半导体相关资料
引言
应用放射性示踪技术研究了金属杂质(如钡、铯、锌和锰)从化学放大光刻胶中迁移和吸附到硅基底层衬底上的行为。评估了两个重要的工艺参数,即烘烤温度和衬底类型(如裸硅、多晶硅、氧化物和氮化物)。结果表明,过渡金属(锌和锰)的迁移率比碱金属(铯)和碱土金属(钡)低,与基底类型和焙烧温度无关。过渡金属与光致抗蚀剂层中共存的焊料和/或水解物质形成稳定的络合物。发现金属络合物的尺寸、溶剂蒸发中的拖曳力和烘焙过程对杂质迁移有显著影响。我们提出了一个新的模型,结合化学放大光致抗蚀剂中的金属迁移和随后在底层衬底上的吸附,来解释金属迁移的途径。该模型可以解释金属杂质从光致抗蚀剂层向衬底表面的迁移率。
实验
材料用直径为15厘米的p型< 100 >晶片生长有各种薄膜(即多晶硅、二氧化硅、氮化硅和非钝化或裸硅对照)。它们被切成2×2厘米的小块作为测试样品。然后通过各种光刻和剥离工艺处理这些样品,以研究光刻工艺中引入的污染物。光刻胶的选择在表1,选择这种特殊的光致抗蚀剂是因为它是最先进的超大规模集成(ULSI)制造中栅极和金属层应用的常用光致抗蚀剂。它可用于波长为248纳米的KrF准分子激光曝光。

表1 光刻剂组成
为了制备用于研究的不同底层衬底,在石英反应器中通过低压化学气相沉积(LPCVD)在各种起始硅片上沉积多晶硅和氮化硅膜。用流速为60 cm³/min的硅烷气体(SiH4)沉积多晶硅膜。
放射性示踪剂实验程序:—为了制备放射性光致抗蚀剂,将一体积稀释的放射性示踪剂(0.005 M)与五体积光致抗蚀剂混合,并充分摇动放射性光致抗蚀剂溶液以确保均匀分布。然后如前所述,通过旋涂工艺将放射性光致抗蚀剂施加到测试样品上。蒸发溶剂后,用高分辨率伽马射线光谱仪对测试样品进行计数。计数系统由一个高性能锗检测器、一个多通道分析仪和普通电子设备组成。如表二所列,每种示踪剂的伽马射线在不同的能量通道下被监测。计数后,通过在60℃下在100毫升NMP溶液中浸泡5分钟除去光致抗蚀剂层,并在热板上干燥。然后用同样的高性能锗检测系统检查残留在晶片上的杂质的放射性。金属杂质从光致抗蚀剂到下层衬底的迁移率由光致抗蚀剂剥离前后的平均时间计数的比率决定。
结果和讨论
金属杂质的迁移率:由于烘焙后的化学放大光刻胶层是无定形聚合物,我们之前的论文使用扩散模型来预测光刻胶层和底层衬底中Mn和Zn的行为。这是基于光刻胶层中金属杂质的浓度高于涂覆光刻胶后立即在衬底中的浓度这一事实。在烘焙过程中,金属杂质开始向基底迁移。然而,为了精确描述基底附近和基底上的金属迁移,可以使用各种可能的机制来阐明迁移过程,包括基底表面上的吸附、与基底表面的化学反应、差异、溶解度、沉淀和吸杂。
图1-4描述了钡、铯、锌和锰杂质在每个衬底上相对于烘烤温度的迁移率。由于实验程序的不同,铯、锌和锰的结果与我们以前的报告有些不同。在本方法中,在用NMP溶剂剥离光致抗蚀剂层之后,直接烘烤晶片,而我们先前的报告是通过首先用水浸渍然后烘烤获得的。钡和铯的迁移率明显高于铯,与底物无关。观察表明光致抗蚀剂层中的大多数钡杂质可能仍然以游离离子的形式存在,而铯以水化的形式存在。相对较小的Ba尺寸会导致烘烤过程中迁移更高。实验结果表明,在烘烤过程中,钡原子通过扩散过程迁移到衬底表面。这种金属迁移过程会引起表面腐蚀污染、恶化器件性能并降低产量。我们相信,相同的过程实际上发生在光刻胶中存在的任何金属污染物上。因此,通过继续这项研究来理解光刻过程中控制金属迁移的机制是至关重要的。
温度对金属杂质迁移的影响:在平版印刷术中,软烘烤(通常在热板上)可以去除大部分溶剂。溶剂逐渐从抗蚀层蒸发,而任何化学形式的金属杂质开始向基底扩散。
迁移-吸附模型:考虑到金属杂质向基体迁移,首次提出迁移-吸附模型来描述这种行为。基本上,应该考虑如图6所示的体区和界面区中的金属杂质。在本体区域,温度和溶剂效应是控制因素。较高的烘烤温度导致向基底的较高扩散,而共存的溶剂以相反的方向蒸发。因此,根据上一节的描述,金属杂质在体区会有复杂的行为。
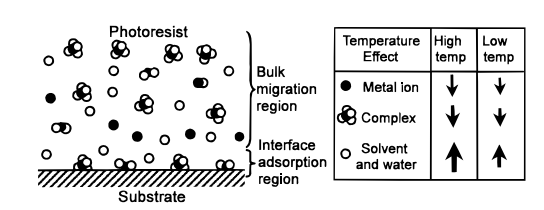
图6 金属杂质从整体迁移区(光致抗蚀剂)输送到界面吸附区(基底)的迁移-吸附模型
迁移吸附模型的应用:在前文中,我们提出了迁移-吸附模型来描述光刻胶层中存在的金属杂质的行为。模型表明迁移率受两个因素控制。第一个是从体区迁移到界面区的金属量。第二个是方程预测的表面吸附。在界面区域。新提出的模型与图1-4中的实验结果一致。过渡金属的迁移速率低于本体区域中的碱金属和碱土金属。过渡金属在界面区的浓度较低。
因为碱金属和碱土金属比过渡金属配合物具有更大的电荷半径比,所以它们与表面硅烷醇基显示出更高的吸引力。根据这一推理,过渡金属的平衡常数低于方程式中的碱金属和碱土金属。考虑到上述原因,过渡金属具有较低的表面金属吸附。因此,出现在图1-4中的迁移率可以用所提出的迁移-吸附模型来解释和预测。
总结
我们已经成功地提出了光致抗蚀剂层中的金属杂质的迁移和在衬底表面上的吸附的机制和模型,以描述范围从80到120的烘烤效应的行为。溶剂性质和烘烤温度在迁移过程中起重要作用。过渡金属(锌和锰)在烘焙过程中与溶剂和/或水解产物形成络合物。配位络合物通过光致抗蚀剂层中的运动显示出更高的电阻,这导致更低的迁移率。用于修正扩散系数的相关函数可以描述温度对迁移率影响的不同趋势。
在所提出的迁移-吸附模型中,金属杂质的迁移以两种途径进行(即,在体区和在界面区)。在本体区域,尺寸和溶剂效应影响金属杂质的迁移。在界面区域,表面吸附是影响迁移率的机制。
平衡方程用于描述吸附的表面金属的浓度、平衡常数、硅烷醇基的表面浓度、金属杂质的浓度和pH值之间的关系,对于阐明钡、铯、锌和锰的迁移率非常有用。