
扫码添加微信,获取更多半导体相关资料
引言
半导体制造过程中流入硅片表面的污染与器件的可靠性下降、晶体缺陷一起带来良品率的减压,因此控制这种污染的技术非常重要。因此,在半导体制造技术方面,污染控制技术,如设计技术和工艺技术等具有重要意义,一直在发展。作为污染控制技术的一部分,清洁技术在制造工艺上实际上一直被用作连接到晶片上的直接污染控制手段,半导体工艺约占清洁工艺的20%。事实上,为了稳定地形成高质量的超细薄膜,确保高选择性的VLSI/ULSI制造技术,基于邀请晶技术的SI基板清洗变得非常重要。例如,晶片必须在热氧化杂质扩散硅薄膜的外延生长、化学气相沉积和其他热工艺等工艺之前清洗干净。目前,湿式清洁被广泛使用,原因是它对从硅酮表面清除嘴、金属污染物和自然氧化膜有效。但是,湿式清洁不仅需要大量的化学试剂和DI Water,而且因为化学试剂的废弃成本高、有害,所以越来越接近其有用性的极限。
本方法通过SEM和XPS分析了在去除金属污染源的清洗方法中,利用UV/O3代替等离子体、UV/Cl2、Vapor phase对硅片进行精密清洗的方法,在臭氧和紫外线各自的清洗方法中,根据清洗时间,Vapor表面残留物质。
实验
图1显示了通过本实验使用的臭氧发生器、原料气体供应装置、前院长装置和仪器真空泵等对臭氧发生装置进行球形化,以研究臭氧发生器的放电特性和臭氧生成特性的实验装置的布置图。图中实线是连接用于调查放电特性的电源装置和仪表装置的电路,虚线是研究臭氧生成特性的气体流动先导,表示通过原料气体供应装置和仪表的臭氧化气体的流动。
如图所示,原料气受到周围环境变化的影响较小,主要使用氧气来比较相关因素的影响。此时,随着流量和NT(NT)输出电压的变化,放电启动电压、放电启动电流、放电波形和外部介质放电间隙的变化,放电电压将由高压分压器产生。
利用SEM和XPS分析了臭氧和紫外线各自的干式清洗方法中,根据清洗时间的不同,晶圆表面残留的物质。
总结和讨论
图4-(a)以SEM表示SF6等离子体上清洁晶片5分钟时未去除的FOTRORRIGSTET碎片,这表示大量杂质微粒和破碎的FOTRORRIGSTET碎片。图4-(b)显示了在晶片上进行20分钟的Q/UV健食清洗时没有移除的波托雷吉斯特。与图4-(a)相对照,图4-(b)时晶片表面是干净的。与图4-(a)相比,4Tb)是500张照片。
图7显示了使用XPS只用臭氧清洗硅片各5分20分钟的时候-所有元素对清洗时间都有一点变化。这是因为氧气和硅随着清洗时间的增加,臭氧氧化成为无机基板。相反,氧气与UV干粮清洁相比,有很大的减少。这是硅晶片与氧原子一起包含臭氧,转换成挥发性物质。
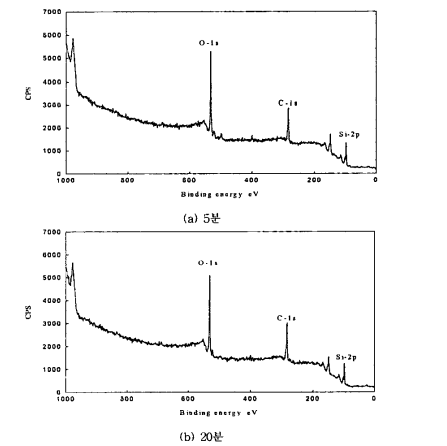
图7 只用臭氧分别清洗硅片5分和20分钟时XPS成分分析结果
图8显示了清洁08/UV的硅片5分钟。这是清洗时XPS成分分析的结果。在那之前很明确蟹氟(F)的出现是因为氧化物被O8/UV清洗去除。那是氟自由基与硅片碰撞的结果,氟原子进入氧化膜内,随着氧化膜的清除,氟出现了。碳的情况是硅晶片中的碳氢化合物被O3/UV分离,结果增加了碳峰。但是,在图9中,可以确认氟在O3/UV清洗中被清除干净。而且碳也被去除了,这是因为紫外线光产生氧原子和分子,臭氧发生器不仅产生臭氧,还产生氧分子,所以氧气的大小也会增加。

图9 071JV清洗的硅片20分钟XPS成分分析结果
总结
本文章的主要研究领域可分为用于清洗的臭氧发生系统和蚀刻的硅晶片的清洗工艺。(1)0:在使用/UV进行的干式清洗中,清洗时间为5分钟时,可以看到晶片表面残留了大量杂质,但清洗时间为20分钟时,杂质水量明显减少。(2)使用XPS分析晶片表面残留物时,氧气和硅是只用紫外线进行的干式清洗。
只用臭氧的饮食清洗方法对氧气的去除非常有效。但是,只用臭氧清洗碳和硅是很难去除的。另一方面,使用臭氧和紫外线的清洗方法对氟和碳的清除非常有效。