
扫码添加微信,获取更多半导体相关资料
引言
等离子体蚀刻是集成电路制造过程中最重要的步骤之一,氟是许多这类等离子体中的主要蚀刻剂。因此,许多表面科学研究致力于氟物种与硅的相互作用,以阐明蚀刻过程的基础物理和化学。到目前为止,大多数硅/二氟化氙反应的温度依赖性研究都集中在产物分布上。在分子束装置中定量研究了硅(100)/二氟化氙刻蚀反应的温度依赖性。在150 K的样品温度下,反应概率最初达到统一,之后二氟化氙凝结在表面上并阻止蚀刻过程。使用热解吸光谱测量的SiFx反应层的稳态氟含量在300 K时达到最大5.5个单层。随着温度的升高,它降低到700 K以上的亚单层覆盖率。通过将二氟化氙前体包括在先前开发的吸附模型中,反应层形成的温度依赖性得到了很好的描述。
实验
实验是在一个多光束装置中完成的。研究的样品都是n型(磷,2–3ω·cm)硅(100)表面。用HF清洗样品以除去天然氧化物后,将其安装在UHV室中,背景压力低于10-8托。镍样品架的温度可以控制在100-1000K。在每次实验之前,样品被加热到900K,以去除所有剩余的氟。为了验证样品没有被样品架上的镍污染,一些样品在实验结束后被转移到不同的装置中,并进行俄歇和XPS分析。没有发现镍或任何其他金属的痕迹,这表明污染物的影响可以忽略不计。
二氟化氙通过与表面法线成52°角的流出气体源提供。根据二氟化氙蒸汽压和气体源的尺寸计算出xef2通量。在样品直径为3mm的检测区域上,它可以从0.06MLs-1 到3.6MLs-1 不等。从样品探测区域分离的物种检测由四极质谱仪进行,该仪位于一个单独的UHV室,背景压力低于102 9 Torr。探测器室通过两个流动电阻和一个差动泵送级与样品室分离。采用热解吸光谱法分析了SiFx反应层。这是通过在监测sif4解吸的二氟化氙暴露后将样品加热到900k,同时进行2Ks-1解吸。
通过对这些热解吸光谱的积分,确定了该层的原始氟含量L。该技术也被用于监测在蚀刻过程中样品的粗糙化。为了校正表面粗糙度,将氟含量L缩放为校准实验的氟含量Lcal。该校准实验包括将干净样品在300k下暴露在1.0mls-1 的xef2通量中3000秒,然后进行热解吸实验。由于我们假设Lcal与有效表面积成正比,所以按比例计算的氟含量L将与表面粗糙度无关。在本文的描述中,表面粗糙度(Lcal)随着样品的老化而整体增加。然而,与室温实验相比,表现出一定的波动。这可能与温度范围内蚀刻速率的大变化有关。
结果和讨论
硅/二氟化氙蚀刻速率显示出复杂的温度依赖性。随着温度从150 K升高,它最初降低,在400 K左右达到最小值,随后升高(图7和图9)。高温下的增加是由反应机制向二氟化氙的直接冲击离解的变化引起的。然而,我们观察到高温下蚀刻速率的增加与SiFx反应层的击穿(图4)和SiF2的产生(图9)相关。因此,我们怀疑SiF2的解吸,以及表面反应位点的增加,是高温下蚀刻速率增加的实际原因。当温度足够高时,不完全的氟化硅物种可以自发解吸。当然,这些反应步骤必须被认为不过是对整体行为的粗略描述。实际上,SiFx反应层不是由SiF2物种组成,而是由SiF-、SiF2-和SiF 3-物种组成的复杂链结构,这是在顺序氟化机制中产生的。因此,SiF4和SiF2的生产机制也将更加复杂。

图9 SiF4生产的生产系数和SiF2生产的生产系数的温度依赖性
我们将在链模型的框架内讨论反应层的形成,该模型用于描述室温下反应层的形成。在该模型中,反应层的形成包括两个步骤。首先形成单分子层的SiFp物质;这是一个快速的过程。然后是从单层到多层六氟化硫链的缓慢转变。参数p和q代表每个表面硅位置的平均氟原子数量。当我们将低于和高于室温的温度下的数据与链模型的300 K拟合进行比较时,我们观察到氟含量的初始增加在较低温度下更快,在较高温度下更慢(图5和6)。这再次表明了二氟化氙前体的存在。随着温度的降低,二氟化氙前体浓度的增加将导致反应层在较低的二氟化氙剂量下形成,并因此显示出更快的增加。
显然,前体效应不足以解释反应层形成的温度依赖性。这并不奇怪,因为蚀刻速率和产品分布都随着温度的变化而显著变化。这意味着参数p和q可能也是温度相关的。当我们使用这两个参数来拟合反应层形成与前体链模型时,我们获得了图14和15中的虚线。
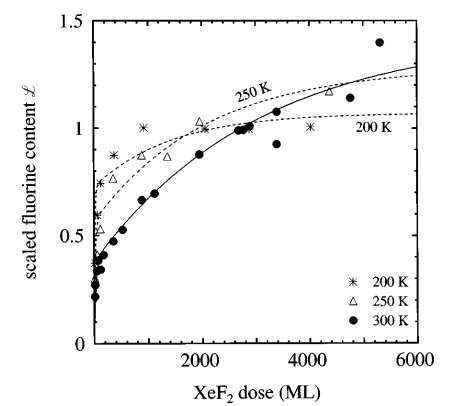
图14对于300 K及以下的样品温度,反应层的比例氟含量与二氟化氙剂量的函数拟合
根据图14中的剂量依赖性,我们得出结论,2400毫升的暴露量只是一个不好的选择。低温下q值的降低可能是由于在这种情况下蚀刻速率的大幅增加,使得链形成的时间不足。氟进入硅晶格也可能在低温下变得更加困难。对于高温下的减少,松散结合物种的解吸可能是原因。另一种可能的解释是层内缺陷的愈合。q的最大值与SiF 6贡献的最大值一致,如SiF+/SiF+信号比和氟原子实验中观察到的,这似乎是合理的,因为多层是形成Si2F6所必需的。
总结
我们对硅/二氟化氙反应的温度依赖性的所有方面进行了详细的验证。发现稳态反应层在室温下具有最大氟含量。该含量对应于5.5毫升的光滑表面,表明是SixFy多层结构。温度升高时,其覆盖范围降至700 K以上的亚单层。温度降低时,其覆盖范围也略有降低,但低于200 K时,由于二氟化氙冷凝,氟含量再次增加。随着温度的降低,该反应层的形成更快,这表明存在前体介导的机制。涉及二氟化氙前体的反应机理也是必要的,以解释随着温度的降低,反应概率从300 K时的20%增加到150 K时的100%。在一个简单的模型中,前体解吸的活化能估计为32±4兆电子伏。对于600 K以上的温度,反应概率在900 K时再次增加到45%。这可以用活化能为260±30兆电子伏的二氧化硅的产生来解释。