
扫码添加微信,获取更多半导体相关资料
作为用于高寿命蓝色LD (半导体激光器)、高亮度蓝色LED (发光二极管)、高特性电子器件的GaN单晶晶片,通过hvpe (氢化物气相)生长法等进行生长制造出了变位低的自立型GaN单晶晶片。GaN单晶晶片生长后不久通常为圆形,厚度、外径有偏差。 另外,在外延器件工序中,不是刚刚生长后晶片,而是通常为平坦的面、传感器为了判断放置在接头上的均匀外径、结晶方位,与结晶面平行加工的OF(定位平面)、为了识别表背面而实施了IF (索引平面)加工的晶圆和背面为梨皮状(粗糙化面)的晶圆。因此,通常为了调整晶片形状,使用NC (数控)加工机和仿形式的加工机进行外径倒角加工,此外,为了得到平坦的面,还进行磨削研磨进行蚀刻研磨加工。
作为加工后的清洗,进行以除去重金属为目的的酸清洗。一般来说是半导体晶片的清洗时,以除去表面上颗粒为目的进行碱清洗,GaN单晶晶片在这种情况下,n面被碱液蚀刻,引起表面粗糙,因此避免使用。但是,传统的清洗方法不能使用碱清洗,因此不能说颗粒去除能力充分,存在难以得到清洁的GaN单晶晶片表面的问题。在GaN单晶晶片中,GaN单晶晶片的Ga表面的颗粒被去除,但是N表面的粗糙度很大,并且不能使用碱清洁。本发明提供了一种GaN单晶晶片的清洁方法,该GaN单晶晶片具有足够的颗粒去除能力,并规定了碱性化学品的种类、浓度和清洁条件,以防止表面粗糙化,本发明还提供了一种GaN单晶晶片的制造方法。
在用于清洁GaN单晶晶片的方法中,在用有机碱基清洁液清洁GaN单晶晶片的表面之后,用有机溶剂清洁GaN单晶晶片的表面,用于清洁GaN单晶晶片的方法使用有机胺作为有机碱基清洁液。根据本发明,可以提供对GaN单晶晶片获得充分的粒子除去能力,且规定了不引起表面粗糙的碱性药液的种类、浓度和清洗条件的GaN单晶晶片的清洗方法以及GaN单晶晶片的制造方法。
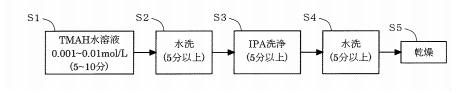
图1清洗过程的过程图
如图1所示,本实施方式GaN单晶晶片的清洗方法是GaN单线.这是用有机碱类清洗液清洗晶圆表面后,用有机溶剂清洗的方法。更具体地说,包括:利用有机碱性清洗液清洗GaN单晶晶片镜面的工序S1,利用超纯水除去有机碱性清洗液的工序S2,进一步利用高纯度有机溶剂完全除去残留的有机碱性清洗液的工序S3,再次利用超纯水除去高纯度有机溶剂的工序S4,最后作为工序S1中使用的有机碱系洗涤液.
使用有机胺,即TMAH(四甲基氢氧化铵),是因为碱性液体如KOH(氢氧化钾)和NaOH(氢氧化钠)含有金属组分,并且金属组分可能通过洗涤污染GaN单晶晶片的表面。 然而,由于TMAH含有有机组分,因此GaN单晶晶片的表面类似地被污染。作为对策,该方法包括用高纯度有机溶剂洗涤的步骤S3。在步骤S3中使用的有机溶剂是异丙醇(IPA)。在每个过程中,优选在过程S1中进行5-10分钟的洗涤,并且在过程S2至S4中进行5分钟或更长的洗涤。因此,可以充分清洁GaN单晶晶片的表面,并且可以完全去除残留的有机碱基清洁液。
通过以这种方式洗涤GaN单晶晶片,在用有机碱基洗涤液洗涤之后,仅通过用水洗涤,有机碱基洗涤液残留在GaN单晶晶片的表面上,但是通过用高纯度有机溶剂洗涤,残留的有机碱基洗涤液被溶解,并且残留在G aN单晶晶片表面上的有机碱基洗涤液被完全去除,并且可以获得高质量的GaN单晶晶片。在这种情况下,可以获得GaN单晶晶片的足够的颗粒去除能力,并且可以调节碱性化学品(TMAH)的浓度和清洁条件,以防止表面粗糙化。
将直径约为3μm的SiO2颗粒粘附到GaN单晶晶片上,并通过图1中所述的工艺进行清洗。 此时,在TMAH浓度为0.001、0.01、0.1和1mol/L的四个条件下,依次进行TMAH洗涤5分钟、超纯水洗涤5分钟、IPA洗涤5分钟和最后的洗涤5分钟,然后干燥。当通过表面检查装置Candela确认清洁后GaN单晶晶片的Ga表面的SiO2颗粒的去除率(=(清洁后晶片上的杂质数-粘附前晶片上的杂质数)/(粘附后晶片上的杂质数-粘附前晶片上的杂质数))时,如图2所示,在所有浓度下获得接近10%的去除率。
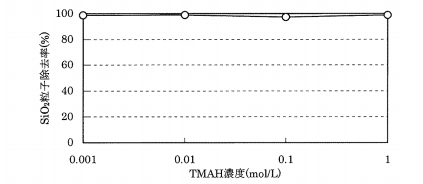
图2 TMAH浓度对SiO2除去率的影响
当测量以相同方式获得的清洁后GaN单晶晶片的N面的表面粗糙度(Ra)时,如图3所示,在0.001和0.01 mol/L的浓度下,表面粗糙度(Ra)突然变高,并且确认表面粗糙度,而在0.1 mol/L的浓度下,表面粗糙度(Ra)不引起表面粗糙度。此外,当通过将TMAH固定在0.01 mol/L并改变洗涤时间来确认表面粗糙度(Ra)和SiO2颗粒的去除率时,如图4所示,尽管SiO2颗粒的去除率没有问题,但表面粗糙度(Ra)在洗涤时间12分钟后急剧增加。因此,可以使用浓度为0.001 mol/L或更高且小于0.01 mol/L的TMAH,并且可以将TMAH的洗涤时间设定为小于12分钟。
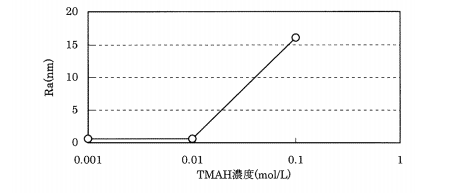
图3 TMAH浓度对表面粗糙度的影响
因此,根据GaN单晶晶片的清洁方法,由于使用有机碱性基清洁液进行清洁,可以获得GaN单晶晶片的足够的颗粒去除能力,并且由于规定了不引起表面粗糙化的碱性化学品的种类、浓度和清洁条件,因此可以防止清洁后的表面粗糙化。此外,通过在制造GaN单晶晶片时包括根据本发明的清洁步骤,可以制造被充分清洁并且没有表面粗糙度的GaN单晶晶片。