
扫码添加微信,获取更多半导体相关资料
引言
随着器件的高集成化,对高质量硅晶片的期望。高质量晶片是指晶体质量、加工质量以及表面质量优异的晶片。此外,芯片尺寸的扩大、制造成本的增加等问题受到重视,近年来,对300mm晶片的实用化进行了研究。随着半导体器件的高集成化,硅晶圆表面的高清洁度化成为极其重要的课题。在本文中,关于硅晶圆表面的金属及粒子的附着行为,对电化学的、胶体化学的解析结果进行解说,并对近年来提出的清洗方法进行介绍。
现在的半导体(晶圆及器件)的制造工序,遇到金属杂质的机会非常多,特别是利用等离子和离子的装置,光刻胶,溅射靶等材料,存在高浓度的金属污染。虽然抑制这些金属产生的开发也在进行中,但是为了有效地除去金属杂质的技术开发也在被期待。另外,还存在着除去的金属从洗涤液中再次附着在硅表面,从药品等混入的金属附着在硅表面的问题。因此,为了在溶液中除去这些金属或者抑制附着,首先需要把握洗涤液中的金属的行为。清洗液中金属的附着大致可分为2种机理,一个是以碱性溶液中的金属附着为代表的化学吸附引起的,另一个是酸性溶液中的电化学附着。
碱性溶液中金属的附着机理:
首先,对碱性溶液中金属的附着机理进行论述。氨·过氧化氢混合水溶液,由于具有优良的颗粒去除能力,被广泛使用。但是,众所周知,如果溶液中存在微量的金属,其金属就会附着在晶圆表面。如图2所示,APM溶液中即使存在1μmol/l左右的微小浓度的金属,在硅晶片表面也会附着1013 atoms/cm2左右。这些金属的附着倾向使用杂质金属的氧化物的生成焓或者通过络合离子模型进行了说明。通常,一般使用的APM洗液的pH范围为9~11左右。在这个范围内,如图3(a)所示,Fe以吸附种中性氢氧化物络合物的溶解种Fe(OH)3为主要存在种,因此即使液中浓度低,吸附量也多。另外,即使液体中的浓度变高,氢氧化物络合物的总浓度也不会达到固体物质的生成开始浓度,因此也不会出现Fe的情况那样的吸附量的饱和。这样,在碱溶液中的金属的附着根据溶解的金属的形态有很大的不同,容易形成氢氧化物的金属容易附着。
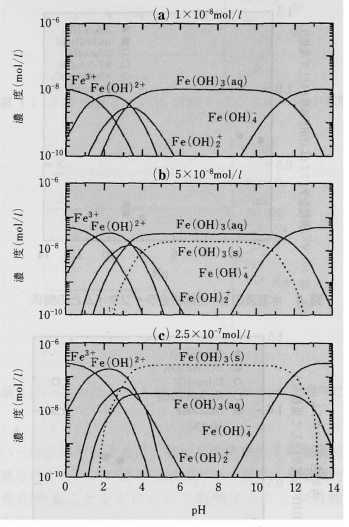
图3 Fe在水溶液中的pH值和溶解离子种类的关系(计算值)
金属在酸性溶液中的粘附机理:
虽然酸性溶液系统的清洗液具有优良的金属去除特性,但在稀氢氟酸等溶液中,Cu、Au的附着问题也是一个问题。这种附着的机理一般是用电离倾向来说明的,但考虑到传导型、电阻率、阴离子等的影响等,单纯的电离倾向是很难解释的。因此,介绍一下金属在酸性溶液中的附着行为的电化学分析结果。
首先,对溶液中的pH值和金属附着量的关系进行阐述。在这种情况下,金属附着量的评价是根据μ―PCD法的复合寿命测定进行。再结合寿命的值越高,金属的附着就越少,如果值低,就会发生金属的附着。其次,对溶液中的硅的能带结构进行了调查。一般来说,将物质浸入溶液中后,表面会形成电化学双层(图6)。该双层内有特异吸附离子和吸附分子,从最外层到溶液侧存在水合离子和配位水分子等。将硅浸入清洗液中,情况也是一样的,因为硅是半导体,所以在表面附近的体侧形成了空间电荷层。
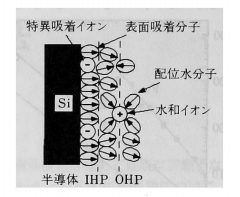
图6 电化学2层概略图
因此,为了防止Cu的附着,需要将硅的Fermi level作为阳极侧的氧化剂。如上所述,如果明确掌握水溶液中硅的带结构,则由于n型硅片容易附着Cu的传导型的差异、基板的电阻率的不同,金属附着量也不同,可以对通过添加阴离子使金属附着量发生变化等情况进行说明。
关于新清洗方法
臭氧清洗:臭氧是仅次于F的强氧化剂。关于有机物的除去,以前是用硫酸和过氧化氢的混合液,碱性水溶液(APM)等,分解并除去有机物等。另外,关于金属除去,使用过氧化氢和硝酸等进行金属除去。作为新的方法,提出了使用臭氧的洗涤。将臭氧的氧化力与以前使用的洗涤液的氧化力进行比较,如表1所示。这样,臭氧具有相当强的氧化力,通过这种氧化力,有机物和金属被氧化除去。金属除去,使洗涤液的氧化还原电位向阳极侧移动,提高了洗涤效率。
去离子水洗涤:有提出电解水溶液,使用阳极侧的电解水和阴极侧的电解水进行清洗的方法。在阳极侧可以看到氧化性物质的生成和pH的降低。另一方面,在阴极侧可以看到还原性物质的生成和pH的提高。利用这些特性,将其作为清洗液应用。由于阳极电解水可以生成氧化性物质,因此具有很强的氧化力,这与前面所述的臭氧洗涤具有相同的效果。
界面活性添加剂洗涤:该方法的目的是使界面活性剂附着在硅晶圆表面和粒子的表面上,使表面状态发生变化,从而提高除去粒子以及抑制附着的能力。具体来说,通过添加界面活性剂,可以改变硅和粒子的zeta电位,抑制粒子的附着。这样,通过使硅晶圆表面的特性发生变化,可以得到清洗特性优良的清洗液。
加入螯合物洗涤:在氨·过氧化氢洗涤液中,中性氢氧化物、固体氢氧化物、铵络合物等基于离子平衡存在,中性氢氧化物吸附在晶片表面。为了抑制这种中性氧化物等金属的附着,提出了添加螯合剂的方案。该试剂具有将存在于溶液等中的金属等以夹持的形式引入并将其改变为稳定形式的效果。也就是说,通过氨过氧化氢洗涤液等,可以使存在于溶液中的金属优先与螯合剂反应,以防止其附着在硅晶片表面上。
总结
关于金属以及粒子的附着结构,已经进行了阐述。这些附着行为分析,随着停留的装置的高集成化,被认为对所需要的高清洁度化的技术开发是有效的。通过RCA清洗,现在的半导体产业得到了支撑。但是,由于300mm晶圆的出现,为了提高晶圆表面的清洁度,清洗方法正在发生变化。为了产生这种变革,有必要在原子水平上分析并控制硅晶片表面发生的反应。由此,发现了飞跃性的清洗技术,半导体产业的进一步发展成为可能。