
扫码添加微信,获取更多半导体相关资料
引言
本文研究了简单的化学清洗技术,易于在制造环境中使用,并使氮化镓表面无损伤。 描述了使用同步加速器辐射~SR,研究氮化镓的电子结构,经过湿式化学清洗序列后再加热的表面,通过使用在200-1000eV范围内的SR,我们监测了Ga、N、O和C的核心水平,表明在硫酸/过氧化氢处理后,一种弱结合的碳氧化物被化学吸附到氮化镓表面,并通过加热去除。
实验
利用同步辐射对电子结构的近表面探测,来确定一个简单而有效的清洁处方,以去除氮化镓表面的碳和氧,利用光子能量范围为200~1000eV的单色同步加速器辐射进行光电发射电子能谱分析。用半球形能量分析仪对发射的光电子进行分析,其能量分辨率约为0.2eV。所有已知感兴趣的元素的核心水平强度~Ga、N、C和O!在探测氮化镓表面的最后几个单分子层时进行了测量。这种表面灵敏度是所使用的光子能量的短逃逸深度的直接结果,我们估计为一个或两个晶格单元单元。
研究了清洗过程的化学性质、退火环境和退火过程的温度。纤锌岩氮化镓~0001,薄膜为p型~Mg掺杂53 1017 cm2 3 -1 3 1018 cm2 3,0.1mm厚,分子束外延生长在c轴蓝宝石基底上的AlN缓冲层上。通过优化III-V清洗中传统的硫酸化学方法,发现了清洗化学性质。湿化学处理为4:1硫酸~51%,到过氧化氢的~值为30%,氨纯度为99.99%的无水金属氧化物半导体加工级气体。最后,考虑了热退火的温度,以找到一个良好的温度窗口,估计为900°C。
结果与讨论
使用4:1的硫酸到过氧化氢溶液中去除碳和氧:两个氮化镓样品用4:1的硫酸到过氧化氢溶液清洗10分钟,一个样品在真空~中退火,底部有两行,另一个在氨~前两排,在590、636、700和740°C的温度下,持续10min。经过化学处理后的碳、氧覆盖率约为1.0 6 0.5 单层~。根据测量的碳1s和氧1s的光发射强度与镓3d的比例,计算出覆盖率。氧覆盖率低于单层表明,与普拉布卡兰相比,氮化镓没有整体氧化。认为这种整体氧化物的缺乏生长限制了半导体行业中用于清洁氮化镓表面的典型酸和碱的有效性,这是因为为了打破氮化镓键来释放镓原子来生长整体氧化物。Ga到N键的键能为8.9eV/原子,8使得氮化镓在湿化学处理中难以氧化或蚀刻。
经过4:1硫酸到过氧化氢处理,然后700°C真空退火,似乎有一种较弱的碳形式结合在氮化镓表面,在我们的光电实验~1%的单层,在本实验中,氨的退火并不比一个简单的真空退火去除碳更有效。条件下,氧气被还原到单层的8%。在氨通量下,氧覆盖在退火过程中波动,并保持高达单层的40%。这可能是氨作为回收氧气的载体气的结果。
碳化学状态
4:1的硫酸到过氧化氢溶液具有丰富的c1s结构,表明碳有几种不同的化学状态。在我们的尺度上,碳的氧化物在化学上向更高的结合能~较低的动能移动,关于碳氢化合物的特征。此外,各种成分的化学分配可以通过报告的温度编程解吸~TPD来验证,因为我们有互补的退火研究。安巴赫10的峰值解吸温度从375°C到800°C6 100°,具有显著的CHx分压。因此,在氮化镓表面的趋势似乎是碳的氧化物比碳氢化合物更易挥发。
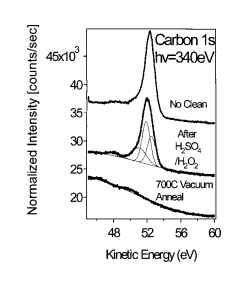
图1
在图中1空气暴露碳特征主要是碳氢化合物种类,4:1硫酸到过氧化氢清洁~中间曲线,在我们的动能尺度上,碳信号被四个以48.1、50.9、51.9和52.5eV为中心的四个单独的高斯分量拟合。碳酸盐的最低动能峰为碳酸盐种,50.9eV峰为二氧化碳特征,5 1.9eV为一氧化碳,52.5eV峰为碳氢峰(CHx其中x5 1,2,3,经过700°C退火后,C1s信号降低到接近背景~底曲线,在真空中进行700°C退火后的碳覆盖率估计在单层的1%以内。c1s信号的减少是hy转换的结果。
将碳变成4:1硫酸到过氧化氢溶液中的碳氧化物,这一假设的直接证据如图所示1,其中,碳氧化物的拟合强度占化学清洁后表面开始碳含量的70%。碳氧化物的波动性使我们能够降低碳表面的碳浓度。这种在单层覆盖水平上的替代化学反应使我们可以用4:1的硫酸清洁成过氧化氢,即使不能生长出大量的氧化物来获取碳。我们的结论是,4:1的硫酸到过氧化氢溶液,然后是700的°C退火,可以有效地清洗氮化镓表面,留下几个百分之一的单层C和O。

图2
在图中进行化学清洗后,与大块氮化镓峰相比,Ga3d峰向较低的动力学移动了0.8eV,这是由于镓的氧化物。在图中2 ,一个较低的动力学特征也会发展,并可能表明氧在氮气位点上的化学吸附,经过700°C退火~底曲线!Ga3d和N1s曲线下的面积显示了一个化学计量学的氮化镓表面,其中晶体在外单元格中的强度有接近1:1的Ga与N的比。
综上所述,利用同步辐射进行光发射电子能谱分析,研究了优化硫酸处理后的湿式化学清洗氮化镓的有效性。在700°C真空退火时,4:1的硫酸到过氧化氢溶液可以将碳和氧浓度降低到单层的百分之一。建议的化学状态主要是浸泡在这种积极的清洁化学中后的挥发性碳氧化物。最后,退火研究表明,在740°C或以下的温度下,碳和氧的热解吸比氨环境比真空环境更差。因此,在700°C下的简单真空退火足以在4:1的硫酸到过氧化氢处理后清洗氮化镓。