
扫码添加微信,获取更多半导体相关资料
引言
随着半导体工业的发展,多层处理变得越来越复杂,清洗溶液和蚀刻化学物质在提高收率和减少缺陷方面的作用变得越来越重要。本文证明了具有铜和钨相容性的成功配方,并具有层间介电(ILD)清洗和选择性钛刻蚀的性能。
本文研究了电化学沉积的铜薄膜在含氢氟酸(HF)的脱脂清洗溶液中的腐蚀行为。清洁溶液中过氧化氢的存在导致了对铜溶解速率的抑制超过一个数量级。我们将这种现象归因于在DHF中溶解速度较慢的界面氧化铜的形成。本文提出了一种涉及氧阴极还原和Cu0和Cu+1阳极氧化的动力学方案。我们利用铜腐蚀研究的经验,开发了一种湿蚀刻/清洁配方。钛硬掩模的引入用于铜互连的双屏蔽图案,这在选择性湿蚀刻化学中创造了一个独特的应用。
含有机HF清洗液中铜薄膜的腐蚀行为
在当今先进的互连系统中,铜是超大规模集成(ULSI)金属化的选择。铜线现在用于所有互连层,高达12个金属化水平。互连是由金属线制成的电气路径或载流子,由绝缘层间介质材料分隔。用铜取代铝合金要求集成、金属化和图案化工艺技术发生显著变化。例如,在半导体器件中铜的引入已经引起了人们对薄膜腐蚀现象的关注,以避免最佳的器件性能、可靠性和寿命。一个简单的两层DD互连系统如图3.1所示。在这样的系统中,允许晶体管相互通信以及与外部世界通信的电信号通过任何给定的金属化水平内的金属线传输,并通过充满铜的通道从一个金属化水平传输到另一个金属化水平。在DD系统中,通电电阻主要取决于铜扩散屏障的通电直径和厚度、所使用的电阻率以及与底层金属层的整体界面电阻。在图案形成过程中,等离子体蚀刻产生的蚀刻残留物可能通过电阻产生高强度,甚至产生开口。

图3.1 一个简单的两层DD互连系统(非扩展)
先进铜互连和选择性湿蚀概念
本章重点仅限于一种新颖的配方,它的设计是为了选择性地剥离图案钛薄膜,而不影响关键互连/晶体管材料。在集成铜互图案的先进逻辑过程技术中加入金属硬掩模(MHM)的许多优点之一是通过耀斑进行控制。由于低钾ILD材料的机械强度较弱,以及在蚀刻过程中对火炬顶部的变形,工业的迁移造成了相当大的困难,如图4.1所示。通过蚀刻轮廓通过对待沉积金属铜扩散屏障的连续性和共形的影响来影响可靠性。此外,MHM允许一个关于蚀刻速率控制的宽工艺窗口,允许蚀刻高方面的定量结构,保护ILD材料免受等离子体蚀刻过程引起的损伤,并在通过和沟槽图案步骤中作为ILD和光刻胶之间的界面。当使用聚合物ILD时,这是至关重要的,因为光刻胶和聚合物ILD之间的干性蚀刻选择性很难达到。蚀刻策略依赖于在沟蚀刻过程中消耗最多的光刻剂,如果不是所有的光刻剂。在这种情况下,当光刻胶被消耗时,硬掩模的存在阻止了通过和沟槽蚀刻化学物质攻击晶片的掩蔽区域中的聚合物ILD。本文还提出了一种双硬掩模方法和三重硬掩模集成方法,用于聚合物和混合ILDs中的DD结构模式化。
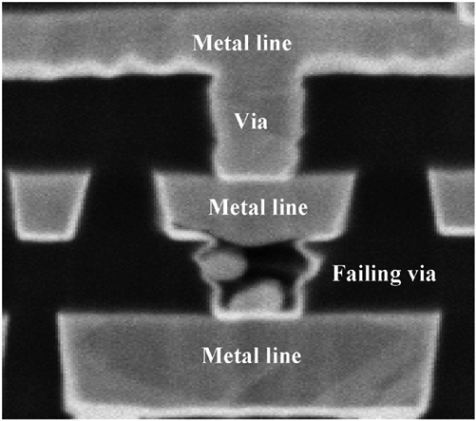
图4.1 一个电失效的通过的扫描电镜显微图
为了充分实现上述使用硬掩模的优点,必须使用金属硬掩模。传统的无机硬掩模(例如,二氧化硅,碳化硅…)由于在介电蚀刻过程中产生的低选择性,在50纳米以下没有足够的先进互连系统。新金属材料,如Ti、氮化钛、TaN等…,具有不同于介质材料的化学性质,允许比传统无机硬掩模更好的硬掩模能力。
选择性钛湿式蚀刻/清洁化学配方的开发
本章节详细讨论了一种强大的钛选择性湿蚀刻化学配方的发展。该配方是基于HF的化学溶液,具有独特的选择性行为,并符合互连制造要求,其中首次集成了金属硬掩模,制造高性能互连系统,使先进ULSI的可靠制造工艺成为可能。蚀刻钛硬掩模而不影响关键互连结构的能力已经被成功地证明。湿蚀刻配方是为了解决选择性地剥离薄的图案化钛层和去除干蚀刻后对铜、氧化硅、玻璃硅酸盐、碳掺杂氧化物和多孔ILD薄膜相容性优越的残留物/聚合物的问题。
该配方最显著的特点是,它含有氢氟酸作为其成分之一。然而,它与氧化硅和掺杂的氧化硅电介质材料表现出特殊的相容性,其中达到了零蚀刻率。必须强调这一独特的特性,因为已知含有湿式蚀刻化学物质的高频对硅氧化物具有极大的侵略性。
结论
随着半导体工业的多层处理变得越来越复杂,清洗溶液和蚀刻化学物质在提高收率和减少缺陷方面的作用变得越来越重要。本文证明了铜和钨相容性,具有ILD清洗和选择性钛蚀刻。
在反应器中大规模合成湿式蚀刻/清洁配方的总结结果表明,所开发的配方符合前面描述的必要的成功标准,即创建了无颗粒、聚合物或油性残留物的均匀溶液混合物。此外,实现了各种衬底的蚀刻速率目标,并在图案晶片上得到了确认。
在铜腐蚀工作中,在含有机的HF清洗溶液中进行的电位动力学极化实验显示了主动、主动被动、被动和跨被动区域。使用有机缓蚀剂和可能使用过氧化氢是降低清洗溶液中腐蚀速率和铜浓度的有效方法。过氧化氢添加到清洁溶液中似乎非常有益,可以创建一个抵抗高频攻击的氧化铜薄膜。