
扫码添加微信,获取更多半导体相关资料
随着半导体技术的发展,为了在有限的面积内形成很多器件,技术正在向多层结构发展,要想形成多层结构,将形成比现有的更多的薄膜层,这时晶片背面也会堆积膜。如果在背面有膜的情况下进行batch方式的润湿工序,背面的膜会脱落,污染晶片正面。特别是Cu如果受到全面污染,就会成为严重的问题。 目前,在枯叶式设备中,冷却晶片背面膜的方法是翻转,翻转晶片进行蚀刻工艺的话,蚀刻均匀度最好在1%以下,但是,如果一面进行工程,工程时间将增加一倍,为了减少工序时间,对在进行顶面工序的同时进行背面工序的方法进行了评价。
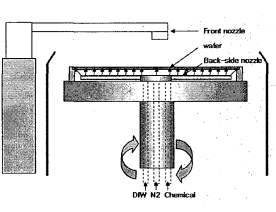
图1
图1是一种300毫米枯叶式装置的模拟图,包括可以蚀刻晶片背面的喷嘴,晶片背面与喷嘴的距离约为1.5厘米,晶片固定为6艘,工艺进行,主轴头最多可旋转2000RPM,使用的晶片是 300毫米。

图2
图2是为晶片背面蚀刻制作的喷嘴,喷嘴由药液喷射部分和DIW喷射部分各组成,药液喷射孔直径为0.7毫米,孔与孔之间的间距设计各不相同,孔的间距是根据300毫米晶片的面积设计的,实验中使用的晶片是SiaN4在硅晶片上沉积约2000A,用于蚀刻的 药液使用HF 49%,为了提高蚀刻效果,药液的温度上升到60℃, 药液的流量为1L/min,进行了蚀刻评价,工艺中DIW为1L/min。 在蚀刻工艺中,为了提高均匀度,在晶片中央部分喷射氮气,氮气气体喷射3~30LPM,在最后阶段的干燥过程中也喷射氮气,希望缩短干燥过程时间。
蚀刻工艺时间为30秒和60秒工艺,用30秒的工艺冷却,观察形态,修改喷嘴的形状,最终评价用60秒的工艺冷却,查看了蚀刻量和均匀度,SiaN4膜的蚀刻量约为每分钟1000安以上,实验前后的结果测量是K- 用MAC公司的ST-6000测量了SiaN4膜的厚度,在晶片直径方向上从3毫米内到5毫米间测量了60点,了解了厚度的分布情况。
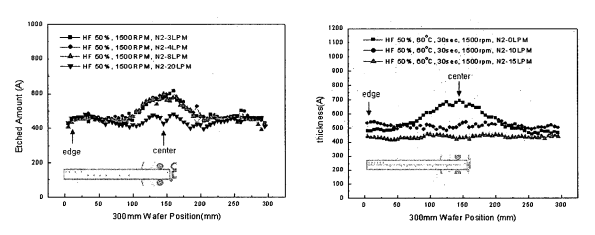
图3
实验首先制作了双面蚀刻用喷嘴,调整药液喷射喷嘴的间距和氮气气体喷射量后进行图3,银喷嘴中间喷射的氮气体喷射量不同的SiaN4膜的蚀刻量和膜厚分布。图3(a)是有11个药液喷射孔的喷嘴,冷却30秒的结果。蚀刻结果表明,在没有药液喷射孔的位置上,蚀刻不良,根据氮气体量,中间部分的蚀刻量存在差异,氮气气体喷射量为20LPM时,食角量的偏差为85 a,平均食角量为443A,均匀度为9.6%。图3(b)是有13个药液喷射孔的诺兹罗,冷却30秒的结果,随着氮气体喷射量的变化,中间部分的食角量发生了变化,在食角量较小的部分添加了药液喷射孔,增加了中间部分的食角量,氮气体分射量为15LPM时,食死量偏差为42A,平均食死量为436A,均匀度为4.8%。
图4是通过改变喷嘴中喷射药液的孔的位置进行评价的结果。图4(a)的结果是蚀刻60秒后的结果,食角量的偏差约为199A,平均食角量约为1052A, 均匀度约为9.5%,喷嘴中央喷射了30LPM氮气,但口感不均匀。图4(b)的结果是,(a)的结果中,在食死量较小的位置添加一个药液喷射孔,从喷嘴中心喷射氮气体33LPM,从而提高食死量,平均识字量为1023A,体食角偏差为86A,均匀度为4.21%。喷嘴中药液喷射孔的位置与蚀刻均匀度密切相关,位置调节可提高均匀度。
本研究确定药液的流量和流速是冷却晶片背面SiaN%膜的重要变量,另外,通过分析它们的相关性,达到了目标食角量1000A和均匀度5%,在枯叶式系统中,可以了解晶片背面的蚀刻结果和喷嘴设计中需要考虑的事项。首先,根据晶片的位置,离心力的大小不同,所以药液的喷射量必须不同。特别是300毫米晶片面积大,离心力的梯度很大。因此,不同位置与晶片接触的药液量和时间会有所不同,湿食方法根据与药液接触的时间,食角量会有所不同,所以要根据基板的面积和转速控制喷嘴喷射的药液量。第二,高温的药液比常温的药液反应性高,因此细微的茶叶中的食死量也出现了显着的差异。据认为,晶片中央喷射氮气体有两种效果:降低药液温度,减少食角量,以及将药液发送到边框,通过控制前面提到的各种变量,制作了能使晶片背面冷却的喷嘴,使SiaN的膜在60秒内冷却了1000A以上,得到了均匀度为4.21%的结果。