
扫码添加微信,获取更多半导体相关资料
本文讨论了温度对去除氮化物或氧化物层的蚀刻速率的影响,对于氧化物层,温度并不是很重要,因为氧化物在室温下可以被快速去除,这与氮化物层不同,与相同厚度的氧化物层相比,在室温下去除它需要更长的时间。具体来说,本研究比较了不同蚀刻温度下氮化物层的图案结构,在第二个实验装置中,研究了不同温度下氮化物层和氧化物层的蚀刻速率,氮化物和使用薄膜映射器F50薄膜指标检测氧化物层的厚度,最后,通过加热桶方溶液,发现了最佳的蚀刻技术,本文通过对传统BOE工艺的比较,对其加热工艺进行了讨论。
在本实验设置中,在780µm厚的单抛光晶片上切割成1英寸的方形样品,衬底在两侧预涂上199.91nm厚的LPCVD氮化硅,利用薄膜映射器F50薄膜指标测量了薄层氮化物的厚度,底物在超声浴中用丙酮和甲醇浸泡5分钟,然后用去离子(DI)水冲洗样品,然后用氮气爆破以干燥。最后,将样品放在热板上,温度设置为120ºC,持续15-20分钟进行硬烤确保硅表面没有水。
硅样品然后进行光刻过程,在基板上形成正方形框架,正光刻胶AZP4620首先使用旋转涂布器涂覆在硅衬底上,设置为500rpm10s,然后是2000rpm20s,接下来,将基底置于120ºC的热板上,放置1分钟,只有这样,样品才能准备好进行光刻工艺。利用掩模对准器KarlSussMJB3将掩模上的正方形图案转移到硅衬底上,然后将样品暴露在紫外线下90秒,然后,将基底在AZ400K显影剂中浸入4分钟,以形成正方形图案,之后,这些样品经过了15分钟的硬烘焙过程,接下来,将它们浸入缓冲氧化物蚀刻(BOE)溶液中,以去除框架开口处不需要的氮化物。
该溶液用于蚀刻二氧化硅或氮化硅的薄膜,特别是在微量加工过程中,所使用的BOE是49%氢氟酸(HF)溶液和40%氟化铵(NH4F)溶液的混合物,成分为1:6,高频溶液本身用于太快去除氧化硅蚀刻,也剥离用于光刻图案的光刻胶,氟化铵被用来减缓蚀刻速率,并避免光刻胶从基底上剥离,此外,NH4F还用于更可控的蚀刻速率,在这种溶液中,NH4F完全解离,提供了大量的铁离子来源,这些铁离子可以自由地与未解离的HF反应形成hf2离子,在氮化硅基板上形成正方形框架的制作过程如图所示1。
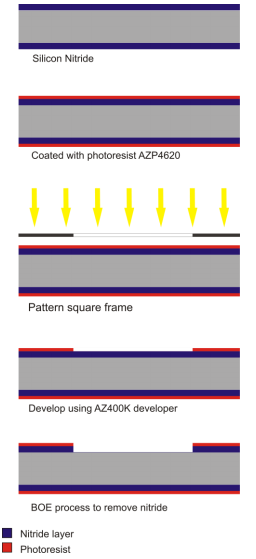
图1
本文研究了温度对去除硅基底上氮化物和氧化物层的蚀刻速率的影响,实验首先将BOE溶液倒入特氟隆烧杯中,与玻璃烧杯相比,特氟隆烧杯具有高抗性,不易被强酸腐蚀,双烧煮技术用于用热板加热BOE溶液,图2为双沸腾技术下的BOE蚀刻工艺示意图。将温度设置在40-80°C之间变化,以研究蚀刻速率,在此过程中,用特四氟隆夹具夹住样品,该过程在去除氮化物或氧化物层的时间方面具有优势,通常,BOE工艺在室温下去除200nm的氮化物层需要4小时,加热BOE将减少去除氮化物层的时间。
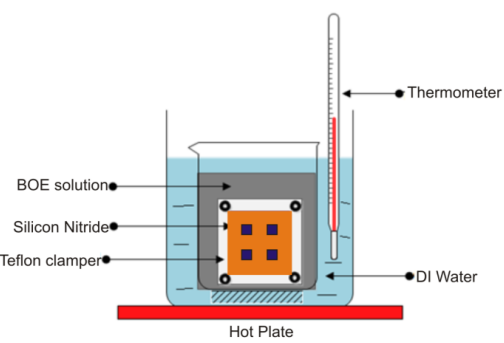
图2
本文着重研究了去除氮化物层和氧化物层的新技术,特别是在硅基板上的框架图案化方面,氮化物和氧化物层被用作掩模,以便进行下一个过程,如稀释硅衬底形成一个膜或某些MEMS应用的膜或隔膜,有一些技术可以用来快速去除氮化物,DRIE只需要2分钟来去除氮化物层,而不是4小时,本文探讨了利用BOE湿式蚀刻工艺在最短时间内去除氮化物并给出最佳图案结构的技术,将光刻胶AZP4620在氮化硅衬底上以500rpm旋转涂层10s和2500rpm旋转涂层20s,得到5µm厚的光刻胶层,样品在120°C下软烤1分钟,光刻胶AZP4620适用于湿蚀刻工艺,因为该光刻胶比AZ1500系列光刻胶形成非常薄的层。衬底在强度为2.4mW/cm2的紫外光下暴露90s,根据光刻胶层的厚度和曝光能,计算出曝光时间。然后将样品浸入Az400K显影剂和1:3体积比的去离子水中,以形成图案2-4分钟,然后,用去离子水冲洗样品,用氮气爆破干燥,然后将样品在120°C下硬烘烤15分钟。
图3显示了已经转移到硅衬板上的框架,2mmx2mm的方形框架已在基底上充分开发,并准备进行BOE湿蚀刻工艺,在框架形成图案后,可以研究温度对BOE蚀刻过程的影响。为此,首先将样品浸入室温下的BOE溶液中,如前所述,确保氮化物从样品框架表面完全去除需要4个小时,相比之下,在80°C下去除不需要的氮化物只需要10分钟,加热BOE溶液将减少去除氮化物所消耗的时间,并且制造过程在时间和框架结构方面变得更加高效。
如果BOE溶液进入光刻胶区域,则会发生过度蚀刻,较短的蚀刻时间将减少BOE溶液进入光刻胶区域的可能性,并保护框架结构的下一个湿蚀刻过程。该方法证明了BOE溶液中短浸渍时间可以保护图案结构,相反,在BOE溶液中长时间浸泡会使溶液进入光刻胶层,根据BOE溶液中不同样品浸渍时间的颜色变化,温度已设置为80°C,以加速该过程,结果表明,最初的紫色氮化物在浸泡5分钟后变为红色,然后在添加5分钟后最终变为银色,即硅色。氮化物层根据其厚度显示出不同的各种颜色。所以,图中的氮化物,将在这个过程中慢慢显示这些颜色,因为它被蚀刻在25°C。
在第二个实验装置中,研究了在不同温度下去除氮化物层和氧化物层的蚀刻速率,温度从40°C到90°C不等,首先用含有氮化物层的样品浸泡3分钟,然后用薄膜映射器F50薄膜度量法来测量氮化物层的厚度,蚀刻速率与温度成正比。换句话说,蚀刻速率随温度的升高而增加。
对于样品2,将硅预涂上6.607µm的氧化物层,并在薄膜映射器下验证其厚度,实验设置是基于上述参数进行的,根据图中氧化物蚀刻速率也与温度成正比,值得注意的是,蚀刻速率在70°C时迅速增加,与氮化物层相比,氧化物层的去除速度更快。例如,在BOE溶液中,可以在2分钟内去除200nm的氧化物层,但200nm的氮化物层需要4小时才能去除,在实验结束时,结果表明,温度提高了蚀刻速率,从而减少了去除氮化物层和氧化物层所消耗的时间。此外,通过向BOE溶液提供更高的温度,也同样提高了构建掩模的框架结构。
验证了温度对去除氮化物层和氧化物层的影响,较高的温度可以减少在蚀刻过程中所消耗的时间。此外,过度蚀刻的风险也降低了,因为时间会抑制BOE溶液进入光刻胶层,两种温度水平的比较表明,在室温下,BOE溶液需要4小时才能去除200nm的氮化物层,与此同时,80°C的温度降低到只有9-10分钟左右,结果证明,与传统技术相比,温度可以提高96%。因此,可以说,温度会在蚀刻过程的时间和框架结构上提高蚀刻过程的有效性。