
扫码添加微信,获取更多半导体相关资料
研究了含少量铜的氢氧化钾水溶液中Sill10)的蚀刻作用,结果表明,在氢氧化钾水溶液中,100ppb级的铜形成了锥形的硅山丘,使蚀刻表面粗糙。结果还表明,100ppb水平的铜降低了蚀刻速率,因为小山丘是由缓慢蚀刻的平面组成的。
为了更稳定地获得光滑的加工表面,因为蚀刻的加工表面影响微结构的强度和弹性行为。在使用KOH水溶液蚀刻{110}面硅晶片的研究中,当KOH水溶液的浓度为30-40重量%时,可以获得更光滑的加工表面,并且蚀刻表面上的微金字塔的出现次数根据硅晶片的热处理条件而不同。 另一项研究表明,反应产物和蚀刻反应产生的氢与Si各向异性蚀刻表面粗糙度的原因有关,然而,尚未获得关于ppb级杂质的影响的知识,在本研究中,我们发现ppb级的微量Cu影响蚀刻表面粗糙度和速度。
使用32重量%KOH水溶液(85%KOH试剂,关东化学制造,用纯水稀释)作为蚀刻液,对于KOH水溶液,用ICP-MS(横河PMS-200)分析液体中金属杂质的量,确认添加Cu之前液体中Cu的量,然后添加Cu并进行蚀刻实验。 将Cu添加到H水溶液中是通过使用用于原子吸收分析的金属标准溶液并将其与化学品中所含的含量相加来获得的。
蚀刻表面的粗糙度为10点平均粗糙度Rz,该10点平均粗糙度Rz是由表面粗糙度计测量的表面形状的粗糙度曲线计算的,用SEM观察蚀刻表面的形状,并用俄歇电子能谱分析蚀刻后的表面,蚀刻深度是用焦深法测量的,当蚀刻表面粗糙时,将最深位置定义为蚀刻深度, 根据蚀刻深度和蚀刻时间计算蚀刻速度。
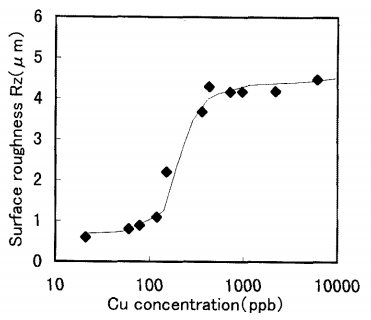
图1
蚀刻特性的Cu含量依赖性图1示出了在110℃的蚀刻液温度下蚀刻表面粗糙度相对于Cu含量的变化,当Cu含量达到10ppb左右时,表面粗糙度为1μInRz以下,但当Cu含量达到100ppb以上时,表面开始粗糙化,当Cu含量达到300ppb时,表面粗糙度为4~5μmRz左右,在A.Hein et a1的结果(5)中,表面粗糙度较小,约为本结果的1/10~50,这被认为是因为A.Heinetal使用Si{100}面,并且与Si{110}面相比,该面的蚀刻速度较小。
图2示出了在110℃的蚀刻液温度下蚀刻速率相对于Cu含量的变化,当Cu含量变为300ppb或更高时,蚀刻速率开始降低,并且已经发现,当Cu含量与蚀刻表面粗糙化的Cu含量几乎相同时,蚀刻速率降低。此外,尽管构成金属标准溶液的NO3-离子随着Cu的添加而增加,但是即使当向蚀刻溶液中添加360ppb的HNO3时,蚀刻特性也没有变化。因此,可以判断表面粗糙度和蚀刻速度的降低是由Cu引起的。
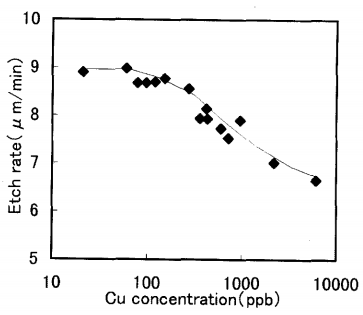
图2
观察蚀刻后的表面形态,确认与蚀刻表面粗糙度的对应关系。 Cu含有量为21ppb时,基本为光滑的蚀刻表面,然而,当Cu含量为120ppb时,可以部分地观察到微金字塔,并且当Cu含量为360 ppb时,蚀刻表面的整个表面由微金字塔组成 图中发现的白色斑点是KOH的残余物,并且确认它们不是微金字塔。
此外,微金字塔的高度约为5μm,其四个侧面呈现出一定取向的晶面,另外,通过几何求出该侧面的晶面,可以鉴定为{311}面。利用蚀刻表面的SEM照片求出的Cu含量的每单位面积的微金字塔产生数,当Cu含量为约100ppb时,微金字塔开始产生,并且当Cu含量为300ppb或更高时,微金字塔的产生数量保持不变,并且蚀刻表面粗糙度的增加与微金字塔的产生数量的增加一致。
除了110℃外,在80,100,115℃的温度下进行了调查,发现在所有温度下,蚀刻表面都是粗糙的,确认了前面所示的微金字塔的发生。此外,蚀刻表面粗糙度对Cu含量的依赖性与蚀刻液体的温度没有大的差异,在任何蚀刻温度下,当Cu含量增加时,蚀刻速度降低。
由于已知蚀刻表面的粗糙度是由微金字塔的产生引起的,因此在蚀刻表面上应该存在成为微金字塔产生的核心的物质作为其产生的原因,发现微金字塔是从蚀刻的初始阶段产生的,并且在微金字塔的表面上存在亚微米颗粒。检测元素除了Cu之外,还有污染物C和分析区域直径φ0.5μm的Si、O,因此,颗粒材料由Cu组成,并且认为Cu从蚀刻液沉积在Si表面上。
通过SEM观察,由于金字塔侧面与底面形成的角约为31度,因此可以确定金字塔侧面为{311}面,就这方面的出现进行考察。{311}面由{111}面和{100}面构成,可以认为是形成的晶面,如已知的,{111}和{100}面的蚀刻速度低,并且蚀刻的进展被抑制,因此,由于{111}面和{100}面以微观顺序出现并构成{311}面,因此抑制了蚀刻的进行,并且认为形成了具有确定晶面侧面的微金字塔。
考虑由于蚀刻液中包含Cu而导致的蚀刻表面粗糙化机理,在用碱性水溶液(7)蚀刻硅的反应中,从蚀刻表面产生氢,在这种情况下,由于碱性水溶液中的Cu含量是非常少量的ppb级,因此认为Cu作为离子存在。考虑到Cu离子与从蚀刻表面产生的氢接触的情况,Cu的氧化还原电位高于氢,因此Cu离子被氢还原,此外,由于在蚀刻表面上产生氢,所以认为Cu被还原并沉积在蚀刻表面上。
然后,确认颗粒Cu沉积在蚀刻表面上,其中蚀刻表面粗糙化,因此Cu以颗粒形式沉积在硅表面上,并用作蚀刻的掩模,然后由于{111}面、{100/面以微观顺序出现,构成{311}面,蚀刻的进行被抑制,形成具有确定晶面侧面的微金字塔。蚀刻进行到一定程度后,析出的Cu会被下切,与表面分离,然后,再次粘附到其他部分,起到掩模的作用,蚀刻面就会变得粗糙,另外,由于这个过程反复进行,Cu的影响也会出现在ppb这个顺序上。
在本研究中,阐明了当32wt%KOH水溶液中含有ppb级Cu时Si{110}面的蚀刻特性的变化,已经发现,当Cu以约100ppb或更多的量混合时,在蚀刻表面上出现微金字塔,蚀刻表面粗糙化,并且蚀刻速度降低。微吡喃的产生被认为是由于在蚀刻表面粗糙的硅表面上观察到亚微米的Cu颗粒,并且Cu的氧化还原电位高于氢,并且Cu离子被氢还原,因此Cu被蚀刻期间在蚀刻表面上产生的氢还原并沉淀,并且用作蚀刻的掩模,此外,蚀刻进程被抑制的原因被认为是由于微金字塔具有由蚀刻速度低的{111}面和{100}面形成的{311}面。