
扫码添加微信,获取更多半导体相关资料
本文研究了通过等离子体辅助分子束外延(PAMBE)和氢化物气相外延(HVPE)方法持续生长的AlN/Si(111)外延结构,通过自催化AlN纳米胶在Si(111)衬底上的过度生长,合成了PAMBEAlN缓冲层,并作为厚AlN层进一步HVPE生长的模板。此外,我们还采用铬薄膜作为表面保护涂层,并相应地增加了层厚,从而避免了表面损伤和背面过刻。
在氢氧化钾溶液中蚀刻这种结构可以导致AlN层从衬底中逐渐分离,同时,还观察到了样品表面的几次损伤,此外,还发现了AlN层背面过延伸的可能性,这项工作是研究通过氢氧化钾蚀刻从衬底中分离AlN层的一个延续,用PAMBE和HVPE法一致合成AlN/Si(111)样品(见图1)。
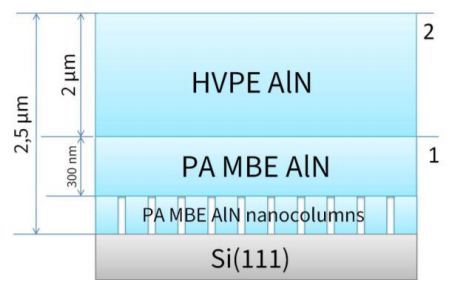
图1
首先,利用VeecoGen200MBE系统,在半绝缘(R>10000Ohm×cm)Si(111)基板上生长具有纳米柱种子层的AlN薄膜,底物的原外延制备采用改进的白石法进行,在生长前,将Si(111)衬底在T=850°C下退火30min,以去除二氧化硅层,以PAMBEAlN/Si(111)样品获得的样品作为厚AlN层HVPE生长的模板。通过扫描电子显微镜(SEM)和x射线衍射(XRD)分析对两种类型的样品进行了研究,在KOH:h2o(1:5)溶液中,使用化学蚀刻法鉴定了AlN脱毛层的晶体极性,以及AlN从Si(111)衬底中进行的分离过程。为了避免在氢氧化钾中蚀刻AlN分离过程中的表面损伤,采用BOC爱德华兹AUTO500真空涂层系统,通过电子束蒸发在样品表面形成Cr掩膜。
获得的两种类型的AlN/Si(111)结构的特征SEM图像如图2所示,如图2(a)中可以清楚地看出,AlN纳米柱合并允许形成连续的AlN外延层,通过HVPE在PAMBE合成的AlN/Si(111)模板上生长AlN,形成了2.5µm厚的连续AlN层(见图2(b))。接下来,使用DRON-8x射线衍射仪对样品进行XRD测量研究,两种所得样品的特征XRD曲线,得到的XRD曲线清楚地显示了Si(111)衬底和AlN层对应的峰。

图3
晶体极性是纤锌矿III-N材料的一个基本特征,这影响了其性质,特别是具有金属面极性的iii氮化物是最稳定的,利用40°C氢氧化钾溶液(KOH:H2O=1:5)对t=5min,利用PAMBE和HVPE方法得到了AlN层的晶体极性,我们发现,所有的样品都是铝极性的,因为在蚀刻后,AlN层的高度和表面的高度保持不变。
实验表明,与HVPE在Ga-faceGaN/Si(111)PAMBE模板上生长相比,HVPEAlN继承了PAMBE生长的AlN层的晶体极性,倾向于分离。通过氢氧化钾蚀刻从Si(111)衬底中分离AlN层的方法有两个严重的缺点:表面损伤和背面过扩张的风险。为了保护AlN脱毛层的表面免受缺陷选择性蚀刻,样品被涂上了55nm的Cr层,薄铬层确实可以避免氢氧化钾中蚀刻过程中的表面损伤。
此外,还发现Cr膜可以保持分离的AlN层,防止其破碎,Cr/AlN层分离后的轻微向上曲率可能是由于材料在生长方向上的应变梯度所致,通过HVPE生长的AlN层也通过氢氧化钾蚀刻与衬底部分分离,层厚度增加到2.5µm,确实可以避免氢氧化钾蚀刻分离AlN过程中背面过拉伸和膜破碎。
结果表明,上述方法可以获得足够光滑的AlN层,从纳米柱状结构向二维形态过渡的PAMBEAlN脱毛层的设计可以作为硅衬底上高质量III-N层异质外延的缓冲层,通过氢氧化钾蚀刻结果表明,所有获得的样品均具有铝面极性,实验表明,HVPEAlN继承了PAMBE生长的AlN层的晶体极性。此外,研究还表明,这种AlN/Si(111)外延结构的氢氧化钾刻蚀导致AlN脱毛层与Si(111)衬底部分分离。此外,利用55nmCr膜作为表面保护涂层,并相应地增加了层厚,从而避免了表面损伤和背面过刻。结果表明,在氢氧化钾中的蚀刻也可能是基于AlN/Si(111)形成悬浮结构或获得独立的III-N结构的很有前途的方法。