
扫码添加微信,获取更多半导体相关资料
本研究设计并制造了一种利用橡胶O型圈物理阻止表面蚀刻剂流入的装置(所述装置包括加热器和温度控制器),通过蚀刻保持恒定的温度,也为薄膜结构考虑了蚀刻剂的静水压力,利用所制备的器件,在六英寸的硅晶片上成功地制造了具有800米的辐射度、600纳米的厚度和具有两个波纹的3 m波纹深度的圆形波纹膜片。

图1
利用该装置制备了一种波纹膜,波纹薄膜结构如图所示1,不仅降低了膜的机械刚度,也广泛应用于MEMS麦克风中。在单侧湿式蚀刻装置的结构中,采用聚四氟乙烯设计,这是一种对氢氧化钾具有化学抵抗力的材料,O形环用于密封晶圆片的前后两侧,并且螺钉和螺纹对O形圈施加足够的压力,以确保适当的密封。
在湿式蚀刻中,蚀刻速率取决于氢氧化钾的浓度和温度,主要需要浓度为20~30wt%,温度为80~90°C,在蚀刻过程中,使用棒状筒式加热器和恒温器来加热溶液并保持恒定的温度,筒式加热器不直接接触氢氧化钾溶液,通过不锈钢制的结构来传递热量,并且在顶部使用了一个带有盖子的结构,该盖子有一个洞,被设计为允许在蚀刻过程中产生的氢气逃逸,因此,即使在很长时间的蚀刻时间后,溶液的水平也能保持不变。
在装置的下部形成一个空腔,并在刻蚀过程中充满去离子(DI)水。因此,可以进入正在进行蚀刻的晶片的另一侧与水接触。封闭腔内的水在达到准静力平衡后就像弹簧的作用。这个弹簧自动平衡在晶圆上创建的微观结构上的压力,包括静水压力。压力平衡将在下一节中详细讨论。连接到空腔的通风孔位于比晶圆表面更高的位置;因此,在加热期间增加的水量可以逸出。
如果使用30wt%氢氧化钾溶液在80~90°C下蚀刻500µm硅,该过程大约需要5小时才能完成,因此器件的所有部分在薄膜形成之前都处于热平衡状态,当达到热平衡时,腔内捕获的去离子水的体积因热膨胀而增加,并从孔中排出。未蚀刻的晶片具有较高的机械刚度,因此在蚀刻开始时无需考虑静水压力氢氧化钾,当装置和基底达到热平衡时,关闭排气孔,无论氢氧化钾的高度、浓度和温度如何,压力总是平衡的。因此,即使形成了高弹性结构(如厚度小于1微米的波纹薄膜),该过程也可以安全地进行。
最后,使用本研究提出的设备中,在不损伤晶片正面的情况下进行了氢氧化钾湿式蚀刻,氢氧化钾浓度为25-30wt%,在80°C~90°C下约5h后完成膜的制备。图4是制作的波纹膜,基于光学显微镜图像,成功地制备了波纹膜。此外,整个晶片上没有破坏膜,大部分膜是按照设计制造的。
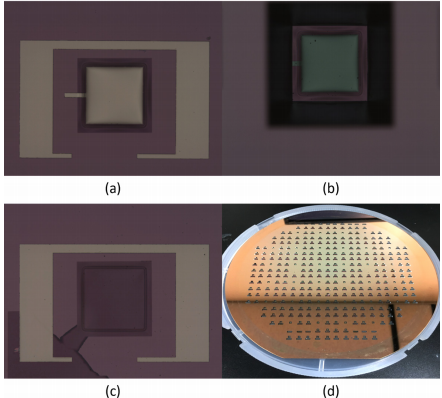
图4
在湿蚀刻中,整个正表面形成保护膜,以检查氢氧化钾溶液是否穿透基底的前表面,而在阳性PR的情况下,由于它对氢氧化钾溶液高度反应,当它与氢氧化钾接触时,PR从底物中移除,然而当使用所提出的装置时,即使在蚀刻完成后,正面的PR仍然完全保持,这证明了氢氧化钾溶液没有穿透。
作为氢氧化钾湿式蚀刻的掩膜材料,使用了500纳米的氮化硅薄膜,在蚀刻过程中保持良好,在经过长时间的湿蚀刻过程中,也在视觉上确认了颜色之间的差异,预计会进行良好程度的蚀刻。此外如图所示4(c),湿蚀刻后有一块膜没有被破坏,且它的形状不佳,这是因为相邻图案之间的氮化硅层的宽度设计约为100微米,当长时间进行湿蚀刻时,图案之间的氮化硅层不能承受和坍塌,可以假定在模式之间保持超过200微米的距离会产生稳定的结果。
由于在蚀刻过程中可以进行现场监测,因此可以确定终点,当使用氢氧化钾时,会产生氢气,因此当进行蚀刻时,形成许多气泡,溶液出现混浊,当蚀刻完成后,溶液就会变得透明,因为不会产生氢气,这也标志着这个过程的结束。最后通过湿式蚀刻装置,建议的装置基于聚四氟乙烯的O形密封装置和温度维护金属结构组成,并且还包括一个用于现场监测的盖子结构和一个压力排气孔。与现有的设备不同,它可以调整温度,此外也使晶片中精细的MEMS结构不受蚀刻剂的静水压力的影响。