
扫码添加微信,获取更多半导体相关资料
引言
硅水清洗是集成电路制造过程中最常用的处理步骤。这一过总旨在去除几种不同类型的污染物,其中包括颗粒、金属和有机物。然而,据估计,集成电路制造中超过50%的产量损失是由清洗后残留在硅晶片表面上的污染物造成的。本文的目的是记录在硅晶片表面上使用改进的超高纯度化学物质的效果,该效果通过全反射x射线荧光测量,TXRF。在这项研究中。用标准等级的化学物质和超高纯度的化学物质清洗硅样品,然后用TXRF测量金属杂质。发现超高纯度化学物质的使用大大减少了清洗后存在于棉卷表面的表面污染物的量。
介绍
自20世纪50年代以来,硅片清洗一直是半导体器件制造中不可或缺的一部分,事实上,它是集成电路制造过程中最常用的加工步骤。晶片清洗的目的是在不降低其结构的情况下从硅表面去除污染物。不能低估充分清洁的重要性,因为已知残留在衬底表面上的污染物会降低器件性能、可靠性和产量。据估计,集成电路制造中超过50%的产量损失是由微分层造成的晶片清洗将继续是器件制造中的重要工艺步骤,尤其是当器件几何尺寸接近亚半微米尺寸时。
残留在半导体表面上的污染物会在随后的加工过程中造成各种不利影响,这取决于杂质的性质。颗粒会造成各种加工操作的阻塞或掩蔽,例如在蚀刻或光刻过程中。薄膜生长或沉积过程中出现的颗粒会导致针孔和微孔,如果颗粒足够大且具有导电性,则会导致导线之间发生射击。在器件加工的几乎任何步骤中,金属杂质也会污染sil- icon晶片表面。这种污染将导致p-n结处电流泄漏的增加、氧化物击穿电压的降低以及少数载流子寿命的恶化。许多金属能够在接近硅带隙(1.12电子伏)的中间位置引入局域能态,从而产生降低少数载流子寿命的高效生成复合中心。这些中心也被称为陷阱。例如,通过在硅价带边以上0.40和0.55电子伏处引入体陷阱,铁可能导致漏电流,从而阻止动态随机存取存储器(DRAM)设备满足刷新规范。
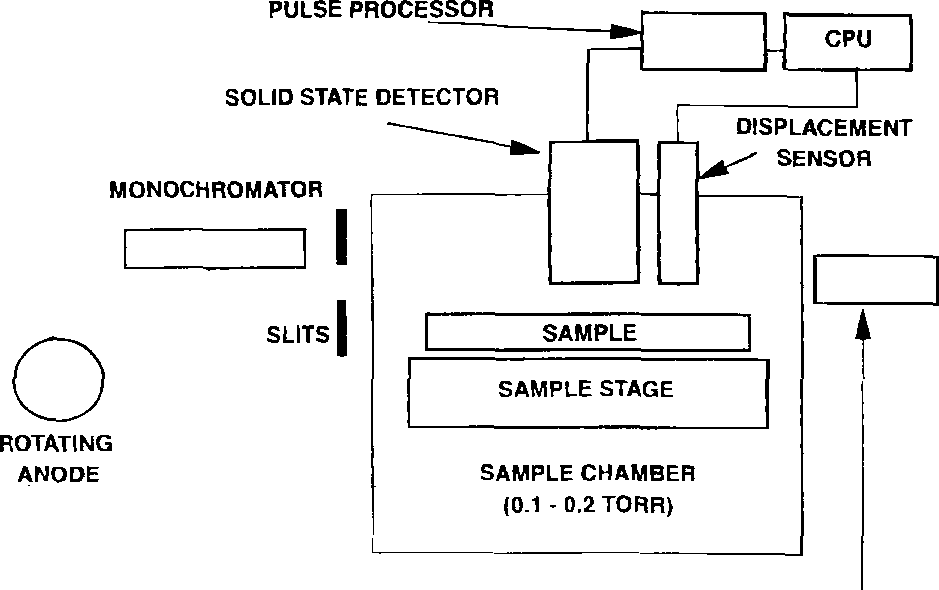
图 1 TRXRF单元的配置
图1”描述了典型TXRF装置的仪器配置。在整个研究过程中使用了飞利浦X射线分析公司的TE CHNOS TREX 610装置,该装置位于德克萨斯州谢尔曼的德州仪器的硅产品部门。TREX 610采用带有钨靶的旋转阳极。单色仪选择W-Lβ线作为激发过渡金属的有效能量源。氟化锂晶体单色仪与消除过度散射的狭缝一起减少了背景信号,从而提高了检测限。样品台根据全反射位置进行调整。样品室被涡轮分子泵压至0.1-0.2托的基础压力,以防止大气污染和x射线散射。”
图2显示了典型的TXRF频谱。荧光强度(ⅰ)以每秒计数(cps)为单位,相对于0至10千电子伏的荧光能量绘制。出现在1.74电子伏的大峰值来自硅衬底,而另一个出现在9.67电子伏的大峰值的来源是二硼化钨x射线。
将化学源从标准等级的NH、OH和HCO转换为超高纯度的NH、OH和HCO。这种转变是由于SPD努力将硅片上的铜、镍、铁和锌含量降低到5×10”原子/厘米以下。向超高纯度氢的转变;O_,在第34天产生,在第63天转变为超高纯度NH OH。
实验
学习期间;化学品(氢、氧;和新罕布什尔州),由达拉斯的化学运行部供应给谢尔曼的硅产品部。最初,这些材料是标准等级的,但后来改为超高纯度。表一列出了研究期间跟踪的四种金属(锌、铜、镍和铁)的规格(杂质的最高可接受容差)。可以看出,改用纯度更高的化学品导致容差更紧,为S0-100倍。
化学运行部的电感耦合等离子体质谱(ICP-MS)和石墨炉原子吸收光谱(GFAAS)装置监控供应给SPD的化学品中的金属杂质水平。金属水平检查符合上述规格。A F-PQS模型电感耦合等离子体质谱法用于铜、镍和锌的分析。“氢氧”的样品制备包括用去离子水以1:1稀释,同时先用蒸汽或加热浴将氢氧化铵蒸发至接近干燥(约为其原始体积的10 %)。这两种化学物质都是通过氩气载气引入系统的,国家标准和技术研究所(NIST)全程使用可追溯标准进行校准。
用瓦里安SpectAA 300/ 400系列石墨炉原子吸收光谱仪测量铁含量,该仪器配有塞曼背景校正和热解涂层石墨管。样品直接注入并在2600℃雾化。使用NIST可追踪铁标准进行校准。
整个研究中使用的硅样品是直拉法生长的p型(掺硼)150毫米二氧化硅晶片,电阻率为8-10平方厘米。沃特斯紧随其后
SPD中使用的常规工艺流程,包括机械抛光和清洗。水域看到的最后过程包括通过两条可能的清理路线之一。
所有晶片首先通过包含SC-1清洁剂(l:4:20 NH,OH:HCO,HCO)的80℃清洗线10分钟,然后用6分钟的室温去离子水冲洗。然后将一些晶片通过附加的60℃,10分钟的SC-1溶液(1:3:50 NH,OH:H2O),接着是1-2分钟的室温HF漂洗,另一个60℃,10分钟的SC-1 (1:3:50 NH,OH:H,。o;:HCO)清洗,并用去离子水冲洗。SC-1的目的是去除颗粒,HF漂洗的目的是去除残留的工艺化学品。在这两种情况下,晶圆片暴露的最后一种化学处理包括不同浓度的HCO和羟基。
然后通过全反射x射线荧光(TXRF)分析晶片。使用掠射角为0.13”的TECHNOS TREX 610装置检测表面金属。提供200毫安的电流和30千伏的电压。在每个水面上的三个点进行分析,称为边缘(距离水边缘1厘米)、中心(偏离中心0.2毫米)和半半径(中心和边缘之间距离的一半)。另外。以类似的方式分析了来自同一批次的三种不同的水,总共九个数据点。由TXRF测量的这九个点的值是四种金属(铁)的金属污染水平的平均值,单位为10“原子/厘米”。锌、镍和铜。
结果和讨论
表1中列出的规格是指标准和超高纯度等级化学品中杂质的最高可接受水平。实际上,杂质水平通常要低得多。表二和表三给出了标准和超高纯度HCO以及标准和超高纯度NH OH中实际金属含量的平均值。平均值基于20至30个样品,每个样品取自不同的生产批次,通过电感耦合等离子体质谱法或石墨炉原子吸收光谱法测量。锌和铜的降幅最大:
应该注意的是,在许多情况下,特别是对于铜和镍,实际值低于仪器检测极限。在这些情况下,检测极限被用作表面金属值。向超高纯度化学制品的转变导致了锌、铜和镍向低表面金属的明显转变。没有观察到铁的这种偏移。
表面锌水平实现了最显著的改善,平均水平从111.4降低到了10030.3 x 10英寸原子/厘米。表面铜被降低到7.2毫摩尔4.8×10“原子/厘米”,而镍从3.6减少到3.1×10“原子/厘米”。铁水平没有遵循类似的趋势;平均表面值从12.6提高到15.5×10英寸原子/厘米。平均值的比较表明,在锌和镍的95%置信水平上,转换前后的差异有统计学意义,而在铜的80 %置信水平上,差异有统计学意义。在每种情况下,标准偏差都有所改善。