
扫码添加微信,获取更多半导体相关资料
本文介绍了抗蚀剂工艺的基础知识,包括实用技术,接近模式是一种具有成本效益的过程,具有实现任意2-3微米宽度模式的潜力,在解释了标准过程和机制之后,描述了MEMS区域中的一些问题。
光刻的基础是基板面统一的并列处理,与利用工具的机械加工相比,能够越精细地增加制作装置数量等,发挥包括生产率在内的威力,在MEMS领域中,在图案化中,可能不是利用步进器,而是利用对准器的近距离曝光,成本效益高,最小稳定图案宽度为2-3微米。
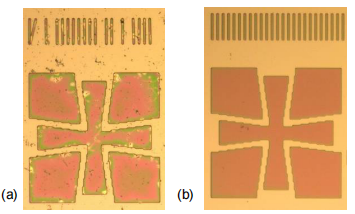
图1
图1是经验少的学生利用OFPR-800LB光刻胶进行图案化的例子,图1(a)乍一看是坏的(1)整个基板上附有细小的垃圾;(2)光刻胶颜色不均匀,有渐变部分;(3)上部提供间距为10微米的线-和-空间(占空比为1:1),但5µm宽的线可能倾斜或丢失。说明原因:(1)中的细小垃圾当然应该清除,将圆型晶片切割,做成小芯片状使用,可以认为是此时的垃圾,作为基板清洗,学习使用食人鱼溶液(硫酸和过氧化氢水)等强化学药品进行处理。实际上,在图1(a)中进行了该清洁处理,但是,划片中最有可能的垃圾是硅的碎片。食人鱼溶液对有机物有效,不能去除硅。建议用有机溶剂和软纤维,如棉签,机械擦拭,擦拭的方向不要往复,以一定的方向为好;(2)和(3)是同样的理由,从细小的模式流动可以推测,模式转录本身已经完成,但湿显影处理发生了异常,正抗蚀剂基本上与基板的粘合较弱,当成膜时,抗蚀剂以液体状态拉伸到基板上,通过预焙,稀释剂脱落,体积收缩,作为结构材料考虑的话,可以认为是大的膜应力在起作用。

图2
图2是很多教科书中介绍的光刻胶工艺一连串的工序,预处理包括清洁和六甲基二硅烷(HMDS)处理,迅速地从硅表面除去水的多分子层并疏水化。
图3显示了HMDS处理中产生的表面改性(1),HMDS与Si表面的OH反应,使表面成为疏水性,实际上,在图1(a)的例子中也使用了这种方法,在HMDS自旋涂覆后,继续自旋涂覆抗蚀剂,如果出现(2)(3)问题,建议在HMDS涂抹后高温烘烤,如果没有限制,最好在200℃以上,HMDS分子分解·固定在基板上时,作为表面活性剂发挥作用,仅暴露于HMDS中时,随附生成的氨和未反应的HMDS残留在硅表面,在270℃烘烤的物质中,没有确认到这些物质的存在,抗蚀剂开始咬住基板,在为旋涂而滴下抗蚀剂时,观察到抗蚀剂难以扩散的情况,图1(b)显示了200℃烘烤措施,良好的模式在有无抗蚀剂之间的差异很明显,没有中间色和晕染。

图3
综上所述,可以理解抗蚀剂膜厚选择的指针,为了实现微细图案,基本是在允许的范围内使抗蚀剂膜变薄,当抗蚀剂-基板之间的接触面积相同且抗蚀剂膜变厚时,涂膜应力的膜厚度积分值变大,因此容易剥离,在MEMS特有的厚膜抗蚀剂中,除了低附着力外,还会出现裂纹,这是共同的问题,主要是通过材料解决,但也有处理上的注意点,在将基板从高温状态中取出等情况下,通过导热率低的材料等,避免陡峭的温度变化引起的温度冲击。
如果到成膜为止都正确进行,那么决定解像度的第一件事就是曝光,在微细图案的转录中,应该意识到硬接触,这是因为即使是微小的间隙,光强度分布也会随着光传播而与掩模的光强度分布发生变化,厚膜抗蚀剂需要UV光的透射率高,这是因为,如果光不能通过抗蚀剂层进行吸收,就无法形成图案,即使通过,如果光刻胶的表面侧和基板侧的曝光量极端不同,图案侧壁也不会垂直。另外,显影通过显影液从抗蚀剂表面侧接触,向基板依次进行,表面侧接触显影液的时间越长,表面侧显影时间越长,对于曝光部分溶解的正型光刻胶,表面侧的曝光量无论如何都较多且显影时间也较长,表面侧容易溶解,基板侧难以溶解。也就是说,侧壁难以垂直。相反,对于曝光部分不溶的负型光刻胶,由于被强烈曝光而难以溶解的表面侧显影时间较长,因此更具有溶解的条件,相互抵消而容易得到垂直壁,在用厚膜抗蚀剂形成垂直图案时,使用透过率高的负型抗蚀剂在原理上是有利的。
通常,抗蚀剂的适用性曝光量随膜厚变化而变化,SU-8不太受曝光量变化的影响,这是因为UV透过率高,在100µm左右的膜厚下,UV吸收量不大,当膜厚较厚,需要精细图案时,应同时使用显影液槽的搅拌和超声波处理,但是,与微细图案的倒下和剥落之间存在着权衡,干燥时产生的冲洗液的表面张力是主要原因,有时使用的不是表面张力为72kN/m的水,而是24kN/m的叔丁醇50%水溶液。但是,一般来说,表面张力小的液体容易侵入抗蚀剂和基板的界面,容易引起图案剥落,虽然工艺变得复杂,但如果使用利用升华的冷冻干燥法,表面张力几乎可以降低为0。
关于抗蚀剂过程,介绍了通常很难在讨论中出现的部分,由于近距离曝光本身很简单,所以对照原理,希望能为判断提供参考。