
扫码添加微信,获取更多半导体相关资料
本文描述了去除金属硬掩模蚀刻后光致抗蚀剂去除和低k蚀刻后残留物去除的关键挑战并概述了一些新的非等离子体为基础的方法。
随着图案尺寸的不断减小,金属硬掩模(MHM)蚀刻后留下的光刻抗蚀剂更难去除,因为没有或只有很小部分的光刻抗蚀剂(PR)没有交联的,采用MHM模式,干燥的PR带通常会导致低k材料的顶角的第一类等离子体损伤,延伸到MHM层的边缘下方,这个受损的区域在随后的清洗中很容易受到攻击,从而产生具有非平面顶部表面的介电线,这反过来又会导致严重的线间电容和隔离问题,因此探索了替代的非等离子体途径来去除MHM上的PR。
通过UV预处理和浸泡在溶解的溶剂中,从MHM中获得了良好的PR去除效果,如下图所示,这一过程去除了整个等离子体修饰的PR和有机BARC层,紫外处理是在222纳米准分子灯在25mW/cm2的真空下进行的,没有有意加热,臭氧是通过以2标准l/分钟总流量的氧气流到臭氧发生器获得的,其出口的臭氧浓度为20w-ppm,这种臭氧和氧气混合物通过溶剂容器底部的扩散器起泡,同时还证明,这三个方面都是必要的:紫外线预处理臭氧和溶剂,通过选择性地消除每一个单独。
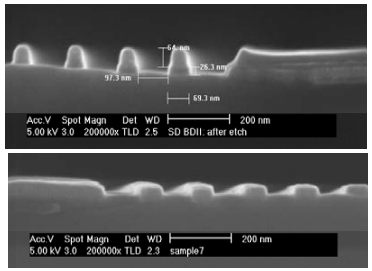
首先使用汞探针进行的测量表明,由于单独对部分蚀刻的低k材料进行紫外处理,导致的k值增加小于0.1,这个过程被认为是这样工作的,紫外处理导致PR外壳中C=C结合浓度增加,由FTIR分析解释,这些C=C通过臭氧分解被臭氧氧化,导致聚合物链的断裂,对于存在于交联PR地壳主链中的C=C,这将导致网络的有效破坏,最终使其可溶于碳酸丙烯酯,然而溶剂和臭氧的联合使用可能会引起溶剂的稳定性、混合物的寿命甚至安全性方面的问题,因此,人们继续寻找其他方法。
一种很有前途的替代方案是进行一系列的紫外线照射,然后暴露在90°C的臭氧+水(蒸汽)中,最后在有机溶剂中进行冲洗,臭氧过程如参考文献所述,氧气的总流量为2标准l/分钟,其中臭氧重量浓度为200ppm,这一过程也导致了整个等离子体修饰的PR和有机BARC层的去除,暴露于臭氧+水蒸汽的时间必须限制在大约1分钟,以保持k值增加在0.1,暴露时间越长,k值就越高,这是由于臭氧水体系中活性自由基的存在,与低k材料相比,这些自由基对PR的选择性较低,在其他研究中,也发现了对溶剂基混合物的机械搅拌的附加应用可以增强光阻去除,这可能是声波搅拌或使用高速液体气溶胶喷雾。
在过去,经常尝试过稀释含高频的混合物,一般来说,dHF由于其有机含量而不能完全溶解聚合物,因此,我们考虑了基于溶剂的溶液,由于化学选择性要求非常严格,认为成功的蚀刻后残留物去除程序将不是纯粹的化学程序,而是需要其他物理去除机制的辅助,例如高频声学搅动或使用高速液体气溶胶喷雾,一些溶剂表现出诸如蚀刻后残留物等颗粒重新沉积的倾向,使用超电子搅动也可以有利于防止这种沉积,下图显示了应用于溶剂基混合物的超电子搅拌对整体PER去除的有益效果,当然,机械力的使用需要很好地调整,因为太强的力会导致结构损伤,化学-机械清洗过程不仅应具有适当的化学选择性,而且还应具有机械选择性。
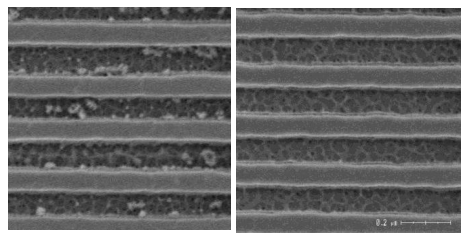
为了优化机械部件,需要更好地理解结构的机械强度,并评估去除颗粒所需的力,对机械强度的测量和理解将导致建立化学机械清洗工艺的机械规范,这是清洁过程中的一个范式转变,一种基于侧向力AFM的测量方法最近已经成功地应用于硅栅极堆叠线,所得到的值可以被建模来提取失效应力值,采用宽度为90纳米、高度为150纳米的多孔低k材料的分离线进行侧向力原子力显微镜测量,在侧向力为4.5+/-0.5mN时失效的线,从扫描电镜检查可以看出,故障发生在低k线内部,而不是在底部界面。
采用相同的侧向力原子力显微镜技术,测量了直径为125纳米的聚苯乙烯乳胶球的去除力,它被发现在20nN左右,由于这个力几乎比破坏30纳米低k线的估计力低2个数量级,因此确实存在一个进行机械清洗的窗口。
由于优越的润湿和没有表面张力,考虑了尺度的特征,一种有趣的替代方法被提出,称为气体膨胀液体,其性质介于超临界流体和液体浴之间,当气体在高压下引入液体时,当气体掺入时,液体体积膨胀,密度、粘度和表面张力降低,相对于单链脂肪酸,同时保持更多的类液体性质(例如,改进的溶剂强度),这些GXL特性允许通过包含高压气体来调整液体特性,基于TMAH和二氧化碳基的混合物已被成功地使用,在保持k值的同时,成功地从MSQ薄膜中去除PER。
紫外预处理后的臭氧和溶剂处理导致了MHM蚀刻后PR的完全去除,如果适当调整以避免结构损伤,去除溶剂的巨超声搅拌具有有益的效果,以自由基阴离子为基础的臭氧和气体膨胀液体过程显示出良好的PER去除前景。