
扫码添加微信,获取更多半导体相关资料
引言
我们在蚀刻的硅(110)表面上实验观察到的梯形小丘的形成,描述它们的一般几何形状并分析关键表面位置的相对稳定性和(或)反应性。在我们的模型中,小丘被蚀刻剂中的铜杂质稳定,铜杂质吸附在表面上并作为钉扎剂。随机吸附模型不会导致小丘的形成,因为单一杂质很容易从表面去除。相反,需要一整簇铜原子作为掩模来稳定小丘。因此,我们提出并分析了驱动相关吸附并导致稳定铜团簇的机制。
实验
第一性原理计算:我们使用度泛函理论的原子轨道计算了铜在不同表面位置的氢和羟基封端的硅表面上的吸附能。使用PBE梯度校正进行计算。使用平衡校正处理基组叠加误差 。所计算的系统是周期性的二维(2D)硅平板,其两侧以氢或氢原子终止,以饱和悬挂键。铜杂质最初作为阳离子存在于溶液中。然而,铜离子在表面附近被还原,并在中性状态下被吸附。
动力学模拟:蚀刻的模拟基于表面的原子描述和选择要去除的硅原子的K级搜索算法。系统中单个硅原子的去除率由它们的局部邻域决定,即第一和第二相邻硅I 原子在体和表面上的数目。这种四指标分类可以区分和分类模拟中遇到的不同表面结构。
非均匀吸附(NUA):在我们的模型中,铜在小丘形成中的作用是作为小丘顶点的钉扎剂。金字塔中间小丘具有非常稳定的面,甚至一种杂质就足以使小丘稳定相当长的时间。
相互作用增强吸附:铜杂质之间吸引人的相互作用可能导致NUA。如果两个铜原子 在硅表面上彼此相邻在能量上是有利的,则铜可以聚集,从而形成稳定的掩模,该掩模 稳定生长的小丘的顶点。
高度增强吸附:虽然离子交换树脂能使杂质找到彼此,但NUA效应 也可以通过使杂质更喜欢吸附在小丘的顶部来实现。
活性增强吸附:为了引入一种不像国际能源机构那样完全是地方性的方法 ,也不像HEA那样是全球性的方法,我们实施了行政审批制度。
结果和讨论
梯形小丘的结构:图1(a)是在实验中看到的梯形小丘的SE M i图像。这些小丘的特征形状在图像中清晰可见:四边形基底近似为菱形,对角线平行于硅(110)表面的对称轴。梯形小丘的假设结构如图1(b)所示。
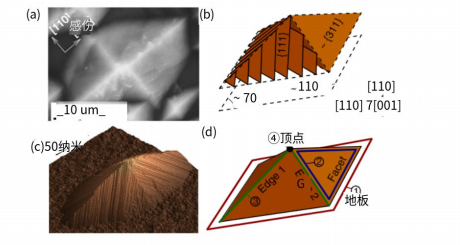
图1 (a)中实验观察到的硅(110)上的梯形小丘应该理想地由三角形层的叠层组成,如(b)中所示。这一假设结构在模拟中得以实现,如(c)所示(使用国际能源机构)。(d)列出小丘的部分,其相对稳定性决定了结构的演变:(1)底面 ,⑵小平面,⑶小平面边缘和⑷顶点。
铜吸附速率:一性原理计算表明,铜吸附在硅表面在能量上是有利的, 吸附能与铜能形成的键数近似成正比。由于能量等级,有几个位置吸附是特别有利的。
为了研究这些特殊位置的钉扎如何影响形态,我们使用理想的吸附速率进行了、一系列计算。如图2,我们系统地检查{A, F, H, 1}所有子集,并为选定的位 点指定高吸附幸,而所有位点的吸附率都非常低。这样,系统中几乎所有可用的铜都将被吸附在所选类型的位置。解吸速率都设置得很低,解吸通过欠蚀刻途径进行,即当相邻的硅被去除时。调整蚀刻条件,使得当允许在所有位点A、F、1 H和I上吸附时,形成小丘。

图2 我们介绍了一些重要的带有标记的铜吸附位点。显示了站点A、D、F、H和I的示例。在面板(a)和(b)中,示出了具有两(111)层的结构(上层被遮蔽)。该层的左侧是扭结的一元步骤,右侧是二元步骤。小组(c)和(d)分别显示了一元和二元步骤的侧视图
根据第一性原理结果估算的比率:为了将我们的KMC模拟与密度泛函理论数据联系起来,我们希望根据第一性原理的结果估算铜的吸附速率。然而,彻底计算所有可能位置的吸附速率太昂贵,我们必须进行简化。这就足够了,因为在前面的部分中,我们表明不需要杂质吸附速率的精确值来定性模拟小丘形成的过程。
NUA模式对山丘形成的影响:已经表明梯形小丘可以在模拟中形成,我们继续分析形成过程和产生的形态。基于理想吸附速率的模拟,我们知道所实施的NUA方案导致了定性不同的结果。此外,这些方法包括影响形貌的参数。
国际能源机构:在IEA中,就小丘形成而言,决定性参数是相互作用强度。这里,我们使用增强因子fIEA = exp(E/kgT),其中参数E实际上是由于相互作用引起的活化能的降低。(然而,这里E不受实际活化能的限制)
结论
我们已经使用KMC方案模拟了硅(110)的蚀刻,该方案包括可能吸附在表面上并充当钉扎剂的蚀刻剂杂质。在本研究中,我们着重于铜作为钉扎杂质的作用。第一次,梯形小丘的结构分析和其稳定性的现场特定条件导致了它们的模拟。模拟小丘的抽象几何结构与理论分析完全一致,与实验观察到的形貌十分吻合。我们观察到铜的聚集是小丘形成的必要条件。如果发生聚集,由密度泛函理论计算得到的铜在最有利位置的特定吸附足以驱动该机制。第一性原理计算表明铜原子之间存在吸引力。结合这种吸引的蒙特卡罗模拟表明,它确实可以导致所需的铜团簇。除了交互模型,我们还实现并分析了另外两个驱动铜聚集并导致小丘增长的计算方案。本研究表明,有一个适用于(100)和(110)上金字塔形和梯形小丘的小丘稳定性通用模型。