
扫码添加微信,获取更多半导体相关资料
热氧化的目的:Si晶片在大气中自然氧化,表面非常薄,但被SiO2膜复盖。 Si和在其上产生的SiO2膜的密合性很强。 在高温下进行氧化,会产生厚而致密且稳定的膜。 Si的熔点为1412℃,但SiO2的熔点为1732℃,复膜具有非常高的耐热性。 并不是所有的金属和半导体都具有被密合性高的致密的氧化膜容易被复的特性,而是作为将Si组装到半导体元件上的实用上非常有益的效果被利用。最初发明的Ge晶体管代替了Si晶体管,也是因为它通过热氧化形成了与Si相容性好的电、机械、热、化学特性优良的绝缘体SiO2,可以应用于MOS晶体管结构和钝化。
热氧化温度在800~1100℃下进行,但该温度区域属于晶片制作工序的其他热处理温度的最高温度范围。 因此,在进行热氧化的同时,同时进行几个热处理效果。 另外,在本来应该在比其更低的温度下进行的处理之后进行热氧化的话,之前的处理就会无效。 因此,热氧化是晶片工艺初期、晶体管形成以前( FEOL )使用的工艺技术。 金属布线中使用的Al的熔点为660℃,布线处理后不能使用热氧化,所以SiO2绝缘膜用堆积法形成。图5-1比较表示各种热处理工艺及其温度。
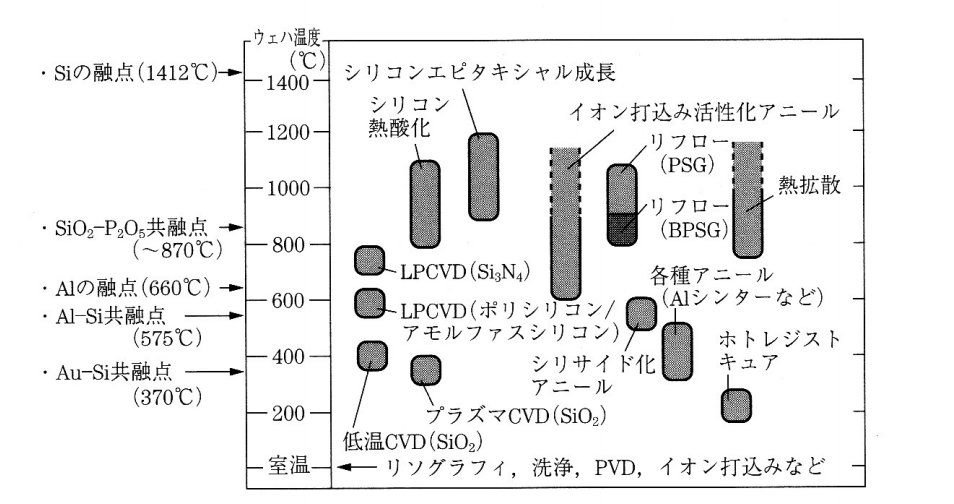
图5-1 晶片制作工序中的各种热处理工艺及其温度
表5-1表示晶片制作工序中使用的SiO2绝缘膜的用途、制作方法、代表性的膜厚。栅极氧化膜非常薄,起到支配晶体管性能的重要作用。
热氧化方式:热氧化根据氧化使用的气体种类,有干氧化、湿氧化、蒸汽氧化3种方式。干氧化使用氧气,湿氧化在氧气中加入去离子水蒸气后使用,蒸汽氧化只使用去离子水蒸气。氢气燃烧蒸汽氧化方式使用的是炉内流通氧气和氢气自然燃烧产生的H2O。氧化装置方式有卧式炉、立式炉、RTP (快速热处理)装置3种。
图5-3表示4级卧式炉装置的结构。炉子用大石英管将其周围包围。将垂直排列在小船上的多个晶片插入炉的内部。表5-2表示干氧化的配方的一例。立式炉是将卧式炉垂直配置,在垂直配置的石英管或SiC的管内部水平配置多个晶片。 直径大的晶片不是用卧式炉而是用立式炉处理。
图5-4所示的RTP装置是从容器外侧通过石英窗用多盏灯照射水平配置的真空容器内的晶片进行加热的方式。由于一次处理一片直径较大的晶片,因此与一次处理数十片至数百片晶片的卧式炉、立式炉相比,单位时间处理的晶片数较少。但是,在炉中进行950℃、20min处理的地方,在RTP中可以进行1100℃、20sec的高温短时间处理。适用于极薄的热氧化膜形成、离子注入后的退火和活性化、钛硅化物和钴硅化物的退火等方面。
热氧化理论:氧化从晶片表面开始向深处进行,但O2、H2O在形成的SiO2层中扩散,氧化反应经常在SiO2/Si的边界面发生。度相当于形成的SiO2层厚度的44%的Si减少。换言之,Si层会通过氧化变化为2.27倍厚度的SiO2层。氧化膜的形成速度受到以下三个因素的影响。
湿式氧化比干式氧化进行得快是因为H2O在SiO2层中的溶解度大。这是因为大且分子小,所以扩散速度大。 但是,干氧化形成的SiO2层的致密性更高。因此,干氧化通常用于形成1000Å以下厚度的氧化层,形成比其厚的氧化层时使用湿氧化。
热氧化的注意事项:说明两个热氧化中的主要注意事项。第一是通过干氧化添加氯。它具有溶解在Si中的有害杂质碱金属原子Na、重金属原子Fe、Ni和氯原子Cl化合形成挥发性物质并去除的效果。 作为添加物,使用盐酸HCl或二氯乙醇C2H3Cl2OH。第二是抑制氧化层中有害电荷产生的对策。氧化层绝缘膜中的电荷有(1)界面的离子性Si原子、(2)碱金属可动离子( Na+、K+ )、(3)Si悬挂键、(4)本体缺陷离子4种。界面30的厚度层中存在的正离子性Si原子的密度对晶体取向的依赖性大,使用密度最小的< 100 >晶片,并且优化氧化·退火条件,抑制其发生。能动性离子的最大原因是从工作环境进入的Na+,对策是洁净室的管理。
Si晶体界面的悬挂键(不成对电子对)大部分与氧原子结合,残留的部分用氢原子终止。为此,在IC封装之前,将芯片在450℃的氢气环境中进行退火。氧化层本体中的缺陷通常少得可以忽略,但由x射线或高能电子的照射或栅极电流等产生,通过退火去除。
氧化膜的干涉色和厚度:在晶片上形成的氧化膜中出现被其表面和硅的边界面反射的光的干涉色。干涉色是判定氧化膜厚度最简便的手段。表5-3表示氧化膜厚和干涉色的关系。

表5-3 晶片上的氧化膜的厚度和干涉色的关系