1引言
硅片上的有机﹑无机和颗粒状杂质通常是以化学或物理吸附的方式结合于硅片表面或包埋于硅片自身的氧化膜中。这些沾染物及颗粒状杂质会严重影响器件的性能﹑可靠性和成品率。实验表明,有超过50%的次品是由于清洗不当造成的,
从而使得超净表面的制备工艺成了制作大规模和超大规模(VLSI)集成电路(IC)的关键技术。所谓超净表面即要求硅片表面无颗粒状杂质和有机、金属沾染物(保守地说,表面的金属杂质应少于每平方厘米1010个原子;大于0.1mm的粒子应少于每平方厘米0.1个),无自身氧化物,完全氢终端﹑表面的微观粗糙度要小[1,2]。因此清洗时必须有效地去除表面有机与无机沾染物,而又不侵蚀和破坏硅片表面或导致表面粗糙化。
目前世界各国在半导体器件生产中普遍采用的是Kern于1970年发明的RCA标准清洗方法[1]。自90年代初期,人们开始致力于新型清洗工艺和清洗剂的研究以取代RCA清洗技术。1996年W.A.Cady和M.Varadarajan[3]提出了采用四甲基氢氧化氨[N(CH3)4OH)]与羧酸盐缓冲剂配置的碱性水溶液喷雾清洗法;1997年JoongS.Jeon和SriniRaghavan[4,5]提出了利用兆声波激发臭氧水对硅片进行清洗;1998年GeoffreyL.Bakker[6]等人提出了用水和水/CO2混合溶液在高温、高压下的清洗等等。1995年山东大学光电材料与器件研究所研制成功了含表面活性剂的新型清洗剂和与之配套的新型DGQ系列清洗工艺。它有DGQ-1﹑DGQ-2两种型号,DGQ-1去除油脂类杂质﹑DGQ-2去除金属类杂质,使用时稀释19倍。该清洗技术的清洗效果与RCA清洗技术相当,目前已在半导体分离器件得到了应用。我们对它的清洗效果与标准RCA清洗技术进行了比较,结果表明含表面活性剂水溶液的新型清洗技术在去除有机物和金属杂质离子方面相当于标准RCA清洗工艺[7]。其清洗的硅片,表面平整度高,明显优于标准RCA清洗技术[8],而且新型清洗剂具有无毒﹑无腐蚀性﹑对人体无危害﹑对环境无污染,工艺简单﹑操作方便等优点。HF在清洗中的作用是什么,下面我们以实验来加以说明。

2实验结果和讨论
2.1HF稀溶液在DGQ系列清洗工艺中的作用
为了确定HF稀溶液在DGQ系列清洗工艺中的作用,将2英寸的硅圆片分4组分别按照表1中的方法进行清洗。
按照上述四种方法清洗好的硅片用傅立叶变换红外吸收光谱仪测量它们的红外(透过)吸收状况并绘制吸收光谱图,如图1所示。从图1中可以看出谱线中有两个明显的吸收峰,在609波数处的峰是硅衬底吸收峰,1108波数处的吸收是不同价态硅氧化物的复合吸收,其中的尖峰是由+2价态硅氧化物吸收产生的;由曲线3和曲线4可以看出,无论是常规的酸碱清洗还是DGQ系列清洗剂的清洗,在没有HF稀溶液浸泡的情况下,1108波数处的吸收都是不同价态硅氧化物的复合吸收,表明清洗后的硅片表面依然有一层不同价态硅氧化物存在;由曲线1和曲线2可以看出,用HF稀溶液浸泡后清洗的硅片,复合吸收变成仅有二氧化硅的吸收;表明DGQ-1﹑DGQ-2清洗剂与SC-1﹑SC-2一样对硅片表面的硅氧化膜都没有去除作用。因此采用DGQ系列清洗剂清洗硅片时,首先需用HF稀溶液浸泡硅片,将硅片表面的自然氧化膜去掉,以利于包埋于氧化层内的金属和有机污染物的去除。
Ishizaka证明了标准RCA清洗工艺在对半导体表面清洗的同时,在硅片的表面生成了一层厚度1~1.5nm的二氧化硅钝化膜[9]。比较用标准RCA清洗工艺和用DGQ系列清洗工艺清洗的硅片的红外透过吸收谱,二者除了硅衬底的吸收外,也都有二氧化硅的吸收,而且吸收峰的高度基本相同。这表明用DGQ系列清洗工艺清洗硅片同样在硅片表面生成了一层厚度1~1.5nm的二氧化硅钝化膜。
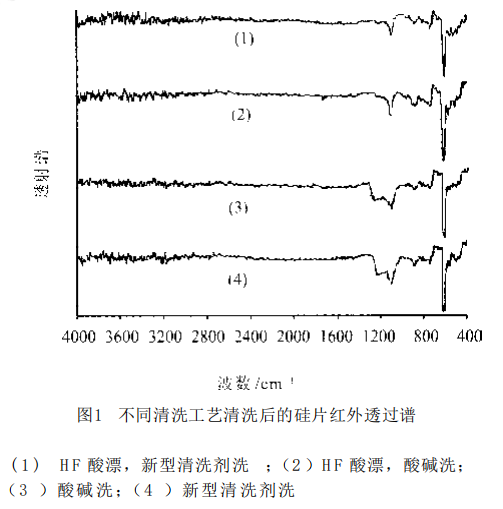
2.2清洗后硅片表面的润湿性能
硅片经不同的清洗工艺清洗后其表面的润湿性能各不相同。为了测定硅片表面的润湿性能,实验中采用了XZD-3型全量程界面张力﹑接触角测试仪,它是利用旋转滴法测量接触角而确定硅片表面润湿性的。接触角示意如图2,根据角度的大小即可判定硅片的润湿状况。

表2给出了硅片经常规酸碱清洗﹑DGQ系列新型清洗剂清洗和仅用稀HF浸泡20秒后高纯水冲洗的硅片表面的接触角。

由图2我们知道,角度越小,表明高纯水从硅片表面排开气泡的能力越强,高纯水与硅片的接触面积也就越大,硅片表面的润湿性也就越好。从表2中可以看到DGQ系列新型清洗剂清洗后的硅片表面的接触角的平均值最小(9.8°),因而润湿性也就最好。
3结论
红外吸收谱测量的结果表明:无论是常规的酸碱清洗还是DGQ系列清洗剂的清洗,在没有HF稀溶液浸泡的情况下,1108波数处的吸收都是不同价态硅氧化物的复合吸收,用HF稀溶液浸泡后清洗的硅片,复合吸收变成仅有二氧化硅的吸收。因此,无论是用标准RCA清洗工艺,还是采用DGQ系列清洗剂清洗硅片时,首先需用HF稀溶液浸泡硅片,将硅片表面的自然氧化膜去掉,以利于包埋于氧化层内的金属和有机污染物的去除。
采用XZD-3型全量程界面张力﹑接触角测试仪测量接触角表明,DGQ系列新型清洗剂清洗后的硅片表面的接触角为最小,因而润湿性也最好;标准RCA清洗剂清洗的硅片表面的接触角稍大一点,润湿性稍差一些;而仅用HF稀溶液浸泡20秒后高纯水冲洗的硅片接触角为最大,因而润湿性最差。