步进扫描光刻机整机集成工艺方案设计
分系统集成工艺方案设计:
分系统集成工艺方案设计包含布局与接口分析、集成与检测方案规划、集成工具工装需求规划、集成步骤规划等。布局与接口分析:主要是分析分系统在整机中的布局、接口的形式、定位方式等;集成与检测方案规划:主要是分析集成指标,结合布局与接口形式规划集成方案及检测方法,如指标无法直接实现,还需要进行装配尺寸链分解;集成工具工装需求规划:根据集成和检测方案,选择适用的工具/检具,如需要设计专用工装辅助集成或检测的,则需给出工装设计方案及其指标需求;集成步骤规划:制定分系统集成到整机上的集成步骤。步进扫描光刻机集成工艺方案非常复杂,下文将通过几个分系统案例,阐述集成工艺方案的设计过程。
调焦调平分系统
调焦调平分系统安装在主基板下方,物镜安装在主基板上方,结构布局如图1所示。根据整机测校流程,调焦调平分系统在物镜曝光过程中实时调平调焦,因此,要求调焦调平焦面与像面的垂向集成误差不能超过调焦调平的焦深范
围。步进扫描光刻机所选用的调焦调平分系统焦深范围非常小,是微米级别的。由此,调焦调平集成方案规划需解决以下几方面的问题:1、调焦调平焦面和像面都是光学面,相互为基准集成,集成阶段如何去确定这两个光学面的位置;
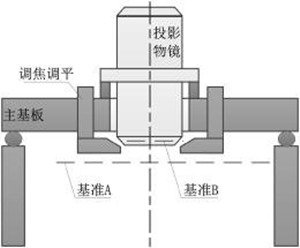
图1调焦调平分系统机构布局
2、指标是微米级别的,常规的测量方法达不到这个级别的测量精度,该选用什么样的测量仪器;
3、在线集成空间小,选用的测量方法如何满足空间要求;
4、指标是微米级别的,可测量,还需可调整,调整结构必须有高于指标的调整分辨率才能最终实现指标。基于上述的问题,我们逐个分析展开:
1、确定调焦调平焦面和像面两个光学面的位置。由于调焦调平焦面和像面是两个光学面,位置无法直接可见,不利于测量,那么首先需要解决可见可测问题。因此考虑引入一个可见可测的面作为第三方基准,如果调焦调平焦面和像面分别可根据这个第三方基准集成,那么问题就可解决。由此,引入了第三方基准面,即图1中基准A。接下来解决调焦调平焦面相对于基准A面的可集成性。根据调焦调平性能可知,如果提供一个光学镜面,那么调焦调平分系统可基于这个镜面进行调整,并可测出其焦面相对于镜面的位置偏差,因此,只要我们引入的这个基准面是光学镜面即可。至于像面,它和调焦调平焦面不同,不能采用同样的方式解决问题。通过分析发现,物镜像面可以和其机械面/光学镜片面建立关系,由此我们对物镜提出了设计需求:在物镜底部提供一个光学镜面B面,作为物镜的间接基准,即图1中基准B。
这样我们就把调焦调平焦面和像面通过两个间接基准A面和B面给实体化了,至于两个光学镜面间的尺寸测量可选用光学检测的方法实现。由于集成指标是通过引入的几个基准间接实现,因此需要进行装配尺寸链分解,定义各组成环的集成要求。这个尺寸链的组成环为:调焦调平焦面相对于A面、像面相对于B面、A面相对于B面,它们的累积误差需小于调焦调平焦面相对于像面间的指标需求。
2、测量仪器选型
这个测量仪器需满足以下几个条件:
1)测量精度微米级以上;
2)可用于光学镜面间的测量;
3)可满足测量空间要求。
经过选型,测厚仪可实现上述所有需求,测量精度1微米。
3、如何调整来实现精度这个就需要给设计提需求:
1)要求调焦调平和物镜两个分系统提供可调整结构,调整分辨率高于微米级;
2)调整结构在物镜和调焦调平整机集成阶段具有可操作空间,且使用简便。通过上述的方案设计,我们最终确定了调焦调平分系统集成指标的实现方案。
零位传感器
零位传感器由PSD和角锥镜两个部分组成,共3组。PSD部分安装在主基板下方,角锥镜安装在工件台chuck上,结构布局如图2所示。
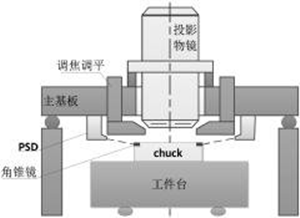
图2零位传感器结构布局
要求PSD相对于角锥镜的集成精度为微米级,3组精度同时保证,可直接用零位传感器作为测量仪器测量。虽然零位传感器的集成精度可直接测量,但工件台集成后,PSD和角锥镜之间距离小于20mm,缺少必要的调整空间,没法调,指标就无法实现。基于这种情况,在线直接装调的方案被排除了。由于集成精度是微米级别的,所以离线集成方式也被排除。最后,考虑到影响集成空间的是工件台本体,那么装调零位传感器时若只用chuck,工件台本体不安装,用一个工装去模拟工件台支撑chuck,这个集成空间问题是否可被解决,经分析和评估,方案可行。调整完成后,再将chuck重新安装到工件台上。后续测校过程中,只要chuck能找到PSD和chuck上角锥镜配作调整的位置,就能实现零位对准。
掩模台分系统:
掩模台分系统安装在整机框架的掩模台支架上,掩模台的结构布局如图3所示。
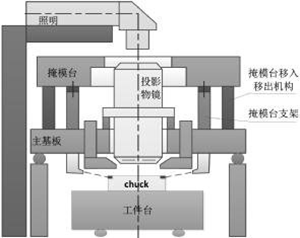
图3掩模台结构布局简图
掩模台和掩模台支架通过一面两销定位,集成指标的实现不需要调整和检测,安装到位即可。掩模台集成需要重点关注的是:
1、 因照明系统空间位置的约束,掩模台集成能吊运,只能通过移入移出机构将其移至集成工位;
2、掩模台重1.2t,提升行程>1.7m;
3、掩模台从工装上向移入移出机构工位交接时,接口需对准,重载、高位的对准,如何保证操作便捷、安全;
4、掩模台从移入移出机构向掩模台支架工位交接时,接口需对准,同样如何保证操作便捷、安全。上述这些都需要工装设计时重点关注的。工装的需求分析,通常需要详细梳理集成步骤,再根据各集成步骤,提出工装需求,下面将梳理掩模台的安装步骤,以及分析每个步骤的工装需求:

综合上述的分析结果,就可以给出合理的工装需求。
免责声明:文章来源于网络,不代表本公司观点,如有侵权请联系本网站删除。