1Marangoni干燥机理分析:
Marangoni干燥原理如图1所示,晶片在IPA气氛下与水分离(可通过晶片提拉或水慢排的方式实现),完全分离后,流体慢排使花篮干燥,开启排风将IPA蒸汽抽掉,同时通入氮气吹干晶片表面残留的IPA。
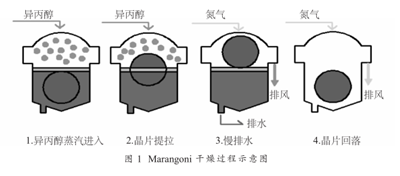
在IPA蒸汽存在的环境中,由于IPA的表面张力比水小得多(25℃,IPA表面张力为20.9×10-3N/m:水的表面张力为72.8×10-3N/m),所以会在坡状水流表层形成表面张力梯度,产生Marangoni对流,使水更容易从晶片表面脱离。
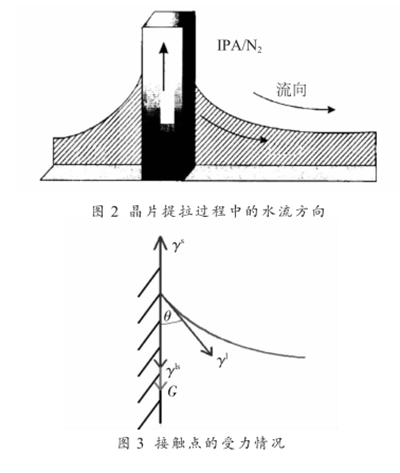
图1中的第2个步骤“晶片缓慢提拉”是Marangoni干燥的核心环节.提拉过程中,晶片表面的水会呈坡状流下,如图2所示,如果两片晶片距离很近(例如处在花篮的相邻槽中),这种坡状水流会相连为弯月形[1].这种坡状水流的最高点与晶片接触,主要受到4种力的作用,即水的重力G,晶片/水的界面张力γls,晶片的表面张力γs和水的表面张力γl,θ为水与晶片的接触角,如图3所示。
2实验部分
利用100mm(4英寸)硅抛光片进行IPA干燥,分两组实验,干燥后利用光散射测试系统检测水痕缺陷。
A组:分别在提拉速率1mm/s、2mm/s和3mm/s下进行不同IPA流量的Marangoni干燥,减压排风阶段氮气流量80L/min。B组:提拉速率1mm/s、IPA流量20L/min下进行Marangoni干燥减压排风阶段氮气流量设置为(10~100)L/min,每次增幅10L/min。C组:调整提拉高度,造成晶片与花篮的不同程度脱离。
3结果与讨论
3.1Marangoni干燥的影响因素Marangoni对流的形成本质是IPA浓度梯度,而水从表面的脱离效果又与晶片提升速度密切相关。图4给出了不同提拉速率下IPA流量与水痕比例的关系。从图4中可以看出,在没有IPA供给时,晶片水痕的出现比例是100%,随着IPA流量的增加,水痕比例有明显的下降趋势,当流量增加到一定范围时,水痕比例又出现平缓增长的趋势。图5显示了几种IPA流量下的典型水痕缺陷。
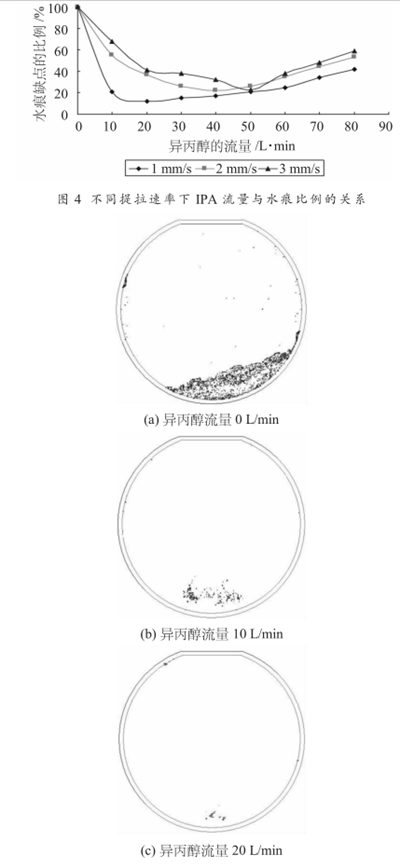

在没有IPA蒸汽的情况下,晶片表面的水主要受到重力和水表面张力的作用向下流动,当晶片露出水面1/2后,晶片与水面的交界线开始收缩,晶片表面的水受到的宏观向下的力开始变小,当晶片完全脱离水面后,晶片下半部分仍有大量水存在,这些表面附着的水在氮气中被吹干,形成了颗粒群和氧化物构成的水痕缺陷,如图5(a)所示,这表明单纯依靠慢速提拉难以获得良好的干燥效果。如果在晶片提拉过程中,通入IPA蒸汽,产生Marangoni效应,可使干燥效果大幅度提高,水痕缺陷变少变小,如图5(b)和图5(c)所示。但是。绝非IPA蒸汽流量越大越好,实验中IPA流量超过60L/min后,晶片表面会呈现无规则缺陷,如图5(d)所示,这是因为IPA蒸汽在腔体内积聚,在晶片表面冷凝形成液体薄层,在减压排风后挥发掉,残留下各种形态的干燥缺陷。从图4中还能发现提拉速率对干燥效果有着明显影响,低速提拉更容易获得良好的干燥效果,但过低的提拉速率会降低干燥效率,并使得干燥效果变得不稳定。另一个非常重要的现象是:即使在IPA蒸汽存在的情况下,无论如何设置蒸汽流量或提拉速率,当晶片脱离水面后,底部仍会有少量水存在,难以完全消除。事实上,Marangoni干燥产生的水痕大多出现在晶片底部,其直接原因即是晶片完全脱离水面后底部仍有残水。如何不留痕迹地消除底部残水,是IPA干燥的另一个核心环节。3.2底部残水的去除晶片完全脱离水面后,底部的残水只能通过蒸发去除,所以此部分的核心内容是营造合适的蒸发环境。为获得良好的蒸发效果,此步骤进行减压排风是必要的,同时还要持续供给氮气,使其在去除腔体内的IPA蒸汽的同时形成流动气流,加快底部残水的蒸发。根据伯努利原理,氮气的流量对残水的蒸发效果有着重要影响,图6是不同氮气流量下的晶片干燥状况,表明氮气流量越大,晶片的干燥效果越好。

图6同时表明,单纯依靠氮气吹拂,会有相当一部分晶片底部的残水不能被完全去除,这是生产工艺所不能容忍的,并且氮气吹拂下水的蒸发速率很慢,水与晶片界面长时间存在并暴露在气体中,较容易发生氧化反应,形成局部氧化缺陷。实验表明,此步骤如果通入适量的IPA蒸汽,可以帮助残水尽快在晶片表面铺展开来,其原理如图7所示,以加快残水的蒸发。必须指出的是,虽然同样是IPA的作用,但此步骤已不再是Marangoni效应范畴,对IPA流量和供给时间有了不同的要求。
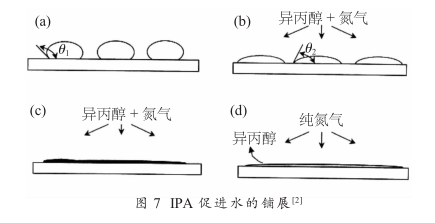
3.3干燥过程中花篮对晶片的影响在多片干燥过程中,花篮对晶片干燥效果的影响是不能回避的。花篮是承载晶片的容器,需要与晶片一并被干燥,但是其结构远比晶片复杂得多,在干燥中需要进行专门讨论。晶片与花篮具有面接触,二者同时进行IPA干燥时,面接触部位(通常为沟槽)的水难以在Marangoni干燥步骤完全消失,而长时间存留在沟槽内,最终导致氧化性缺陷。片、篮在干燥中的分离设计有助于降低水痕缺陷的比例,如表1所示,当片、篮处于半分离状态时,二者的接触面相对下降,晶片两侧的水流到晶片底部,造成底部水痕缺陷比例增加;当片、篮处于完全分离状态时,接触面的影响被消除,水痕比例有明显下降,但是随着片、篮分离程度的增加,整体干燥时间也会增加。

免责声明:文章来源于网络,如有侵权请联系作者删除。