SiC单晶的清洗:
SiC单晶的湿化学清洗法研究中,样品的清洗和接触角的测定在同一实验室完成,有效避免样品的再次污染;为防止清洗过程中的污染,清洗所用的容器均是定制的聚四氟乙烯(PTFE)器皿。实验中尝试了不同的湿化学清洗法,下面是主要清洗方法的流程:
1、RCA清洗法:
(1)将30mlH2SO4倒入聚四氟乙烯容器中,边搅拌边缓慢加入10mlH2O2,
将SiC单晶样品放入混合液中,恒温加热30min;
(2)DI水冲洗3min,将样品表面的混合液冲洗干净,N2吹干;
(3)将30mlDI水倒入聚四氟乙烯容器中,然后加入10mlNH3OH和10mlH2O2,将样品放入混合液中,恒温加热20min;
(4)DI水冲洗,N2吹干;
(5)将30mlDI水倒入聚四氟乙烯容器中,然后加入10mlHCl和10mlH2O2。将样品放入混合液中,恒温加热20min;
(6)DI水冲洗,N2吹干。
2、硫酸和双氧水混合液(SPM)单步清洗法:
(1)将30mlH2SO4倒入聚四氟乙烯容器中,然后边搅拌边缓慢加入10mlH2O2,将SiC单晶样品放入混合液中,恒温加热30min;
(2)DI水冲洗3min左右,将样品表面的混合液冲洗干净,N2吹干。
3、实验用清洗剂+SPM两步清洗法:
(1)用干净的电动牙刷蘸取适量实验用清洗剂刷洗SiC单晶样品5min;
(2)DI水冲洗3min,将样品表面的清洗剂冲洗干净;
(3)将样品置于实验用清洗剂的稀释溶液(实验用清洗剂:DI水=1:100)中超声20min;
(4)DI水冲洗3min;
(5)DI水中超声10mn;
(6)DI冲洗3min,N2吹干;
(7)将30mlH2SO4倒入聚四氟乙烯容器中,然后边搅拌边缓慢加入10mlH2O2,将SiC单晶样品放入混合液中,恒温加热30min;
(8)DI水冲洗3min,将样品表面的混合液冲洗干净,N2吹干。
注:清洗后样品储存在密封的聚四氟乙烯容器中,防止再次污染。
SiC单晶的蚀刻:
实验中对SiC单晶的贵金属Pt催化溶解蚀刻进行了静态、微观的系统研究。下面是主要蚀刻研究过程:
1、Pt丝接触蚀刻:
(1)首先在样品表面用金刚石刀做标记,然后用清洗剂+SPM两步清洗法将样品清洗干净,N2吹干;
(2)将Pt丝缠绕在样品上,使Pt丝尖端与样品上的标记点接触,置于HF溶液中,蚀刻一定时间;
(3)用实验用清洗剂+SPM两步清洗法将蚀刻后的样品清洗干净,N2吹干。
2、SiC单晶样品镀Pt及蚀刻:
(1)在20ml去离子水(DI)中放入20mg氯铂酸(H2PtCl6),混合均匀,配置氯铂酸溶液;
(2)称取0.1g硼氢化钠(NaBH4)放入100ml去离子水中完全混合,配置硼氢化钠溶液;
(3)将用清洗剂+SPM两步清洗法清洗干净的SiC单晶原片用Pt丝固定后没入氯铂酸溶液中,然后用干净的一次性滴管将硼氢化钠溶液缓慢滴入氯铂酸溶液中,边滴加边磁力搅拌,转速为1000r/min,混合液由亮黄色变为黑色时停止滴加硼氢化钠溶液。
(4)在55℃条件下,保持快速搅拌,24h后将SiC单晶样品取出。DI水冲洗镀Pt样品,N2吹干。
(5)将镀Pt样品放入聚四氟乙烯器皿中,倒入约50ml的HF浸泡12h;
(6)DI水冲洗,再用实验用清洗剂+SPM两步清洗法将样品清洗干净,N2吹干。
3、Pt粉蚀刻:
(1)实验用清洗剂+SPM两步清洗将SiC单晶样品清洗干净;
(2)将20mlHF溶液放入聚四氟乙烯器皿中,然后用Pt丝蘸取适量的Pt粉放入HF溶液中,振荡混合均匀;
(3)将清洗干净的SiC单晶Si面(0001)朝上放入聚四氟乙烯器皿中,蚀刻一段时间;
(4)用DI水冲洗干净,再用实验用清洗剂+SPM两步清洗法清洗干净,N2吹干。清洗干净的SiC单晶样品用N2吹干后存放在聚四氟乙烯器皿中,用原子力显微镜从微观上表征样品表面的形貌变化,探究SiC材料的贵金属催化溶解机理。
SiC单晶的表征:
对于SiC材料表面清洁度的表征主要是通过接触角、XPS和原子力显微镜。因SiC是亲水表面,接触角越小表面SiC表面越干净;XPS的测定清洗后样品表面是否有杂质的存在,判定样品表面的洁净度;原子力显微镜可以直观的看到样品表面形貌,观察样品表面是否存在微观颗粒状污染物或者样品表面蚀刻前后形貌是否发生变化。
刚拆封的SiC单晶原片的清洗:
SiC单晶原片是指刚拆封的未被外界环境污染的样品。实验中我们首先对原片进行了接触角、XPS和原子力显微镜的表征,为接下来样品的清洗研究提供基本参照。图3-1a是原片的接触角图,测得原片的接触角70°,表明SiC表面可能存在憎水的有机物杂质,表面不干净;图3-1b是原片的AFM图,从图中可以直观的看到SiC单晶原片表面有片状污染物的存在。一定程度上就证明未经外界再次污染的原片表面并不干净,存在着憎水的有机污染物,因此使用原片进行研究首先需要适当的清洗。图3-2是原片表面的C1s的XPS谱。通过分析C1s谱有四种成分,对应于键能283,15eV、285.35eV、286.9eV和288.8eV,分别是SiC本体的C-Si键、C-H键、C=O键和C(=O)-OH键。除SiC本体的C-Si键之外,其他三种键均是因原片表面存在污染物,经过分析计算,样品表面杂质含量为18.18%。接触角、AFM和XPS对SiC单晶原品的表征结果表明原片表面存在着憎水的有机污染物,要进行SiC单晶的化学蚀刻机理研究,必须对原片进行有效的清洗。文献中常用来清洗SiC单晶的湿化学法主要是经典RCA法,用到的其他湿化学清洗法也都是以标准RCA法为基础改进的。
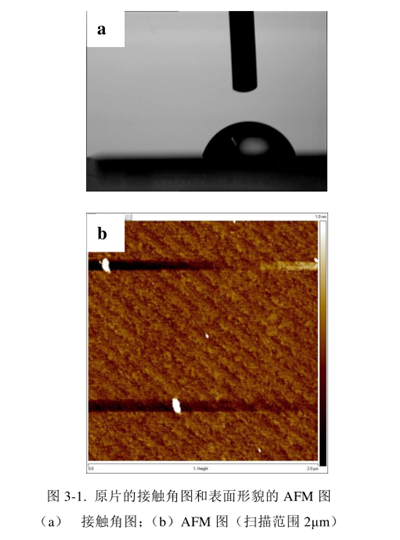
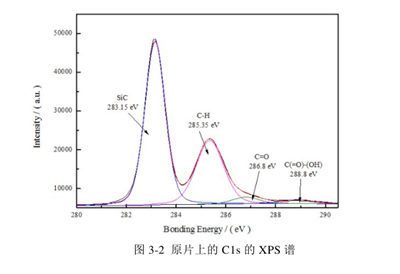
SiC单晶的湿化学清洗:
RCA清洗:RCA清洗法主要是由三步组成的,SPM(H2SO4/H2O2)、
SC1(HCl/H2O2/H2O)和SC2(NH4OH/H2O2/H2O)。SPM用于去除样品表面的有机物,SC1用来去除样品表面的颗粒物,SC2用来去除样品表面的金属污染物。对SiC的清洗研究主要基于RCA湿化学清洗方法。实验中对RCA清洗法的每个步骤进行了清洗效果的研究。将每个步骤都做为一个独立的清洗方法对SiC单晶原片进行清洗。清洗后用接触角仪测试样品表面的接触角。表3-1给出了RCA清洗法中不同步骤清洗SiC单晶样品后测得的接触角值,可以看到SPM单步清洗后样品的接触角最小,表明该步在几个独立步骤清洗法中对SiC单晶的清洗效果最佳。SPM清洗:SPM的主要作用是去除样品表面有机物,结果表明确认了SiC单晶表面的污染物主要是有机物。接下来我们主要围绕SPM进行清洗研究。SPM:H2SO4和H2O2按3:1的比例混合。SPM单步具有很高的氧化能力,可将金属氧化后溶于清洗液中,并能把有机物氧化生成CO2和H2O,用SPM清
洗SiC单晶可去除单晶表面的有机玷污和部分金属。
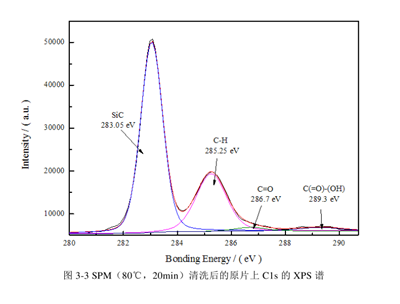
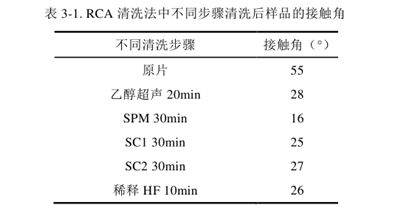
SPM清洗步骤:
(1) 将样品投入H2SO4:H2O2(15:5)的混合溶液中,在加热台上恒温加热30min,;(2)DI冲洗3min;(3)N2吹干。图3-3给出了用SPM单步清洗SiC原片后,样品表面C1s的XPS谱,经分析C1s谱依旧可以分为四种成分,但污染物杂质C含量明显降低,污染物杂质C含量与SiC本体C含量的比值为48:100,经计算分析,杂质含量为10.15%。相对于SiC单晶原片,杂质含量显著降低。

表3-2给出了SPM单步清洗在不同加热温度下加热30min清洗后的样品的接触角值。从表中可以看到加热100℃时SPM单步清洗后的样品的接触角最小,表明清洗效果最佳。继续升高温度,对结果没有影响。原因可能是温度较低时SPM混合溶液的氧化性较低,去除污染物能力较弱;100℃时SPM混合溶液的氧化性能增强,清洗效果增强;继续升高温度,对SPM混合溶液的氧化性能影响不大,清洗效果和加热100℃时相差不大。表3-3是SPM单步清洗在100℃恒温加热不同时间后得到的样品的接触角值。一般认为时间越长,清洗效果越好。为了验证该观点,我们重复了该实验,实验结果确实表明时间越久,清洗效果越好,清洗时间超过30min,继续延长时间,对清洗效果影响不大。原因可能是H2O2在清洗30min后完全分解。几次实验所得的结果显示,加热30min后得到的清洗样品接触角均为6°左右,接触角的结果比较稳定,表明SPM单步清洗在恒温加热30min时清洗效果较好。

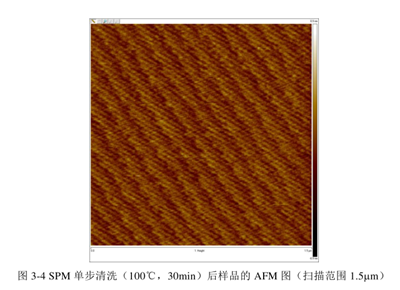
图3-4是SiC单晶样品在恒温100℃,SPM单步清洗30min后测得的样品表面的AFM图。可以看出样品在单步SPM清洗处理后,再用DI水冲洗,N2吹干一系列清洗处理后表面是很干净的,可清晰的看到样品表面的台阶,说明单步SPM清洗对于SiC单晶原片是非常有效的清洗方法。可以看出样品表面几乎没有任何杂质;还可以清晰的看到SiC单晶样品表面的台阶,这就为接下来的蚀刻抛光研究提供了基本保证。SPM+HF清洗:SPM具有强氧化性,为保证样品表面氧化物的完全溶解,确保样品表面的清洁度。尝试SPM处理后用HF溶液处理,HF溶液可将表面某些未溶解的金属氧化物去除。但发现使用HF溶液后,得到的样品表面接触角变大,对SiC单晶片的清洗效果不利。在SPM处理30min,HF溶液中浸泡10min,DI水冲洗3min左右,氮气吹干后得到的SiC单晶样品的接触角为20°,比单步SPM处理得到的样品的接触角大,表明HF处理对SiC单晶样品的清洗效果不利。
免责声明:文章来源于网络,如有侵权请联系作者删除。