
扫码添加微信,获取更多湿法工艺资料
平版印刷术被定义为“一种从已经准备好的平坦表面(如光滑的石头或金属板)印刷的方法,以便油墨仅粘附在将要印刷的设计上”。在半导体器件制造中,石头是硅片,而墨水是沉积、光刻和蚀刻工艺的综合效果,从而产生所需的特征。因为用于器件制造的光刻涉及使用光学曝光来创建图案,所以半导体光刻通常被称为“光刻”。与已经讨论的检查和计量技术一样,光刻是图案化的选择技术,因为它是光学的,因此能够实现小特征和高晶片产量。这与直接书写和压印等其他技术形成对比。
光刻的基本原理
图1示出了用于定义浅沟槽隔离特征的典型光刻工艺。这一过程包括以下步骤:
1. 基板清洁和准备
2. 形成热氧化层,并在干净的衬底上沉积一层氮化硅
3. 沉积碳硬掩模,然后沉积一层抗反射材料
4. 沉积一层光刻胶
5. 预烘焙光刻胶
6. 对准衬底/光刻胶和掩模版,使用紫外辐射和4x-5x成像曝光光刻胶。重复步骤和扫描
7. 曝光后烘焙
8. 在光致抗蚀剂中显影图案,并硬烘焙以去除剩余的溶剂
9. 执行蚀刻以打开电介质抗反射涂层(DARC)和硬掩模图案,并去除光致抗蚀剂和DARC
10. 执行蚀刻以在衬底中打开沟槽并去除硬掩模
11. 清洁表面
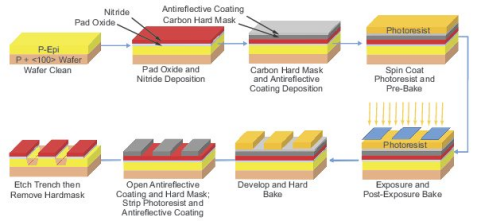
图1 半导体器件构图工艺的示意图
深紫外光刻
用于光刻的DUV技术完全基于投影光学,因为光掩模上的图案比光致抗蚀剂上形成的最终图案大得多。193纳米光刻工具中的光学系统被称为折反射系统。该术语意味着它使用透镜(折射)和反射(反射)元件来引导和调节来自激光器的光。更多信息,请参见深紫外光刻。
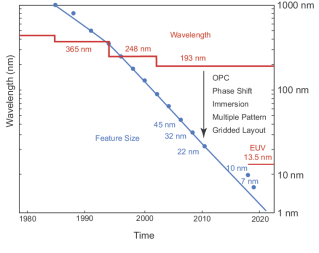
图2 集成电路特征尺寸和光刻技术的历史进展
极端紫外光刻
正在开发EUV光刻技术,以满足22纳米以下特征尺寸的单次曝光构图要求(图3)。这项技术的独特之处在于光源的性质。更多信息请参见极端紫外线光刻。

图3 EUV光刻示意图
精密DUV光学
在半导体光刻系统中,光分子污染是可靠性和寿命的重要问题。因此,必须非常小心地防止这些系统中的光学器件暴露于粘合剂、润滑剂和任何其他有机碳以及硅氧烷、膦酸盐或硫酸盐。有机物在DUV范围内具有吸收性,在光学器件表面吸附和随后的DUV照明后,会发生反应形成各种破坏性污染物。挥发性有机化合物、可冷凝的硅氧烷和无机化合物的微量污染会导致光在透射或反射中损失,并可能导致波前畸变,严重影响性能并导致计划外停机。它会导致斯特雷尔降低(或光学成像质量降低)、偏振变化甚至去调谐,即光学波长的偏移,从而对光刻系统的性能产生负面影响。光分子污染的范围包括DUV波长(190 - 355纳米)和EUV波长(低于190纳米,通常为13.5纳米)。光分子污染机制很复杂,高度依赖于功率水平以及化合物的类型和浓度。有多个方面需要考虑,具体的解决方案必须在具体的应用中得到理解和证明。随着波长的不断缩短和功率的增加,防止这种形式的化学污染变得越来越重要。
光学制造商拥有消除或限制光分子污染影响的方法,有助于实现高性能、长寿命的光学器件和系统。其中包括专有的光学材料和化合物、专有的抛光、清洁和涂层工艺,以及洁净室处理设备和工艺。本节描述了将DUV光学系统与标准目录光学系统区分开来的功能,包括:
1. 料科学领域的广泛R&D可靠性和寿命测试
2. 系统的初始设计
3. 长寿命和最小预防性维护周期的系统设计
4. 次级供应链管理和控制
5. 内部洁净室环境和生产控制
6. 保持清洁和包装
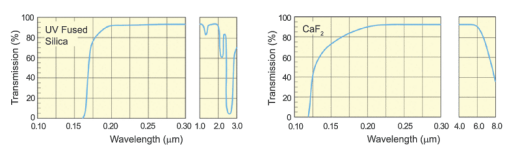
图4 DUV光学材料透射图
许多光学材料在200纳米以下具有低透射率,因此紫外熔融石英或氟化钙(CaF2)是DUV透射光学衬底的首选材料。图4显示了这些材料的典型透射率,该透射率在200纳米以下,然后急剧下降。然而,如果不使用特别优化的工艺进行涂覆,CaF2光学器件容易出现缺陷和滑移面。在选择与DUV波长兼容的抛光化合物和工艺方面进行了广泛的研究和测试。一些抛光材料/化合物会吸收紫外线/DUV光,这会影响光学元件的可靠性和寿命。其他可能包含直接与DUV光反应导致损坏和故障的化合物。
EUV光刻的真空控制
EUV对光学组件和真空控制的规格有严格的要求。EUV光源需要硬真空,因为所有气体都吸收13.5纳米的光。使用过程控制设备,如MKS流量控制器、阀门和压力表。
压电式压力计在一个封装中包含两个压力计:一个微机电系统micro pirani传感器和一个压电式传感器。它们是为负载锁设计的,测量压力范围从大气压到中等真空(1000到1x10-5托)。这一宽范围允许该仪表用于要求绝对真空/压力切换能力的真空室应用中。
DUV光刻的精确运动控制
DUV光刻需要高速运动平台来处理具有高精度和稳定性以及快速步进和稳定时间的晶片。覆层(一个图案层相对于另一个图案层的相对位置)、临界尺寸和生产量推动了掩模版和晶片阶段的这些要求,在193纳米技术中,典型的覆层公差为临界尺寸的15%。吞吐量要求(高达200个晶片/小时)将每个晶片的最大处理时间限制在20秒以内。这意味着在掩模版和晶片平移操作中出现相对较高的速度和加速度。这些光刻工具中的运动控制系统必须能够在不影响掩模版或晶片振动水平的情况下实现这些速度和加速度,因为这会影响可实现的光盘。快速步进和建立需要主动隔振,以最小化光学柱的振荡和随后的照明延迟。
除了更高的速度之外,通过增加管芯尺寸,使得每个晶片处理更少的管芯,吞吐量也被最大化。然而,这种方法增加了对定位精度的要求。光刻应用需要运动平台校准,以确保晶圆厂中许多不同平台定位的可重复性。
注意:此处包含的信息、建议和意见仅供参考,仅供您考虑,查询和验证,不以任何方式 保证任何材料在特定下的的适用性。华林科纳CSE对以任何形式、任何情况,任可应用、测试或交流使用提供的数据不承担任何法法律表任,此处包含的所有内容不得解释为在任何专利下运营或侵如任何专利的 许可或授权。