
扫码添加微信,获取更多湿法工艺资料
光刻是将掩模上的几何形状转移到硅片表面的过程。光刻工艺中涉及的步骤是晶圆清洗;阻挡层的形成;光刻胶应用;软烤;掩模对准;曝光和显影;和硬烤。
晶片清洗、阻挡层形成和光刻胶应用
在第一步中,晶片被化学清洗以去除表面上的颗粒物质以及任何有机、离子和金属杂质的痕迹。清洗后,用作阻挡层的二氧化硅沉积在晶片表面。在二氧化硅层形成之后,光致抗蚀剂被施加到晶片的表面。硅片的高速离心旋转是集成电路制造中应用光刻胶涂层的标准方法。这种技术被称为“旋涂”,在晶片表面产生一层薄而均匀的光刻胶。
正性和负性光刻胶
光刻胶有两种:正片和负片。对于正性抗蚀剂,抗蚀剂在要去除底层材料的地方用紫外光曝光。在这些抗蚀剂中,暴露于紫外光会改变抗蚀剂的化学结构,从而使其在显影剂中更易溶解。然后曝光的抗蚀剂被显影液洗掉,留下裸露的底层材料窗口。换句话说,“无论什么节目,都会去。因此,掩模包含要保留在晶片上的图案的精确拷贝。
消极抵抗的行为正好相反。暴露在紫外光下会导致负性抗蚀剂聚合,并且更难溶解。因此,负性抗蚀剂在其被曝光的任何地方都保留在表面上,并且显影剂溶液仅去除未曝光的部分。因此,用于负性光致抗蚀剂的掩模包含待转印图案的反转(或照相“负片”)。下图显示了使用正性和负性抗蚀剂产生的图案差异。
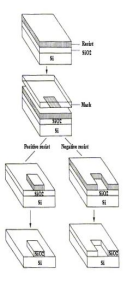
负抗蚀剂在集成电路加工的早期历史中很流行,但是正抗蚀剂逐渐变得更广泛使用,因为它们为小几何特征提供了更好的工艺可控性。正性抗蚀剂现在是超大规模集成电路制造工艺中使用的抗蚀剂的主要类型。
软烤
软烘烤是从光致抗蚀剂涂层中除去几乎所有溶剂的步骤。软烘焙在照片成像中起着非常关键的作用。光致抗蚀剂涂层只有在软烘烤后才变得感光或可成像。过度烘烤会降低抗蚀剂的光敏性,要么降低显影剂的溶解度,要么实际上破坏一部分感光剂。烘烤不足会阻止光线到达感光器。如果涂层中残留大量溶剂,正性抗蚀剂不会完全暴露。这种未充分烘烤的正性抗蚀剂随后容易被曝光和未曝光区域的显影剂侵蚀,导致抗蚀性降低。
掩模对准和曝光
光刻工艺中最重要的步骤之一是掩模对准。“光掩模”是一个方形玻璃板,其一面有金属膜图案乳液。掩模与晶片对准,使得图案可以转移到晶片表面上。第一个掩模之后的每个掩模必须与前一个图案对齐。
一旦掩模已经与晶片表面上的图案精确对准,光致抗蚀剂就通过掩模上的图案用高强度紫外光曝光。有三种主要的曝光方法:接触、接近和投射。如下图所示。
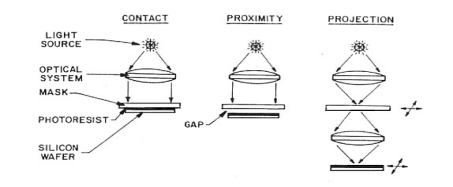
接触印刷
在接触印刷中,涂覆有抗蚀剂的硅晶片与玻璃光掩模物理接触。晶片被保持在真空吸盘上,整个组件上升,直到晶片和掩模彼此接触。当晶片处于与掩模接触的位置时,光致抗蚀剂用紫外光曝光。由于抗蚀剂和掩模之间的接触,在接触印刷中非常高的分辨率是可能的(例如。0.5微米正性抗蚀剂中的1微米特征)。接触印刷的问题在于,残留在抗蚀剂和掩模之间的碎片会损坏掩模并导致图案缺陷。
邻近印刷
接近曝光方法类似于接触印刷,除了在曝光期间在晶片和掩模之间保持10到25微米宽的小间隙。该间隙最小化(但可能不会消除)面罩的损坏。接近式印刷可以实现大约2到4微米的分辨率。
投影印刷
投影印刷,完全避免掩膜损坏。掩模上图案的图像被投影到几厘米远的抗蚀剂涂覆的晶片上。为了获得高分辨率,只对掩模的一小部分成像。这个小像场在晶片表面上扫描或步进。将掩模图像步进到晶片表面的投影打印机称为步进重复系统。分步重复投影打印机的分辨率约为1微米。
发展
光刻工艺的最后一步是显影。下图显示了曝光和显影后负抗蚀剂和正抗蚀剂的响应曲线。
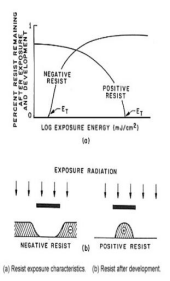
在低曝光能量下,负性抗蚀剂完全溶解在显影液中。随着曝光增加到阈值能量Et以上,显影后残留更多的抗蚀剂膜。在两倍或三倍阈值能量的曝光下,很少的抗蚀剂膜被溶解。对于正性抗蚀剂,即使在零曝光能量下,抗蚀剂在其显影剂中的溶解度也是有限的。溶解度逐渐增加,直到达到某一阈值,它变得完全可溶。这些曲线受所有抗蚀剂处理变量的影响:初始抗蚀剂厚度、预烘烤条件、显影剂化学性质、显影时间等。
硬烤
硬烤是光刻工艺的最后一步。为了硬化光致抗蚀剂并提高光致抗蚀剂对晶片表面的粘附力,该步骤是必要的。
注意:此处包含的信息、建议和意见仅供参考,仅供您考虑,查询和验证,不以任何方式 保证任何材料在特定下的的适用性。华林科纳CSE对以任何形式、任何情况,任可应用、测试或交流使用提供的数据不承担任何法法律表任,此处包含的所有内容不得解释为在任何专利下运营或侵如任何专利的 许可或授权。