
扫码添加微信,获取更多半导体相关资料
摘要
本文开发并实施了一种依次结合酸性和碱性清洗方法的“混合”后CuCMP清洗过程。新工艺展示了相对于全碱性刷子清洁工艺,证明了酸性和碱性清洁的优点,并使CMP缺陷减少超过60%,如抛光残留物、异物、泥浆磨料、划痕和中空金属工艺。它还消除了在辊子刷清洁过程中间歇性发生的圆环缺陷。TXRF扫描确认在使用混合清洁过程时AlOx缺陷的减少。XPS光谱显示了碱性和杂化清洁过程之间相似的铜表面氧化态。通过使用新的清洁工艺,可以提高短期和开放的产量。讨论了巨大的缺陷减少效益的潜在机制。
介绍
对于具有铜互连的半导体制造,与铜化学机械平面化(CMP)过程相关的缺陷往往是主要的屈服分离器。由于CMP是在完全定义一个铜互联之前的最终启用工艺,它不仅可以在过程中产生缺陷(例如划痕和抛光残留物),还可以揭示或装饰之前工艺步骤产生的缺陷,如rie后清洗、衬里沉积和铜镀。因此,铜CMP后的清洗过程不仅必须消除CMP期间产生的缺陷,还需要与之前的过程兼容,以防止进入CMP的缺陷加剧。
在本文中,我们研究了酸性和碱性清洁化学物质的优点,并通过实施两种不同的清洁化学物质开发混合清洁过程3,以满足铜CMP清洁的挑战。
实验
实验采用了基于32nm和22nm设计规则的铜金属化叶片。所有的晶片都用酸性铝化铜浆和基础化学的硅基屏障浆进行抛光。在清洁模块中对各种cmp后的清洁化学品进行了测试。其中,化学A是酸性的,而化学B是碱性的。这些化学物质在不同顺序的各种清洗过程中进行评估,如表i所示。BR1和BR2指的是使用化学喷雾的滚子刷1和2中的清洗步骤。“冲洗”步骤是在一个充满干净化学物质的水箱中进行的,在一个预先设定的出血和饲料循环中不断补充。在冲洗过程中,晶圆以恒定的转速旋转,不与刷或其他部件机械接触。无论清洗过程如何,垫片、滚子刷和浆液批次的消耗寿命都保持不变,即P1、P2和混合工艺具有相同的消耗寿命。
结果
全酸性和全碱性cmp后清洗过程:图中P1和P2清洗过程产生的CMP缺陷如图3所示。 在酸性P1过程中,PR/FM缺陷较低,而HM和DE缺陷较高。因此,正如我们之前的研究报道,必须实施广泛的队列时间控制,以减少这些腐蚀相关的缺陷。
混合清洁工艺:如图所示。5(c),采用混合清洁工艺,也能显著减少了HM、LE(线端中空金属)、DE等腐蚀相关缺陷。酸性化学物质(即化学物质A)在防止腐蚀缺陷方面的缺陷似乎远远被碱性化学物质B的最后清洗步骤所弥补。
表面特征:用p2和混合清洁工艺处理的晶片上的x射线光电子能谱(XPS)光谱如图11所示。P2和混合清洁过程在铜表面状态上没有明显的差异。结果表明,混合清洁过程实现的大量HM缺陷还原不能归因于化学反应对铜进行更好的钝化。相反,它可能源于表面缺陷(如PR/FM/SH/AL)的去除,这可以加速HM缺陷的形成。
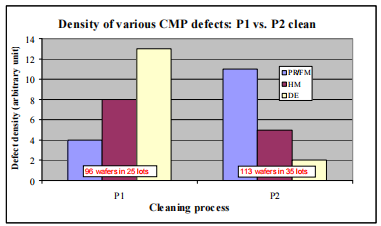
图 3: CMP来自两种不同的后清洗过程的缺陷,P1和P2,如表1所示
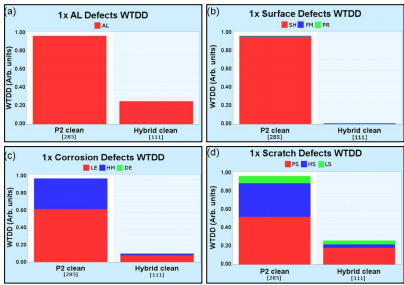
图5: P2和混合清洁过程中主要cmp相关缺陷的加权缺陷密度(WTDD)。x轴上的数字表示样本量。(a)AL缺陷;(b)SH(硅磨料)、FM和PR缺陷;(c)线端中空金属(LE)、中空金属(HM)和树突(DE);以及(d)抛光划痕(PS)、处理划痕(HS)和轻划痕(LS)
讨论
混合清洁工艺的工作机制:在目前的研究中,我们利用化学物质的性质来在不改变化学物质本身的情况下解决CMP缺陷产生的根本原因。一般来说,金属氧化物往往会在酸性环境中溶解。因此,使用酸性清洁剂是去除PR/FM/AL/SH的有利选择。在混合清洁过程中,使用酸性化学物质作为清洗的第一阶段,也是去除环状缺陷的关键。在刷清洁过程中,CuOx和AlOx颗粒与酸性化学溶解,消除了刷中产生环缺陷的来源。
基本化学冲洗剂在混合清洗过程中的作用:在基本化学环境(pH>10)中,CuOx(即铜晶片表面)以及氧化铝和二氧化硅磨料上的zeta电位是负的。因此,铜晶片表面与碱性化学物质中的残留磨料之间存在内置的排斥势,有助于消除这些PR/FM缺陷。基本的化学冲洗步骤需要钝化铜表面,以防止HM和DE缺陷的形成。同样,根据普尔贝克斯图,基本的清洁化学物质是一个更好的选择,因为铜表面在高pH状态下是钝化和保护的。
CMP后的清洁和缺陷特征:CMP相关缺陷的大幅减少不仅提高了本研究所证明的水平的短期和开放产量,而且也有帮助在下一级减少与CMP不直接相关的其他缺陷。
结论
本文开发并实现了一种针对先进BEOL技术的后铜cmp混合清洁工艺。该工艺依次结合了酸性和基本清洁,相对于所有基本清洁工艺,将所有CMP相关的缺陷减少了60%以上,包括抛光残留物、异物、泥浆磨料、划痕和中空金属。它还消除了在辊子刷清洗过程中产生的圆环缺陷的发生。TXRF扫描显示,混合清洁工艺大大降低了晶片边缘残留的AlOx磨料的浓度。在刷中使用酸性清洁化学物质溶解金属氧化物是减少PR/FM/AL和消除环状缺陷的关键。基本化学冲洗步骤的应用可以进一步减少表面缺陷和铜表面的钝化,以防止HM和DE缺陷的形成。新的清洁工艺有助于提高当前水平的短期产量和下一个金属水平的开放产量。它还减少了其他缺陷,如缺失的模式和非视觉效果,以更好地表征和表示其他缺陷。
文章全部详情,请加华林科纳V了解:壹叁叁伍捌零陆肆叁叁叁