
扫码添加微信,获取更多半导体相关资料
引言
近十年来,湿化学法制备超薄二氧化硅/硅和超薄二氧化硅/硅结构的技术和研究取得了迅速发展。这种结构最重要是与大尺寸硅晶片上氧化物层的均匀生长有关。
在硝酸溶液中湿法制备的氧化物(通常标记为氢氧化钠)的性质在于通过傅里叶变换红外光谱测定的高氧化物密度,因此,产生了制备具有优异绝缘性能的超薄氧化物层的可能性。
实验
我们使用了电阻率为10厘米的适度n型和p型硅(100)晶片。
所有硅衬底的表面在氧化之前都用标准的RCA工艺清洗(即。浸泡在NH4OH+H2O2水溶液和然后用5wt %蚀刻氢氟酸。近十年来,湿化学法制备超薄二氧化硅结构的技术和研究得到了迅速发展。这种结构最重要的优点之一与大尺寸硅晶片上氧化物层的均匀生长有关。当然,氧化层和氧化物/硅界面的质量也非常好。在硝酸溶液中湿法制备的氧化物(通常标记为氢氧化钠)的非常有趣的性质在于通过傅里叶变换红外光谱测定的高氧化物密度,因此,产生了制备具有优异绝缘性能的超薄氧化物层的可能性。
讨论
氢氧化钠样品的光学性质光谱椭偏法和原子力显微镜 略
采用后氧化退火和HCN处理的与NAOS相关的金属氧化物半导体结构的电学特性。第一组制备好的样品在N2气氛中于700℃退火20分钟。它们被标记为氧化后退火后的样品。第二组制备好的样品在室温下在0.1M水溶液中处理
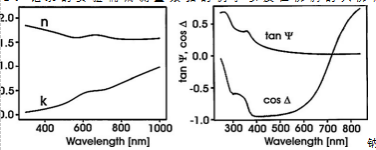
图2
氧化后退火样品和金属化后退火样品(PMA)

图11 通过原子发射光谱法获得的穿过极薄的氢氧化钠氧化层的氧、碳和硅原子的深度分布图。漏电流的减小,界面态密度的降低,悬空键结构的转变,以及SiOx沉淀的形成。在PMA之后,我们观察到激活能为0.05–0.2eV的连续缺陷态谱。在图1所示的情况下。10A,是0.14eV。结构热稳定后,可能形成二氧化硅沉淀。我们认为它们是深陷阱,活化能为0.26电子伏——见图10B 。这种类型的陷阱已经在POA样品中发现——见表3,因此我们假设PMA结构的界面性质没有发生质的变化。当然,PMA结构的电学性质,如漏电流和界面态密度,都得到了改善。
光致发光测量
硅晶片的机械和化学预处理的使用方式可以影响观察到的光致发光振幅的值(而不是能量尺度上的最大值位置)以及界面缺陷状态密度,因此在本实验中使用的所有硅晶片组上进行相同的标准RCA程序。
我们认为,多孔硅内部的原子无序程度会影响室温下记录的主要光致发光光谱。这种光谱在能量尺度上的位置与本文中给出的光谱有很大的不同,它们来自样品中与硅晶体相关的部分,在6K温度下测量。
结论
我们研究了在硝酸溶液中湿法化学氧化制备的结构中光学、结构和电学性质。光谱椭偏法表明,形成的超薄氧化层的复折射率实部比二氧化硅的复折射率大。
原子力显微镜测量证实,与参考清洁表面相比,覆盖有超薄氧化物的样品的表面粗糙度仅略有变化。相应的值相差0.07纳米。
在POA后极薄的NAOS氧化物/Si界面上,形成了更多类型的离散深陷阱。几乎所有的深陷阱都与界面区域中更多类型的硅悬空键的形成有关。应力还会引起硅带隙中陷阱的能量位置的变化。因此,我们不能排除它在这种情况下的作用。在极薄的氧化物/硅结构上应用HCN水溶液后,观察到了相当强的钝化效应,这是由CN基团饱和硅悬挂键和将界面缺陷态密度降低大约一个数量级引起的。此外,钝化过程可能导致形成新的深界面陷阱,尽管它们的密度很低。另一方面,我们不得不承认,我们可以观察到相同类型的深陷阱(如钝化过程之前),其活化能因应力变化而改变。此时此刻,我们无法区分哪种效应占主导地位。在两种类型的硅衬底的中间间隙水平上观察到最强烈的钝化过程。如果使用p型硅衬底,记录在NAOS/Si样品上的深陷阱谱更简单。