
扫码添加微信,获取更多半导体相关资料
引言
随着半导体器件不断向越来越小的尺寸发展,保持硅表面无污染以提高器件功能、产量和可靠性变得越来越重要。基于RCA的湿法化学清洗仍然广泛用于半导体器件制造工艺。经过SC-1和SC-2处理后,硅表面具有约1纳米厚的化学氧化层。对于预浸清洗,低质量的化学氧化层最好在生长高质量的热栅氧化层之前去除。这可以通过稀氟化氢(DHF)处理来实现。
在本方法中,我们结合电位测量技术、TXRF技术和电感耦合等离子体质谱法来测定不同添加剂在DHF溶液中对硅表面超压铜输出的影响。用光散射和透射电镜研究了溶液中表面活性剂与铜离子的相互作用。用扫描电镜研究了表面活性剂对减少硅表面铜成核的影响。硅表面吸附的表面活性剂层用原子力显微镜进行了验证。在此基础上,总结了DHF清洁生产中对铜产出的表面影响。
实验
我们选用盐酸、双氧水、硝酸、阳离子表面活性剂和阴离子表面活性剂等不同添加剂,研究它们对铜输出的影响。我们使用的阳离子表面活性剂是烷基四甲基溴化铵(CTAB),阴离子表面活性剂是含硫表面活性剂。它们具有相似的链结构和分子量。我们之前的结果表明,这两种方法在稀释过程中都有效地防止了颗粒的再沉积。用一个2英寸(100)电阻率为1-10ωcm的n型硅片(Silicon Quest International)在安装到定制的特氟隆电化学电池之前,经过SC-1清洗、DHF清洗和去离子水冲洗,以去除颗粒和化学氧化物。只有晶片的抛光面与溶液接触,背面与不锈钢基底接触,不锈钢基底与外部有不锈钢连接。在晶片背面和金属基底之间使用了共晶镓铟合金薄膜,以确保欧姆接触。在电池中使用50毫升0.5重量%的含/不含添加剂的溶液。使用25 W徕卡白炽灯,光线直射到晶片上。
为了再生硅,采用5 mL 5%氢氟酸+ 5%硝酸+ 5%过氧化氢溶液去除表面铜。表面污染由TXRF和飞行时间二次离子质谱(TOF-SIMS)检测。将硅片样品浸入含/的0.5% HF + 100 ppb铜浴中。在光照下无表面活性剂10分钟。在所有的实验中,表面活性剂浓度为1%(重量)。通过动态光散射在1%阴离子表面活性剂+500 ppm铜/污染物水溶液中进行粒度分析。还对1%阴离子表面活性剂+500 ppm铜污染物中的颗粒进行了透射电镜分析。透射电镜样品是通过将覆盖有无定形碳薄膜的铜网格浸入溶液中以捕获颗粒而制备的。硅表面上吸附的表面活性剂层的表征是通过使用具有原子力显微镜的表面力测量技术来完成的。液体电池和氮化硅尖端都来自数字仪器。
还研究了表面活性剂对保护受损硅表面免受铜输出的影响。表面损伤可能是由用划痕仪刮伤硅表面引起的。将面积为1 × 1 cm的划开的晶片片浸入含和不含表面活性剂的0.5% HF + 1 ppm Cu2+溶液中,在25 W白炽灯下照明10分钟。然后是晶片片用去离子水冲洗并进行扫描电镜观察。拍摄了二次电子图像和特征铜和硅的Kα X光图像。
结果和讨论
表征铜输出添加剂效率的电位法。—DHF溶液中的铜离子导致硅电极和参比电极之间的OCP变化。图1中绘制了添加铜的硅电极的OCP变化。OCP变化与整体铜浓度密切相关。每次加入铜后,OCP值突然增加,然后在15分钟后逐渐变为相对稳定的值。随着更多铜污染物的加入,观察到OCP值的类似变化。在水冲洗后,在同一电极上使用没有铜污染的新鲜0.5% HF溶液,OCP没有回到其原始值,因此表明OCP响应不是由铜引起的。图2中绘制的结果进一步验证了这种说法,其中使用反萃溶液溶解表面铜,新鲜0.5% HF中的OCP回到大约原始值。这证实了表面铜,而不是溶液中的铜,是造成OCP变化的原因。
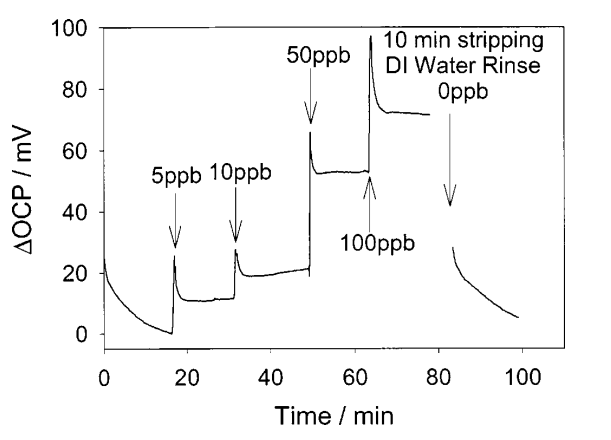
图2 随着铜的加入,OCP变化
图3绘制了OCP变化与大块铜浓度对数的函数关系。最小二乘回归结果表明,OCP变化与对数[Cu/ppb]呈线性关系r2 = 0.99。图4总结了同一批次的不同p型晶片上的OCP变化与时间的关系,图5显示了从同一批次的不同n型晶片获得的相同参数。这表明n型晶片比p型晶片具有更高的斜率。Norga等人报告说,n型晶片比p型晶片更易受铜输出的影响。14因此,斜率变化与铜输出的易感性定性相关。从图4和图5中,我们可以看到回归线的斜率比绝对OCP值更具可重复性。这是因为硅电极的OCP也取决于其表面条件。很难在不同的晶片上或同一晶片上在不同的时间有相同的表面条件(在附录中讨论了硅电极在DHF溶液中的OCP变化机理)。然而,回归线的可重复斜率可以提供铜输出程度的定性测量,从而提供添加剂的效率。

图5 n型晶片OCP变化与铜块浓度对数的关系
DHF清洗过程中表面活性剂对铜输出的影响综述。根据所呈现的结果和先前公布的结果,表面活性剂在DHF清洗期间铜污染中的作用可总结如下:
表面活性剂在硅表面形成保护层。硅上吸附的表面活性剂分子层阻碍硅表面和铜离子之间的电子转移。因为硅表面上的铜还原不再受扩散控制(图9),推断限速步骤是电子转移。对缺乏优先成核的直接观察(图15)也支持这一结论。硅表面表面活性剂层形成的证据是ζ-电位变化3和直接测力的结果。
表面活性剂与铜离子相互作用。表面活性剂,尤其是阴离子表面活性剂,可能与铜离子有很强的相互作用。我们的光散射实验结果可以作为证据(图10)。表面活性剂对铜的输出有两种影响。一是表面活性剂降低了自由铜离子的浓度,导致铜输出的驱动力降低(图8)。另一种是表面活性剂-铜离子络合物可能吸附在硅表面。如果这种复合物不能通过去离子水冲洗完全冲洗,那么铜污染会增加(图12)。
表面活性剂在铜输出中的作用不是孤立的。因此,我们观察到表面活性剂对镀铜的不同影响。吸附污染机理表明,如果表面活性剂被用于DHF清洁,这被提议最小化颗粒再沉积,那么研究其对金属污染以及具有低还原电位的其他金属的影响是至关重要的。
总结
我们研究了DHF清洗过程中添加剂对铜在硅表面输出的影响。我们通过不同的实践证明,在DHF清洗过程中,盐酸、过氧化氢和硝酸等添加剂能有效降低铜的输出。我们指出了十六烷基三甲基溴化铵能有效减少铜的输出。DHF清洗期间的硅表面。阴离子表面活性剂通过与金属离子形成络合物并随后吸附在硅表面上,可以增加金属输出,不仅是铜,还有其他金属,如镍。结合OCP监测、表面金属分析和显微镜研究,可以区分铜输出的不同机理。实验数据表明(1)硅表面上吸附的表面活性剂层可以阻碍硅表面和铜离子之间的电子转移,(2)本体溶液中的表面活性剂分子可以与金属相互作用。既可以降低金属外层驱动力,也可以增加金属离子-表面活性剂配合物的物理吸附趋势。