
扫码添加微信,获取更多半导体相关资料
引言
硅晶片在晶片制造工艺或元件制作工艺过程中,会受到各种污染物、表面特性的影响。 这些污染物是导致半导体元件产出率下降的原因,可以在晶圆制造工序后的最后阶段进行清洁处理,也可以在元件制造工序前和工序中间进行清洁处理。进行清洁工程,使污染物浓度最小化。
使用HF清洗后,必须对重新吸入的微粒进行清除。BOE溶液是NH4F和HF混合的溶液,与DHF溶液一样,NH4F溶液有助于酸的货物去除和NH4F溶液去除微粒,NH4F和HF混合使效果比HF颤抖。本方法对广泛应用于通用器件的Polished Si晶片和用于逻辑器件的Epitaxially-grown Si晶片进行了表面处理时表面的化学物理变化,确定了相互之间的三个定过程后特性差异。
实验
本方法对直径为300mm的抛光晶片和EpiLayer晶片采用不同的清洁液进行表面处理后,表面的变化进行了鉴定。晶片为P-type兴奋剂,以抑制杂质为1016cm−3浓度,在1200摄氏度高温下进行离子注入掺杂。 切成10 mm×10 mm大小的雕塑试片后,用清洁液进行了表面处理。 选用SC-1作为RCA洗脱方法; SC-1洗脱方法是由氨水及过氧化氢水、超纯水按1:1:5的比例混合使用,在混合液加热到80 oC的情况下进行洗脱,洗脱时间为600秒。
用混合液在清洁阶段结束后利用超纯水去除晶片表面残留的混合液1分钟,然后依次进行了干燥阶段。DHF洗脱以50%HF溶液与超纯水为1:50的混合液在常温下洗脱10秒,并进行相同的混合液去除、干燥。BOE洗洁精也和DHF洗洁精一样,在洗洁精后实施了去混合液干燥。在NH4F和HF以6:1混合的溶液中,用超纯数为1:50混合的溶液洗脱BOE溶液10秒。这种利用混合液经过表面处理过程的样品均通过真空贮存,使硅片试件表面形成的自然氧化物的生长达到最小。
在XPS分析中,所有的峰值都进行了能量偏差补偿,因此反映了表面特性。通过这些物理和化学测定,比较和分析了洗井前后表面的变化。
总结和讨论
纯硅在化学上非常不稳定,很容易与大气中存在的异物结合。结果化合物在表面形成,占大部分的是氧化物。这种自然氧化膜形成后,显微、远地等吸附现象会发生得更严重。因此,本研究为了最大限度地减少这些空气中的污染现象,将清洗后的样品真空包装起来,在表面处理后测量之前,尽量减少与样品大气的接触时间,从而只获得清洗过程本身引起的表面特性。
表面粗糙度特性:图1是通过对表面处理前后的每个晶片进行AFM测量来测量表面的精细粗糙度的图,与没有进行表面处理的雕刻时的相比,表面几何图形较差。
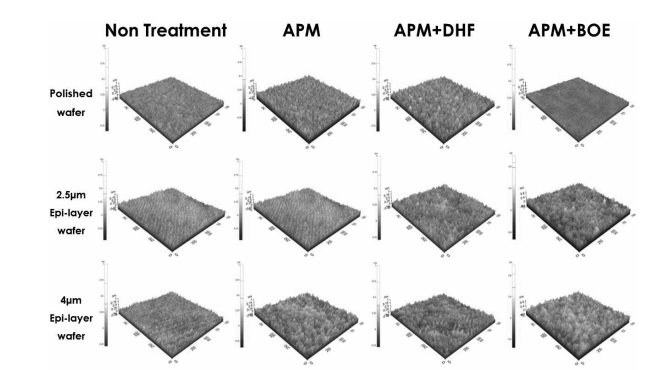
图1 清洗处理前后的抛光和2.5µm和4µmepi层晶片表面的AFM图像
表面化学特性:将晶片进行表面处理后利用XPS测得的光谱图,这里要重点确认的元素种为:530eV附近的氧(O 1s)峰; 依据峰值强度可计算出键合浓度,峰值强度为280 eV附近的碳(C 1s)峰,100 eV附近的硅(Si 2p)峰。特别是对于用APM混合物和DHF混合物处理过的抛光晶片,可以看出O1s峰的强度被测得比其它表面处理混合物小。
这些表面处理后立即形成的表面极性,在以后的门绝缘膜形成过程中伴随的化学变化,使过程后出现变化。然而,对于这些表面化学和电学特性,利用XPS精确地确立初始条件对以后的工艺参数也有影响,因此可能是非常重要的。
本方法使用的X射线能量在Si的平衡带边缘的结合能量区域(主要由Si3s和O2p外角电子斜坡组成的区域)中有3 nm以上的电子逸出深度。因此,通过图6的解释,确认了表面处理前后Si-Si耦合电子结构在表面上的存在。这证明了存在的氧化膜的形态是island形态,而不是一开始表面处理之前完全捕集Si晶片表面的真菌工作形式,这种流动形式随着表面处理后氧化膜蚀刻的发生而更加明显。这样,基板表面处理后,不均匀的表面结构特性和部分氧化特性增加,表面状态不稳定,DHF溶液处理等氧化膜被大部分去除,成为氢纵断面。这之后进行的栅极绝缘膜过程中,界面不稳定性导致界面扩散和界面粗糙的可能性会增加,因此,对这些清洗过程的密切表面特性的观察可以说是非常重要的例子。

图6 晶圆表面的XPS价带边缘光谱
总结
本方法以抛光晶片与Epi-Layer晶片进行表面粗糙度、自然氧化物厚度及化学结合研究来确定变化,以确定晶片表面经过表面处理后的化学与物理变化。 抛光晶片和Epi-Layer晶片通过AFM的3-D图像确定了表面处理时,不同混合液晶片表面在特定部分的蚀刻导致的表面微粗糙度不同。 但是抛光晶片的情况下,对于BOE混合物,前部的蚀刻不是特定部分的蚀刻,而是产生了微粗糙度比表面处理前得到了改善值。
化学键分布通过XPS测量确定。结果表明,抛光晶片和Epi-层晶片均表明DHF混合液对表面存在自然氧化物的去除优于BOE混合液。在抛光晶片和4µm-EPi-层晶圆的情况下,在O1s XPS光谱中发现了由表面吸附的OH效应引起的结合能的变化,这使得表面极性 VBM结果证明是有影响的。尽管是相同的Si结构,抛光和Epi-层晶片在各自的表面处理后有显著的化学和物理差异,Epi-层晶片之间的厚度也不同。因此,为了应用逻辑器件,Epi-层晶片通过本方法得到了增强,通过上述仔细的表面分析,为应用栅极形成,必须对现有聚合波导基础上建立的WAFAFER清洗工艺进行重新评价,并开发出能够对聚合晶片和2.5 m & 4 m Epi-层晶片进行相同表面氧化膜和污染物去除和微粗糙度改善的混合清洗液和工艺。